Chip-Bonding: Der Prozess, bei dem ein Chip auf einem Substrat platziert wird
Der Verpackungsprozess ist der letzte Schritt bei der Herstellung von Halbleitern und besteht aus Schleifen, Schneiden, Montieren, Verdrahten und Formen. Der Ablauf dieser Prozesse kann sich entsprechend den Veränderungen in der Verpackungstechnik ändern und auch eng miteinander verknüpft oder kombiniert sein. Dieser Artikel konzentriert sich auf das Wafer-Bonding, eine Verkapselungstechnik, mit der ein von einem Wafer getrennter Chip nach einem Schneidprozess mit einem Verkapselungssubstrat (Leiterrahmen oder PCB) verbunden wird.

1.Was ist Bindung?
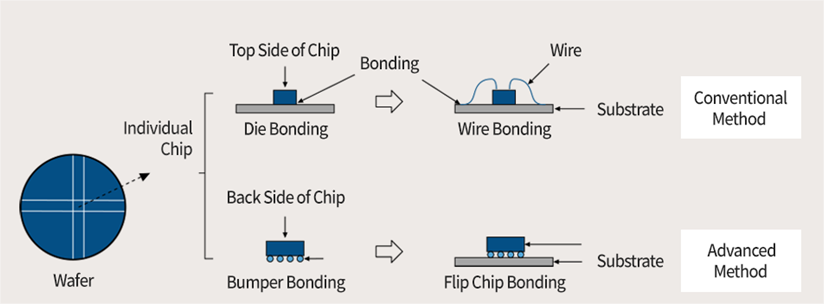
Unter Bonden versteht man im Halbleiterprozess die Verbindung eines Wafer-Chips mit einem Substrat. Das Kleben kann in zwei Arten unterteilt werden, nämlich die traditionelle Methode und die fortgeschrittene Methode. Zu den traditionellen Methoden gehören Chip-Verbindungen (oder Chip-Verbindungen) und Drahtverbindungen, während zu den fortschrittlichen Methoden Flip-Chip-Verbindungen gehören, die Ende der 1960er Jahre von IBM entwickelt wurden. Flip-Chip-Bonding ist eine Methode, die Die-Bonden und Drahtbonden kombiniert und den Chip und das Substrat durch die Bildung einer konvexen Auskleidung auf dem Chip verbindet.
2. Klebevorgang
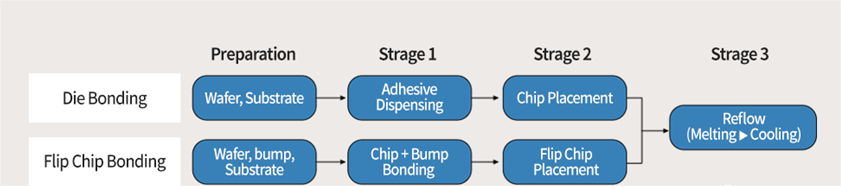
Beim Chip-Bonden muss zunächst der Klebstoff auf das Gehäusesubstrat aufgetragen werden. Legen Sie dann einen Chip mit der Stiftseite nach oben darauf. Stattdessen werden beim Flip-Chip-Bonden, einer fortgeschritteneren Methode, kleine Höcker, sogenannte Lotkugeln, auf der Auskleidung des Chips angebracht. Anschließend wird der Chip mit der Pin-Seite nach unten auf das Substrat gelegt. Bei beiden Methoden durchläuft die zusammengebaute Einheit einen Temperaturrückflusskanal, der im Laufe der Zeit angepasst werden kann, um den Klebstoff oder die Lotkugel zu schmelzen. Anschließend wird es abgekühlt, um den Chip (oder Bump) auf dem Substrat zu befestigen.
3. Pick & Place der Chips
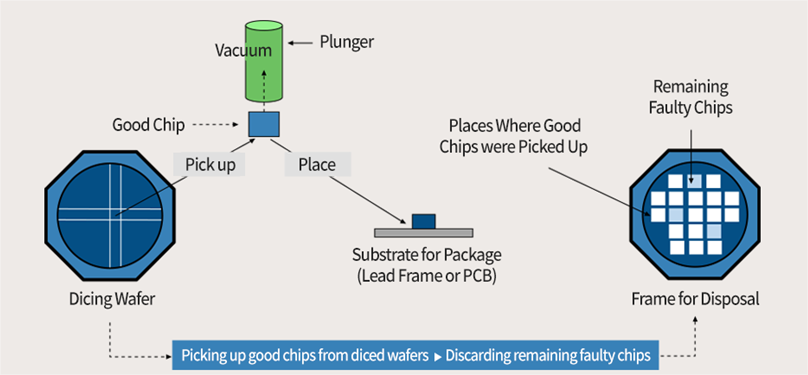
Das einzelne Entfernen des am Band befestigten Chips wird als „Pick“ bezeichnet. Wenn die guten Chips mit dem Stößel vom Wafer entfernt werden, wird das Platzieren dieser Chips auf der Oberfläche des Gehäusesubstrats als „Platzieren“ bezeichnet. Diese beiden Aufgaben, „Pick & Place“ genannt, werden auf einer Die Bonde erledigt.
4. Spanauswurf
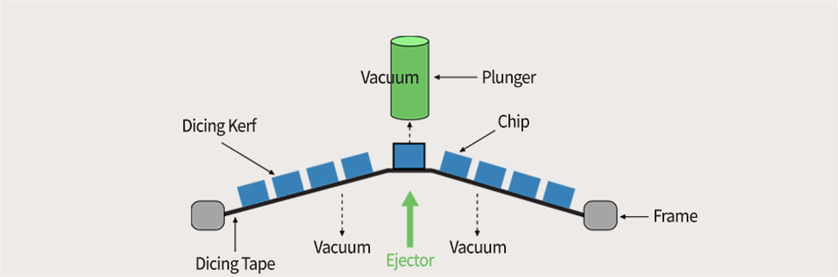
Verwenden Sie eine Methode, mit der sich der Chip leicht aufnehmen lässt: „Auswerfen“. Mithilfe eines Auswerfers werden physikalische Kräfte auf den Zielchip ausgeübt, wodurch dieser sich in der Schrittgröße geringfügig von anderen Chips unterscheidet. Nachdem Sie den Chip von unten ausgeworfen haben, ziehen Sie ihn mit einem Vakuumbandstößel von oben nach oben. Ziehen Sie gleichzeitig mit einem Vakuum an der Unterseite des Bandes, um die Bandoberfläche glatt zu machen.
5. Die Chips werden mit Epoxidharz verklebt
Beim Bonden des Chips erfolgt die Verbindung mittels metallhaltigem Lot oder einer Paste (Power Tr), für das Chipbonden kann auch Polymer (Polyimid) verwendet werden. In Polymermaterialien sind silberhaltige pastöse oder flüssige Epoxidharze relativ einfach zu verwenden und werden häufig verwendet.
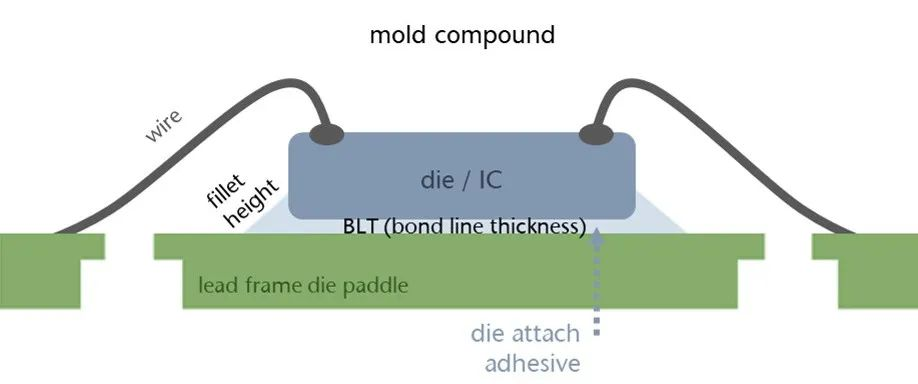
6. Die Beschichtung (DAF) wurde zum Chipbonden verwendet
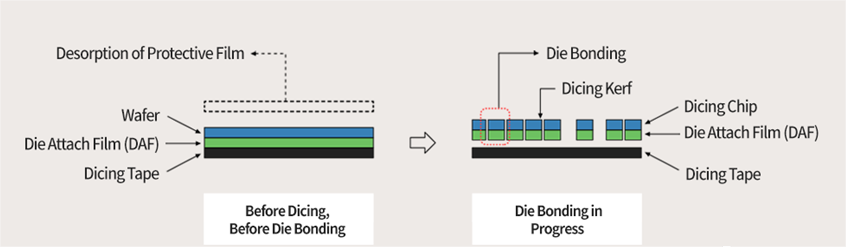
DAF ist ein dünner Film, der auf der Unterseite des Chips angebracht ist. Die Dicke des DAF kann auf eine sehr dünne und konstante Dicke eingestellt werden. Es wird häufig nicht nur beim Chip-zu-Substrat-Bonden, sondern auch beim Chip-zu-Chip-Bonden zur Herstellung von Multi-Chip-Packages (MCP) eingesetzt. Aufgrund der Struktur des Chips ist der DAF an der Unterseite des Chips mit dem Chip verklebt, und das Schneideband ist mit dem DAF darunter verklebt, und die Haftung ist schwach. Um das Chipbonden in dieser Struktur durchzuführen, wird der Chip nach dem Entfernen des Chips und des DAF vom Band direkt auf dem Substrat platziert, ohne dass Epoxidharz verwendet werden muss
Fountyl Technologies PTE Ltd konzentriert sich auf die Halbleiterfertigungsindustrie. Zu den Hauptprodukten gehören: Stiftfutter, poröses Keramikfutter, Keramik-Endeffektor, Keramik-Vierkantbalken, Keramikspindel. Willkommen bei Kontakt und Verhandlung!











