کنترل جریان در لیتوگرافی غوطه وری
برای بیش از ده سال، لیتوگرافی غوطه وری اصلی ترین فناوری نوردهی در تولید نیمه هادی ها بوده است. در مقایسه با روشهای لیتوگرافی خشک سنتی، این تکنیک وضوح نوردهی را با تزریق یک مایع با ضریب شکست بالا به شکاف بین لنز و سطح ویفر بهبود میبخشد. حفظ خلوص و یکنواختی مایع غوطه ور و اجتناب از تشکیل قطرات باقیمانده در فرآیند اسکن با سرعت بالا، دو چالش عمده پیش روی توسعه فناوری لیتوگرافی غوطه ور است. آلاینده ها، ذرات، حباب ها، گرما و تنش در مایع می توانند تداوم ضریب شکست را مختل کنند. حرکت با سرعت زیاد ویفر در حین اسکن ممکن است منیسک را در سطح مشترک بین مایع و گاز اطراف بی ثبات کند و در نتیجه قطرات باقی مانده روی ویفر ایجاد شود. پدیده های فوق بر عملکرد نوردهی لیتوگرافی غوطه وری تاثیر می گذارد و روش کنترل رفتار جریان مربوطه برای حل مشکل مورد نیاز است.
1، تأثیر کنترل رفتار جریان بر خلوص و یکنواختی مایع
1.1.تأثیر رفتار جریان بر خلوص و یکنواختی مایع
1.1.1.ذرات و آلاینده ها
ذرات و آلاینده ها منابع اصلی ناخالصی های جامد در مایعات غوطه ور هستند. ذرات معلق در یک مایع غوطهور شده در نزدیکی سطح ویفر یا در بالای فترزیست میتوانند به داخل فترزیست زیرین تصویربرداری شوند یا در طول توسعه به فوتوریست منتقل شوند.
ذرات ممکن است در منبع مایع وجود داشته باشند یا ممکن است از هر سطحی که مایع لمس میکند بیرون بیاید. اولاً، مایع مورد استفاده برای غوطه وری به طور اجتناب ناپذیری حاوی ذرات و ناخالصی است، بنابراین از آب یونیزه شده تمیز به عنوان محلول غوطه وری استفاده می شود و قبل از تزریق به سر غوطه وری، بیشتر تصفیه و فیلتر می شود. یکی دیگر از مشکلات ذرات، پوسته شدن لایه اطراف مخروطی ویفر است که به دلیل چسبندگی ناکافی بین سطح اریب و پوشش سطح ایجاد می شود. در طول قرار گرفتن در معرض، این ذرات می توانند از طریق منیسک مایع از لبه ویفر به مرکز ویفر به عقب و جلو منتقل شوند. روشهای حل این مشکل عبارتند از انتخاب مقاومت نوری، بهینهسازی فرمول EBR و پردازش ویفر. پدهای ویفر نیز منبع بالقوه ذرات هستند. همانطور که سر غوطه ور در سراسر ویفر حرکت می کند، سر غوطه ور ذرات را می گیرد و دوباره آنها را ذخیره می کند. تمیز کردن معمولی میز ویفر تعداد ذرات را کاهش می دهد و ثابت شده است که فناوری تمیز کردن در محل یک روش تمیز کردن میدان بسیار مؤثر است. سایر عیوب ناشی از ذرات مقاوم نور/روپوش شفاف که بر روی سطح لایه مقاوم نوری یا لایه پوششی (به عنوان عیوب ضد حباب) ایجاد می شوند را می توان با بهینه سازی فرمول پوشش کاهش داد.
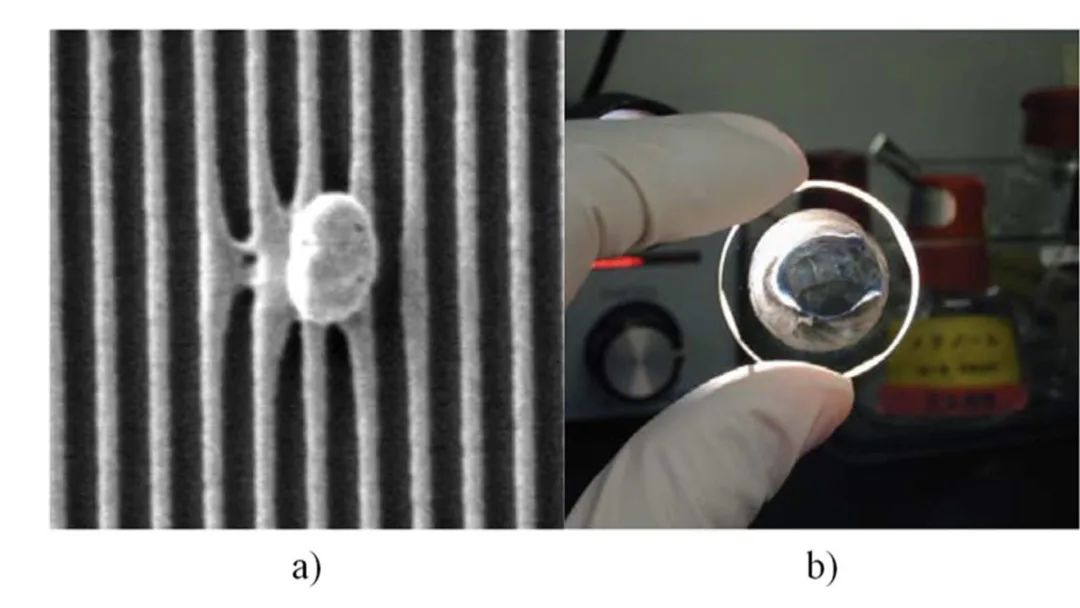
راه موثر برای حل مشکل لیچینگ استفاده از نرخ آبشویی پایین لایه مقاوم یا مانع بالایی است. شستشوی لایه های مقاوم با آب دیونیزه شده نیز به عنوان جایگزینی برای مشکل شستشو مورد بررسی قرار گرفته است. علاوه بر این، ناحیه سر غوطه ور بزرگتر از ناحیه میدان نوردهی است، به این معنی که ویفر قبل و بعد از قرار گرفتن در معرض قرار گرفتن، مانند فرآیند فلاشینگ خیس می شود [38]. از آنجایی که مایع در طول قرار گرفتن در معرض و غوطه ور شدن از طریق سر غوطه ور به جریان خود ادامه می دهد، آلاینده های موجود در مایع غوطه ور تا حد زیادی حذف می شوند و بنابراین می توانند جایگزین فرآیند شستشو شوند.
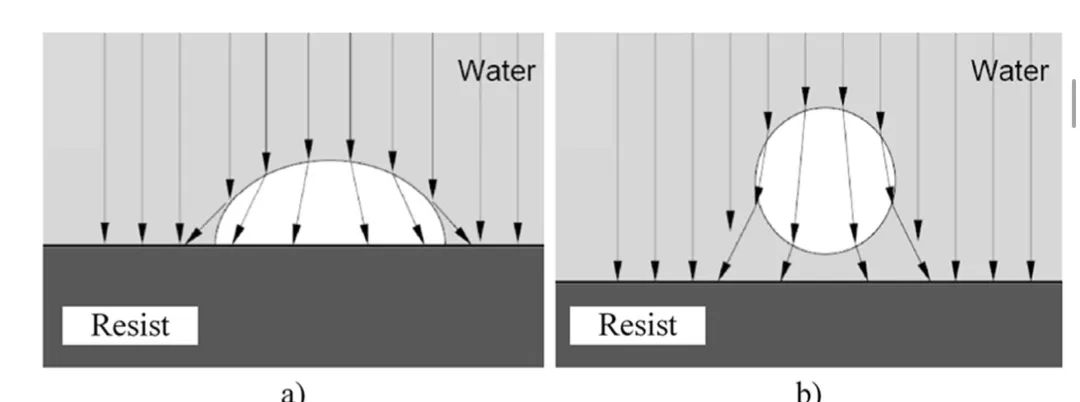
حباب ها نور ورودی را منعکس و منعکس می کنند. الف) روی سطح مقاومت نوری، و ب) شناور در محلول غوطه ور شده.
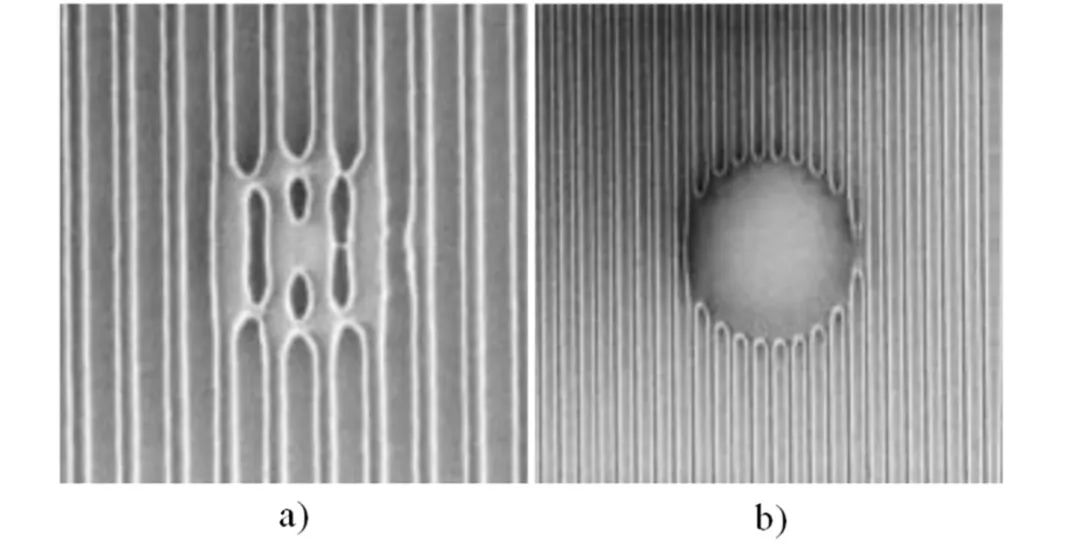
نقص حباب در اندازه های مختلف. الف) 0.85μm، ب) 3μm.
1.1.2.بیوبل
یکی از چالش های اصلی لیتوگرافی غوطه ور شدن حباب این است که در طول فرآیند نوردهی هیچ حبابی در محلول غوطه وری ظاهر نشود. رابط منحنی گاز-مایع ناشی از حباب ها، نور فرودی را منعکس و شکست می دهد، که ناپیوستگی های ضریب شکست را ایجاد می کند و اثرات پراکندگی را افزایش می دهد و در نهایت منجر به نقص در الگو و کاهش تسلیم می شود.
عوامل اصلی که بر اثر حبابها تأثیر میگذارند، زمان قرار گرفتن در معرض، اندازه حباب و ارتفاع حبابها در بالای ویفر است، با زمانهای نوردهی کوتاهتر که تأثیر حبابها را افزایش میدهد و باعث میشود که ویژگیها برای زمان نوردهی بیشتر در ناحیه با سایه شدیدتر باقی بمانند. . دوم، اگر حباب به اندازه طول موج نور استفاده شده برای نوردهی باشد، نور پراکنده می شود و نور سرگردان را افزایش می دهد. اگر اندازه حباب میکرومتر یا بزرگتر باشد، حباب تا حدی مسدود می شود و جهت نور را تغییر می دهد. در نهایت، این مطالعه همچنین نشان داد که تأثیر کلی حبابها بر روی تصویر به فاصله حبابها از سطح ویفر بستگی دارد - هر چه فاصله بیشتر باشد، اثر ضعیفتر است، زیرا حبابهای دور از مقاومت نوری میتوانند به سرعت از بین بروند. یک مایع با حرکت سریع اگر نسبت فاصله حباب از ویفر به قطر حباب 4:10 باشد، تأثیر یک حباب شناور ناچیز است. با نزدیکتر شدن حباب به ویفر، به دلیل جریان آهستهتر سیال در نزدیکی سطح ویفر، سایه حباب در صفحه تصویر قویتر میشود و طول عمر آن در یک مکان خاص روی ویفر طولانیتر میشود. در نتیجه، حباب های متصل به سطح ویفر، یک تصویر بدون نقص را تهدید می کند. از طریق مطالعه سیستماتیک اثر پراکندگی حباب در لیتوگرافی غوطهور، پیشبینی میشود که 60 نانومتر حداکثر اندازه حباب است که وقتی حباب به سطح مقاومت نوری متصل میشود، نقصی ایجاد نمیکند. حبابها در لیتوگرافی غوطهور ممکن است در اثر تداخل عوامل مختلفی مانند فشار، دما، واکنش فتوشیمیایی و دینامیک سیالات ایجاد شوند.
1.1.3.گرمایش
در طول نوردهی، مایع غوطهور شده بهطور نابرابر گرم میشود و توزیع دما ممکن است به روشهای مختلفی بر روی تصویر تأثیر بگذارد، در حالی که مقادیر کمی انحرافات کروی و درجه بالاتر ایجاد میکند، و نقص اصلی تصویربرداری عدم فوکوس است. اگر فقط یک نانومتر فوکوس زدایی را مجاز کنیم، تغییر ضریب شکست باید بسیار کم نگه داشته شود. از آنجایی که ضریب دمایی آب (dn/dτ=-10-4K-1) در مقایسه با گاز بسیار بزرگ است، دمای مایع باید در 10 mK نگه داشته شود، که محدودیت های سختی را برای سیستم های کنترل دما و جابجایی مایع ایجاد می کند.
1.1.4.فشار
برای لیتوگرافی غوطهوری، ویسکوزیته بالا و چگالی بالای مایع غوطهور شده، در مقایسه با هوا در لیتوگرافی خشک، میتواند باعث ایجاد استرس قابلتوجهی بر روی سطوح لنز و ویفر شود. این تنش های معمولی و برشی می تواند منجر به انحراف و انکسار عدسی شود و در نتیجه مسیر یکنواخت نور را مختل کند.
1.2.روش های کنترل
سه راه برای کاهش رفتارهای فوق وجود دارد که بر عملکرد نوردهی تأثیر می گذارد. برای جلوگیری از ناخالصی ها و حباب های حاصل از فرآیند قرار گرفتن در معرض،
در بخش
1.2.1 از فتوسنتز کم شسته شدن و کم انتشار گاز استفاده می شود. به منظور جلوگیری از حباب و ذرات از حک شدن بر روی ویفر، بخش
1.2.2 روش سیم کشی خاص و روش پوشش ضخیم را شرح می دهد. در نهایت، برای متعادل کردن توزیع دما و تنش با حمل آلایندهها، ذرات، حبابها و گرما به دور از ناحیه قرار گرفته،
بخش
1.2.3از روش های تامین و بازیابی مایعات استفاده می کند.
نیکون اولین شرکتی در جهان بود که یک اسکنر غوطه وری ArF را برای تولید توسعه داد، NSR-S609B [75]. قبل از این، آنها تلاش های زیادی برای ساختارهای سر غوطه ور بر اساس روش پر کردن محلی انجام داده بودند. آنها روش پر کردن موضعی را با و بدون سیستم تامین و بازیابی مایع شبیه سازی کردند [54،67] و دریافتند که سیستم تامین و بازیابی مایع نیز به عنوان یک ساختار مهار مایع عمل می کند. در غیاب سیستم تامین و بازیابی، مقداری از مایع خارج از ناحیه لنز قرار دارد و مقداری فضای خالی در زیر ناحیه لنز قرار دارد. در حضور یک سیستم تغذیه و بازیابی، جریان بازیابی کشش سطحی را در سطح مشترک گاز-مایع در اطراف گودال مایع تقویت میکند، و مایع را با موفقیت در یک ناحیه محلی زیر لنز محدود میکند و محتوی مایع بهتری را نشان میدهد.
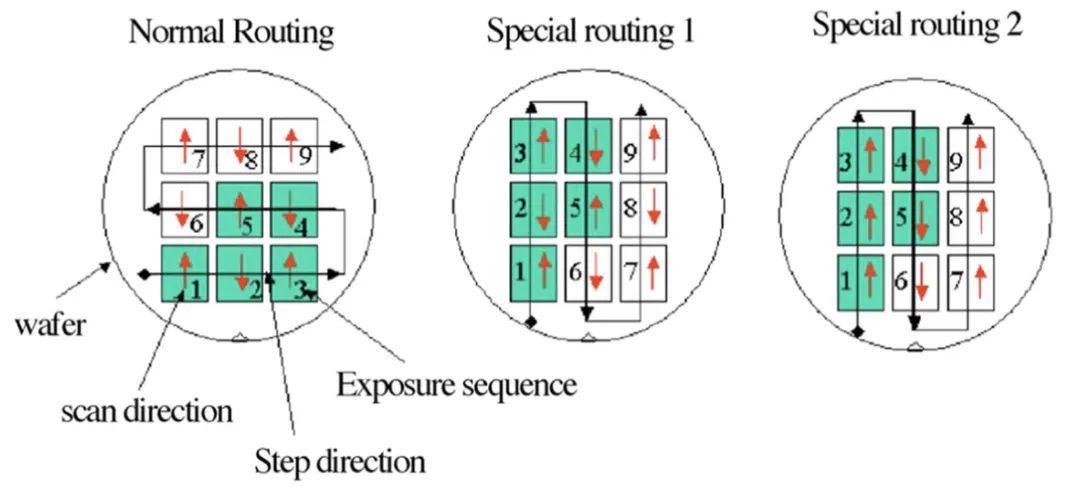
سیم کشی معمولی و 2 سیم کشی مخصوص برای کاهش عیوب
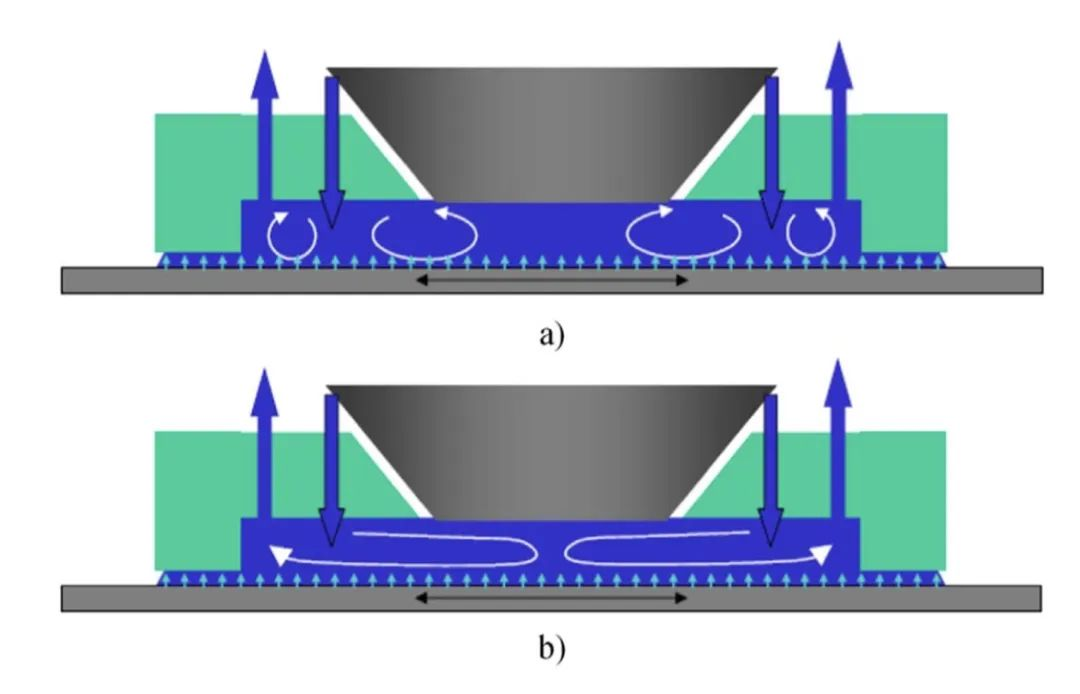
دو آرایش نازل متفاوت الف) نازل نسل قدیم؛ ب) نازل های جدید.
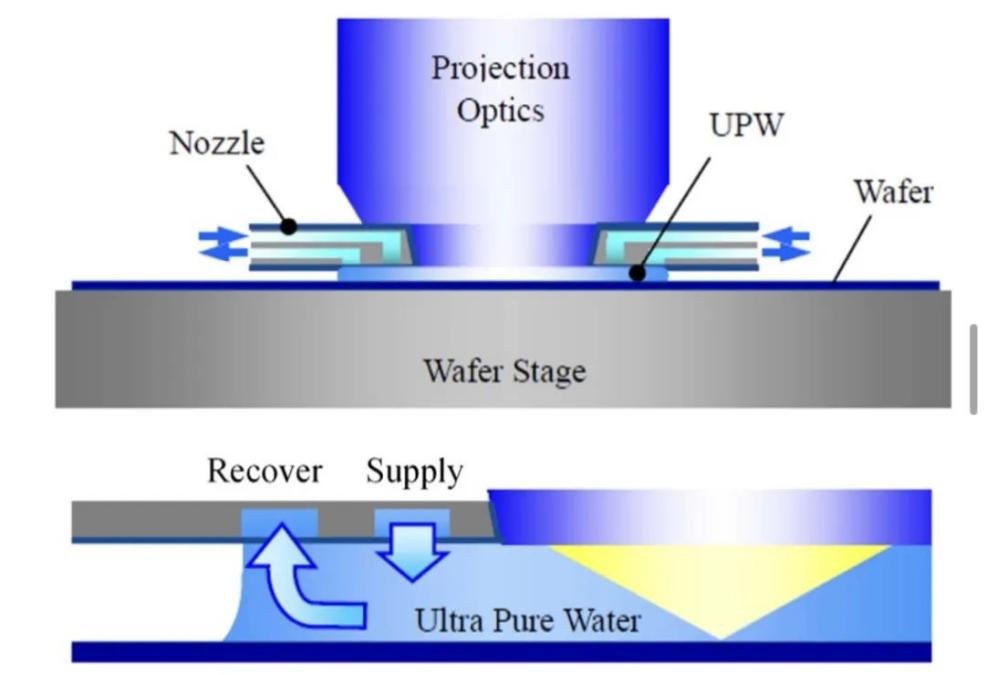
ساختار اساسی سیستم غوطه وری LLF.
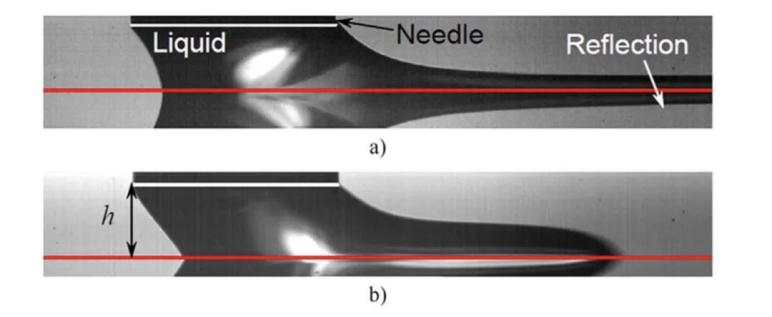
یک شکل منیسک معمولی. آ). کشش فیلم، ب). سرریز اینرسی.
2. کنترل رفتار جریان پایداری منیسک
2.1.ناپایداری منیسک و قطرات باقیمانده در لیتوگرافی غوطه وری
در طول فرآیند، مایع باید در شکاف بین آخرین لنز نوری و ویفر باقی بماند. همانطور که ویفر در زیر مایع حرکت می کند، نیروهای چسبناک شروع به کشیدن مایع به سمت جهت اسکن می کنند و بر منیسک تأثیر می گذارد. فراتر از سرعت معین، ثبات منیسک در حال عقب نشینی مختل می شود و مایع از حجم مایع خود خارج می شود و متعاقباً به قطرات تجزیه می شود. این قطرات باقیمانده می توانند روی ویفر باقی بمانند و باعث نقص های تصویری متعددی شوند. اکنون در صنعت نیمه هادی، سرعت اسکن تولید انبوه 800 میلی متر بر ثانیه است و در آینده بالاتر خواهد بود. بنابراین، لازم است اطمینان حاصل شود که منیسک میدان غوطه ور در این سرعت مورد نیاز، ثبات خود را از دست نمی دهد.
2.2تحقیقات اساسی در مورد ثبات مینیسک
سرعت بحرانی به حداکثر سرعتی اطلاق می شود که می توان بدون رسوب مایع باقیمانده به دست آورد و یک پارامتر عملکرد بسیار مهم در لیتوگرافی غوطه وری است. از طریق آزمایشهای "کشیدن قطره" روی 41 مقاوم نوری مختلف [80،87،88]، نتایج نشان میدهد که سرعت بحرانی با افزایش زاویه تماس رکود ایستا، هم در حالت ترسیم فیلم و هم در حالت سرریز اینرسی، به طور قابلتوجهی افزایش مییابد. .
2.3.روش های کنترل
سه راه برای کاهش قطرات باقیمانده روی ویفر وجود دارد. به منظور بهبود پایداری منیسک و جلوگیری از تشکیل قطرات باقیمانده در هنگام قرار گرفتن در معرض، می توان از فوتوروفوبیک بیشتری در لیتوگرافی غوطه وری استفاده کرد. برای حذف قطرات باقیمانده که به تازگی از منیسک خارج شده اند، از یک پرده هوا و یک محیط متخلخل استفاده می شود. به منظور کنترل سرعت جریان مایع در نزدیکی کانال بازیابی و تسهیل عملکرد بازیابی، اصلاح سطح بر اساس سطوح ناهمگن با کنتراست ترشوندگی را می توان روی سر غوطه ور اعمال کرد.
2.3.1. آبگریزی سطح گنبد اصلاح شده سرعت اسکن ویفر و نوردهی را کنترل می کند. آبگریزی بالاتر به معنای زاویه تماس استاتیکی بالاتر است که حرکت مایع غوطهور را آسانتر و سریعتر میکند بدون اینکه قطرات باقیمانده را پشت سر بگذارد. بنابراین، آب گریزی بالاتر برای به حداکثر رساندن توان عملیاتی کلیدی است و هنگامی که با نرخ عیب کمتر ترکیب شود، می تواند بازده را نیز افزایش دهد.
2.3.2.روش دوم نگهداری مایع
یکی دیگر از راه های کنترل پایداری مینیسک، طراحی خاص سر فرو رفته است. با در نظر گرفتن زوایای تماس مختلف بین مقاومتها و پوششهای مختلف و مایع غوطهور، ساختار سر غوطهور باید بتواند محدوده عملیاتی گستردهای را در سرعتهای اسکن بالا به دست آورد. ASML گزارش می دهد که استفاده از سر غوطه ور جدید به طور قابل توجهی کل عیوب (بیش از 3 برابر) را زمانی که سرعت اسکن 600 میلی متر بر ثانیه است کاهش می دهد.
رایج ترین بهینه سازی برای سرهای غوطه ور ساختار پرده هوا است. این طرح یک پرده هوای پرفشار در اطراف ناحیه غوطه ور ایجاد می کند و سیال را در شکاف زیر آخرین عنصر نوری نگه می دارد.
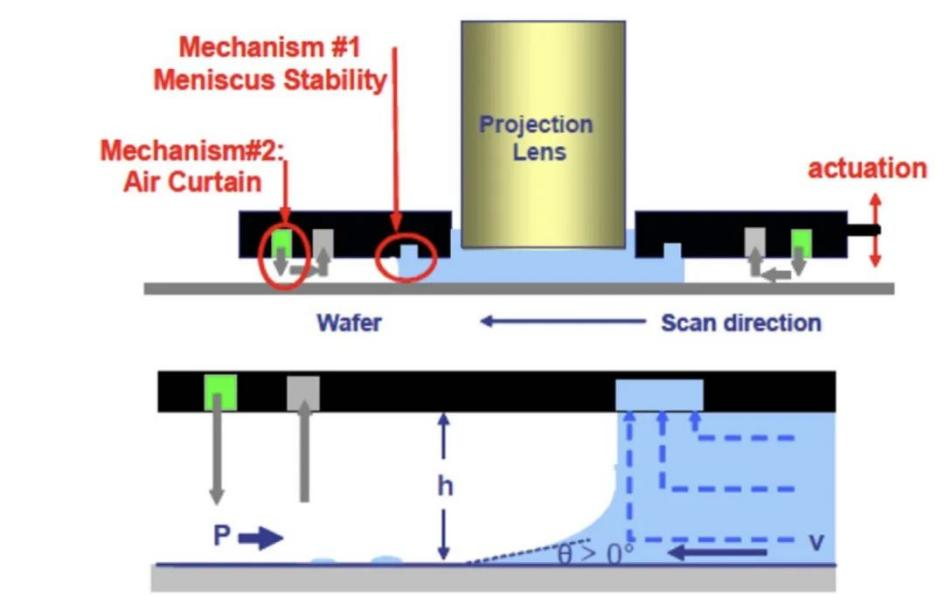
2.3.3.اصلاح سطح سر غوطه ور
اصلاحات سطح فوق برای کنترل پایداری مینیسک همگی روی ویفرها اعمال می شوند و بر اساس سطوح همگن هستند، اما سطوح ناهمگن با کنتراست ترشوندگی نیز می توانند برای قرار دادن مایع در شکاف استفاده شوند. با توجه به اینکه فرآیند لیتوگرافی واقعی ممکن است اجازه اصلاح ناهمگن سطح مقاومت را ندهد، این روش را می توان برای سر غوطه ور اعمال کرد.
Fountyl Technologies PTE Ltd، بر صنعت تولید نیمه هادی تمرکز دارد، محصولات اصلی عبارتند از: پین چاک، چاک سرامیکی متخلخل، افکتور انتهایی سرامیکی، پرتو مربع سرامیکی، دوک سرامیکی، خوش آمدید به تماس و مذاکره!











