सिलिकॉन कार्बाइड वेफर काटने के प्रकार
सिलिकॉन कार्बाइड एक बहुत कठोर और भंगुर पदार्थ है (मोह कठोरता 9.2), जो प्रसंस्करण समस्याएं पैदा कर सकता है। यह बैक-एंड प्रक्रिया के दौरान विशेष रूप से सच है, जहां वेफर्स को पैक करने से पहले अलग-अलग चिप्स में विभाजित किया जाना चाहिए।
1,डायमंड ब्लेड काटना
मैकेनिकल डायमंड ब्लेड कटिंग SiC वेफर्स को अलग करने की एक पारंपरिक तकनीक है।
वेफर को नीली फिल्म पर लगाया जाता है और हीरे से लेपित ब्लेड से काटा जाता है जो तेज गति से घूमता है। कटिंग रनवे की चौड़ाई आमतौर पर 50 से 100 माइक्रोन की सीमा में होती है।
SiC की कठोरता के कारण, ब्लेड की काटने की गति कम होती है, और काटने वाले ब्लेड का घर्षण अधिक होता है, जिसके परिणामस्वरूप लागत अधिक होती है। इसके अलावा, ब्लेड काटने से चिप किनारे का विखंडन और प्रदूषण हो सकता है। सिलिकॉन कार्बाइड वेफर का आकार 4 इंच से 6 इंच व्यास में बदलने के साथ, संचयी रनवे की लंबाई दोगुनी से भी अधिक हो गई, जो सभी कटिंग करने के लिए एक मानक ब्लेड की क्षमता से परे है। नतीजतन, ब्लेड को तब बदला जाना चाहिए जब वेफर अभी भी काम करने की स्थिति में है और काटने की प्रक्रिया के दौरान फट सकता है, जिससे वेफर को नुकसान पहुंच सकता है।
उदाहरण के लिए, 100 मिमी (4-इंच) में SiC वेफर स्क्राइबिंग के एक पीसी को 6 से 8 घंटे लगते हैं, और किनारे टूटने का कारण बनना आसान है। इसलिए, इस पारंपरिक अकुशल प्रसंस्करण विधि को धीरे-धीरे लेजर स्क्रिबिंग द्वारा प्रतिस्थापित किया गया है।
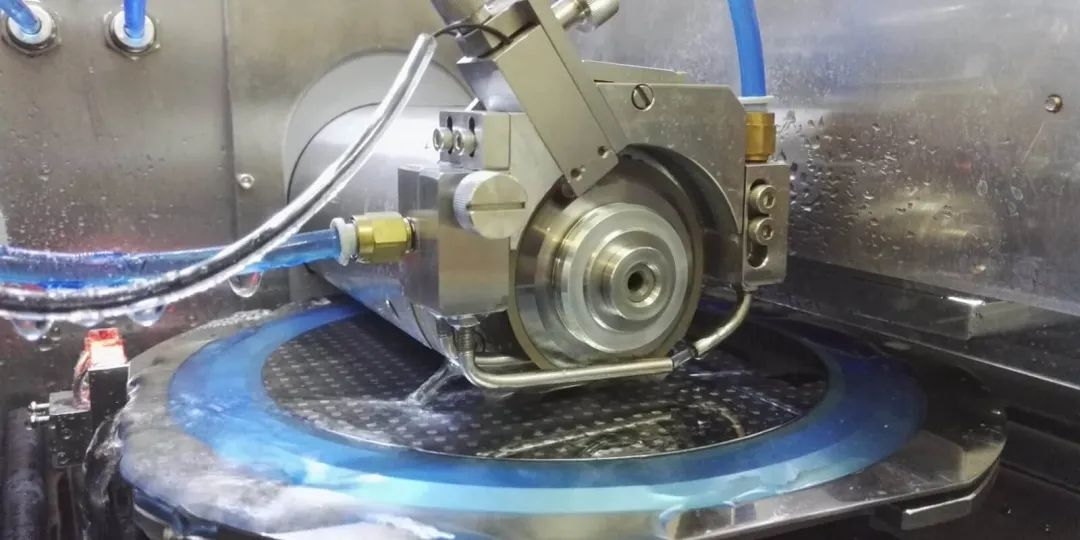
2,लेजर एब्लेशन कटिंग
लेजर एब्लेशन मैकेनिकल वेफर कटिंग का एक विकल्प है। लेजर बीम कटिंग रनवे पर केंद्रित है। सामग्री को अवशोषित लेजर ऊर्जा द्वारा गर्म किया जाता है। इसके परिणामस्वरूप महत्वपूर्ण ताप प्रभावित क्षेत्र और सूक्ष्म दरारें उत्पन्न होती हैं। नीली फिल्म गर्मी से भी प्रभावित हो सकती है, जो बाद की पैकेजिंग प्रक्रिया को प्रभावित कर सकती है। इसके अलावा, एब्लेशन दर बहुत कम है और चिप को अलग करने के लिए कई बार प्रदर्शन करने की आवश्यकता होती है। दोहराव की संख्या वेफर की मोटाई और काटने की गति पर निर्भर करती है। चिप पर सामग्री के अवशेष से बचने के लिए, वेफर की सतह को एक सुरक्षात्मक कोटिंग के साथ लेपित किया जाना चाहिए। इस कटिंग तकनीक का मुख्य नुकसान निम्न धार गुणवत्ता और कम उत्पादकता है।
स्टील्थ कटिंग में, SiC वेफर से गुजरने वाली एक छोटी-तरंग दैर्ध्य लेजर किरण को सामग्री के अंदर केंद्रित किया जाता है। यह सामग्री के अंदर स्थानीयकृत दोषों की एक परत बनाता है, जो वेफर पृथक्करण के लिए प्रारंभिक बिंदु बन जाता है। सबसे पहले, लेजर बीम वेफर के निचले हिस्से पर केंद्रित होती है और परत दर परत ऊपर की ओर बढ़ती है। विभाजन प्रक्रिया के कारण, काटने के रास्ते में कोई सामग्री नहीं हटती, जिसके परिणामस्वरूप शून्य चीरा लगती है। दूसरा, चिप का अंतिम पृथक्करण एक अलग यांत्रिक स्प्लिसिंग प्रक्रिया के साथ-साथ ब्लू फिल्म के विस्तार द्वारा पूरा किया जाना चाहिए। क्योंकि लेजर वेफर के अंदर सामग्री को गर्म करता है, इसलिए वेफर सतह पर कोई थर्मल क्षति नहीं होती है। ओवरलैपिंग क्षेत्रों के साथ मोती के हार पैटर्न में दोष केवल सामग्री के अंदर उत्पन्न हो सकते हैं। इसके अलावा, प्रत्येक काटने की दर लगभग 200 मिमी/सेकेंड है, और कुछ अनुप्रयोगों में 300 मिमी/सेकेंड तक पहुंच सकती है। हालाँकि, सामग्री की मोटाई के आधार पर, चिप को अलग करने में सक्षम होने से पहले लेजर को कई बार गुजरना पड़ता है। इसके परिणामस्वरूप परिवर्तित परत के कारण चिप की साइड की दीवारें क्षतिग्रस्त हो जाती हैं। वेफर के अंदर बहुत छोटे बिंदुओं पर लेजर बीम को केंद्रित करने के लिए, कटिंग रनवे में एक सपाट सतह पर बिखरी हुई बीम को चिकना और न्यूनतम करने की आवश्यकता होती है। लेजर के प्रतिबिंब से बचने के लिए, मेटल कट-फ्री रनवे की आवश्यकता होती है। एक और नुकसान यह है कि रनवे खोलने के लिए आवश्यक चौड़ाई वेफर मोटाई (आमतौर पर वेफर मोटाई का 40%) का एक कार्य है, जिसका अर्थ है कि 350μm की मोटाई वाले मानक SiC वेफर के लिए, आवश्यक न्यूनतम कट रनवे चौड़ाई 140μm है।
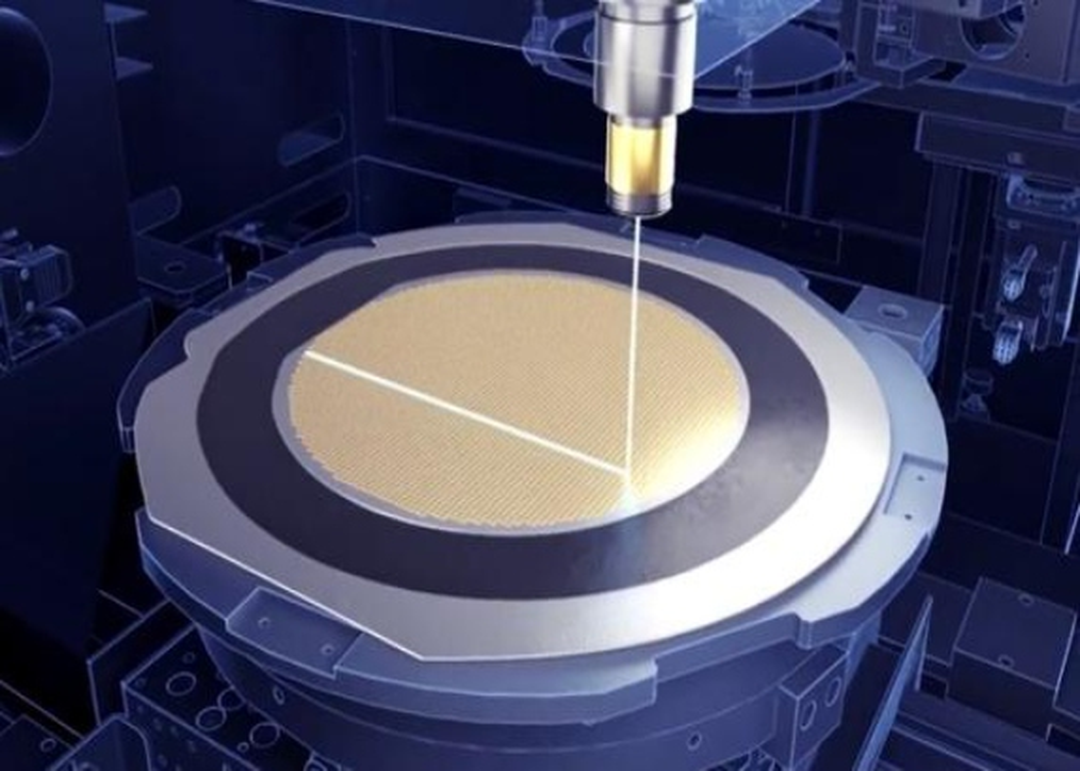
3, टीएलएस काटना
थर्मल लेजर पृथक्करण सिलिकॉन कार्बाइड वेफर्स को अलग करने का एक तेज़, स्वच्छ और लागत प्रभावी विकल्प है। लेज़र सामग्री को गर्म करता है और स्पर्शरेखीय तन्य तनाव के पैटर्न से घिरा हुआ संपीड़न तनाव का एक क्षेत्र बनाता है। फिर बहुत कम मात्रा में विआयनीकृत जल स्प्रे का छिड़काव किया जाता है, जो पहले क्षेत्र के पास एक दूसरा ठंडा क्षेत्र बनाता है, जिससे स्पर्शरेखीय तन्य तनाव का एक पैटर्न बनता है। तन्य तनाव उस क्षेत्र में निर्मित होता है जहां दो तनाव पैटर्न ओवरलैप होते हैं, जो पूरी सामग्री के माध्यम से दरार की नोक को खोलता है और मार्गदर्शन करता है।
टीएलएस कटिंग एक एकल-चरणीय प्रक्रिया है जो 300 मिमी/सेकेंड तक की पृथक्करण गति पर पूरी मोटाई के वेफर्स को अलग कर सकती है। प्रारंभिक बिंदु वेफर सतह पर एक स्थानीय या निरंतर उथली खरोंच है। चूंकि टीएलएस कटिंग एक विभाजित प्रक्रिया है, इसलिए इसमें कटिंग रनवे की चौड़ाई कम करने और प्रत्येक वेफर पर चिप्स की संख्या बढ़ाने की क्षमता है। चिप का किनारा चिकना है, कोई अवशिष्ट तनाव या सूक्ष्म दरारें और विखंडन क्षेत्र नहीं हैं। सामने के रनवे पर धातु संरचना (पीसीएम) और चिप पर पॉलीमाइड स्वीकार्य हैं। इसके अलावा, चूंकि पृथक्करण बाद के भौतिक पृथक्करण/फ्रैक्चर के बजाय लोब से प्राप्त होता है, इसलिए बैकिंग धातु को प्रदूषण या गर्मी से प्रभावित हुए बिना अलग किया जा सकता है। पूरी तरह से धातुयुक्त बैक के साथ एक विशिष्ट पावर डिवाइस वेफर पर टीएलएस कटिंग प्रक्रिया का उपयोग करके उपज विश्लेषण से पता चलता है कि कटिंग रनवे पर पॉलीमाइड और धातु संरचनाओं की औसत उपज 98% से अधिक है।
4,जल निर्देशित लेजर स्क्रिबिंग
जल गाइड लेजर लेजर को सूक्ष्म जल स्तंभ में केंद्रित करने के लिए है, जल स्तंभ का व्यास नोजल एपर्चर के अनुसार भिन्न होता है, 100 ~ 30 माइक्रोन विभिन्न विनिर्देश हैं। जल स्तंभ और वायु इंटरफ़ेस के बीच कुल प्रतिबिंब के सिद्धांत का उपयोग करते हुए, लेजर को जल स्तंभ में पेश किए जाने के बाद जल स्तंभ यात्रा की दिशा में प्रचारित किया जाएगा। इसे पानी के स्तंभ की स्थिर सीमा के भीतर संसाधित किया जा सकता है, और लंबी प्रभावी कार्य दूरी विशेष रूप से मोटी सामग्री को काटने के लिए उपयुक्त है। जब पारंपरिक लेजर कटिंग होती है, तो ऊर्जा का संचय और संचालन काटने के रास्ते के दोनों किनारों पर थर्मल क्षति का मुख्य कारण होता है, और जल-निर्देशित लेजर पानी के स्तंभ की भूमिका के कारण प्रत्येक पल्स की अवशिष्ट गर्मी को जल्दी से दूर ले जाएगा। , और वर्कपीस पर जमा नहीं होगा, इसलिए काटने का रास्ता साफ है। इन फायदों के आधार पर, जल-निर्देशित लेजर कटिंग के सिद्धांत में सिलिकॉन कार्बाइड एक अच्छा विकल्प है, लेकिन तकनीक कठिन है, संबंधित उपकरण की परिपक्वता अधिक नहीं है, क्योंकि नोजल के पहनने वाले हिस्से में बड़ी उत्पादन कठिनाई होती है, यदि आप नहीं कर सकते छोटे पानी के स्तंभ को सटीक और स्थिर रूप से नियंत्रित करें, पानी की बूंदों के छींटे चिप को अलग करते हैं, जिससे उपज प्रभावित होती है। इसलिए, यह प्रक्रिया अभी तक सिलिकॉन कार्बाइड वेफर्स के उत्पादन में लागू नहीं की गई है।
फाउंटिल टेक्नोलॉजीज पीटीई लिमिटेड सिरेमिक वैक्यूम चक में विशेषज्ञता रखती है, जो एसआईसी काटने की प्रक्रिया के लिए सर्वोत्तम सिरेमिक फिक्स्चर प्रदान करती है, 2/3/6/8/12/14 इंच में विभिन्न चक।












