Ikatan chip: Proses penempatan chip pada substrat
Proses pengemasan merupakan langkah terakhir dalam pembuatan semikonduktor, dan urutannya adalah penggilingan, pemotongan, pemasangan, pengkabelan, dan pembentukan. Urutan proses-proses ini dapat berubah sesuai dengan perubahan teknologi pengemasan, dan dapat juga berkaitan erat satu sama lain atau digabungkan. Artikel ini berfokus pada ikatan wafer, yang merupakan teknik enkapsulasi yang digunakan untuk menyatukan chip yang dipisahkan dari wafer ke substrat enkapsulasi (bingkai timah atau PCB) setelah proses pemotongan.

1.Apa itu ikatan?
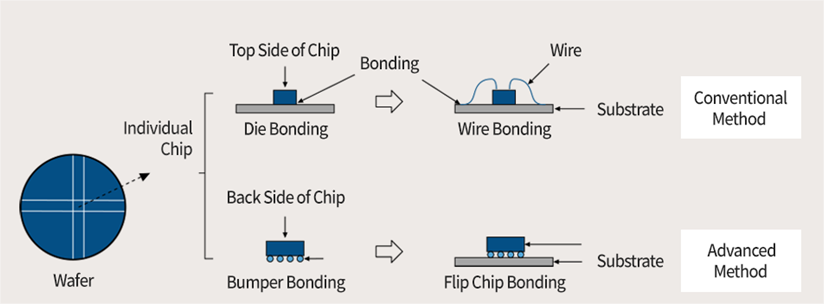
Dalam proses semikonduktor, "ikatan" mengacu pada sambungan chip wafer ke substrat. Bonding dibedakan menjadi dua jenis, yaitu metode tradisional dan metode lanjutan. Metode tradisional mencakup koneksi chip (atau koneksi chip) dan koneksi kabel, sedangkan metode lanjutan mencakup koneksi flip chip yang dikembangkan oleh IBM pada akhir 1960-an. Flip chip bonding adalah metode yang menggabungkan die bonding dan wire bonding, serta menghubungkan chip dan substrat dengan membentuk cembung pada chip liner.
2. Proses pengikatan
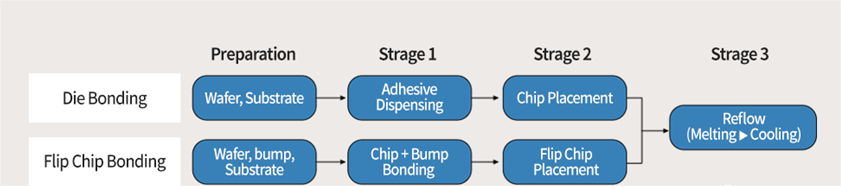
Untuk pengikatan chip, hal pertama yang harus dilakukan adalah melapisi perekat pada substrat kemasan. Lalu, letakkan chip di atasnya, sematkan menghadap ke atas. Sebaliknya, dalam kasus pengikatan chip flip, yang merupakan metode yang lebih maju, tonjolan kecil yang disebut bola solder dilekatkan pada lapisan chip. Kemudian, chip ditempatkan pada media dengan pin menghadap ke bawah. Dalam kedua metode tersebut, unit rakitan melewati saluran refluks suhu yang dapat disesuaikan seiring waktu untuk melelehkan perekat atau bola solder. Kemudian didinginkan untuk menempelkan chip (atau benjolan) ke media.
3. Pilih & Tempat Keripik
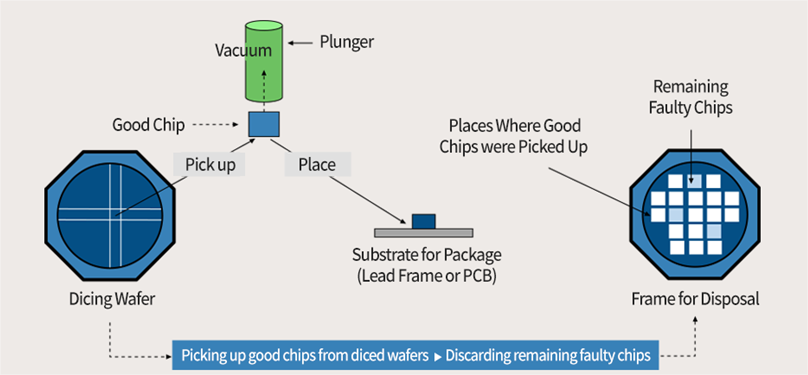
Melepaskan chip yang menempel pada pita satu per satu disebut "Pick". Ketika chip yang baik dikeluarkan dari wafer dengan alat penyedot, penempatannya pada permukaan substrat kemasan disebut "Tempat". Kedua tugas ini, yang disebut "Pick & Place", dilakukan pada Die Bonde.
4. Pelepasan chip
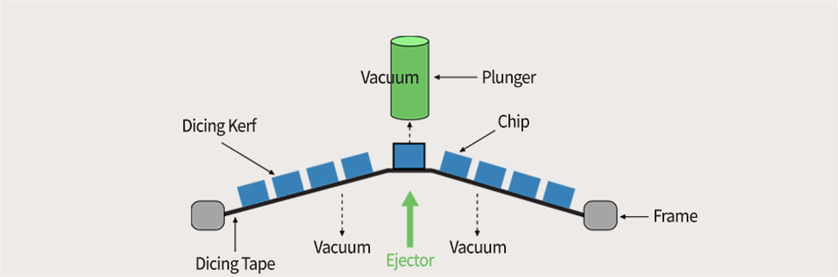
Gunakan metode yang mudah untuk mengambil chip: "ejeksi". Sebuah ejector digunakan untuk menerapkan kekuatan fisik pada chip target, menyebabkan ukuran langkahnya sedikit berbeda dari chip lainnya. Setelah mengeluarkan chip dari bawah, tarik chip ke atas dari atas dengan penyedot pita vakum. Pada saat yang sama, tarik bagian bawah selotip dengan penyedot agar permukaan selotip menjadi halus.
5. Keripik diikat dengan resin epoksi
Pada saat pengikatan chip, penyambungan dilakukan dengan menggunakan solder atau pasta yang mengandung logam (Power Tr), atau polimer (polimida) juga dapat digunakan untuk pengikatan chip. Pada bahan polimer, resin epoksi pasta atau cair yang mengandung perak relatif mudah digunakan dan memiliki frekuensi penggunaan yang tinggi.
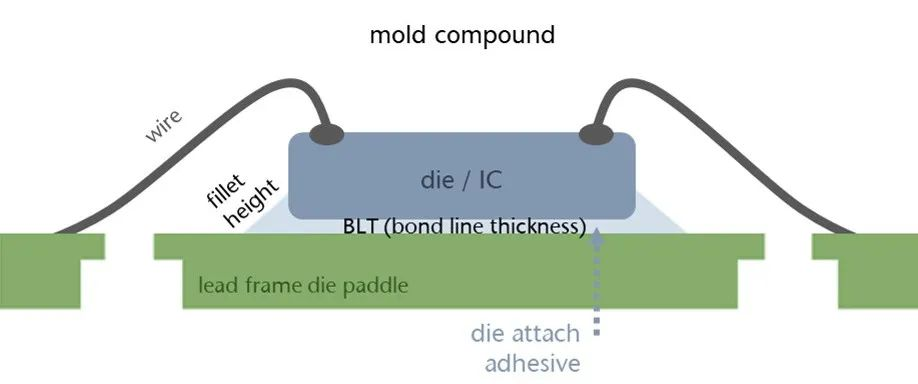
6. Die coating (DAF) digunakan untuk pengikatan chip
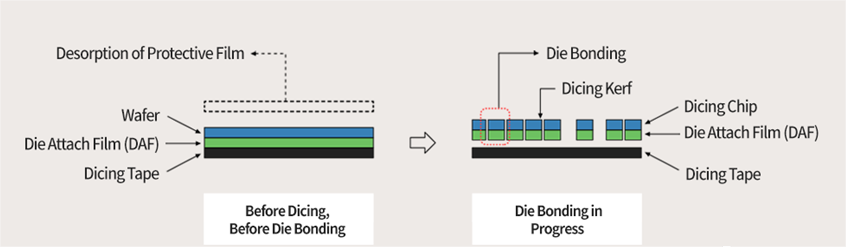
DAF adalah lapisan tipis yang ditempelkan pada bagian bawah chip. Ketebalan DAF dapat diatur hingga ketebalan yang sangat tipis dan konstan. Ini banyak digunakan tidak hanya dalam pengikatan chip-ke-substrat, tetapi juga dalam pengikatan chip-ke-chip untuk membuat paket multi-chip (MCP). Dari struktur chip, DAF di bagian bawah chip direkatkan ke chip, dan pita pengiris direkatkan ke DAF di bawahnya, dan daya rekatnya lemah. Untuk melakukan pengikatan chip pada struktur ini, setelah chip dan DAF dikeluarkan dari pita, chip ditempatkan langsung pada substrat tanpa menggunakan resin epoksi.
Fountyl Technologies PTE Ltd, berfokus pada industri manufaktur semikonduktor, produk utama meliputi: Pin chuck, chuck keramik berpori, efektor ujung keramik, balok persegi keramik, spindel keramik, selamat datang untuk menghubungi dan negosiasi!











