Kontrol aliran dalam litografi perendaman
Selama lebih dari sepuluh tahun, litografi perendaman telah menjadi teknologi paparan utama dalam manufaktur semikonduktor. Dibandingkan dengan metode litografi kering tradisional, teknik ini sangat meningkatkan resolusi eksposur dengan menyuntikkan cairan indeks bias tinggi ke dalam celah antara lensa dan permukaan wafer. Menjaga kemurnian dan keseragaman cairan terendam serta menghindari pembentukan tetesan sisa dalam proses pemindaian berkecepatan tinggi merupakan dua tantangan besar yang dihadapi pengembangan teknologi litografi terendam. Kontaminan, partikel, gelembung, pemanasan dan tekanan pada cairan dapat mengganggu kontinuitas indeks bias. Pergerakan wafer berkecepatan tinggi selama pemindaian dapat mengganggu kestabilan meniskus pada antarmuka antara cairan dan gas di sekitarnya, yang mengakibatkan tetesan sisa pada wafer. Fenomena di atas akan mempengaruhi kinerja eksposur litografi perendaman, dan metode kontrol perilaku aliran yang sesuai diperlukan untuk menyelesaikan masalah tersebut.
1, Pengaruh kontrol perilaku aliran terhadap kemurnian dan keseragaman cairan
1.1.Pengaruh perilaku aliran terhadap kemurnian dan keseragaman cairan
1.1.1.Partikel dan kontaminan
Partikel dan kontaminan merupakan sumber utama pengotor padat dalam cairan terendam. Partikel yang tersuspensi dalam cairan terendam di dekat permukaan wafer atau di atas photoresist dapat dicitrakan ke dalam photoresist yang mendasarinya atau ditransfer ke dalam photoresist selama pengembangan.
Partikel mungkin ada dalam persediaan cairan atau mungkin berasal dari permukaan mana pun yang disentuh cairan. Pertama, cairan yang digunakan untuk perendaman pasti mengandung partikel dan kotoran, sehingga air deionisasi ruangan bersih digunakan sebagai larutan perendaman dan selanjutnya diolah dan disaring sebelum disuntikkan ke kepala perendaman. Masalah partikel lainnya adalah terkelupasnya lapisan film di sekitar bevel wafer, yang disebabkan oleh kurangnya daya rekat antara permukaan bevel dan lapisan permukaan. Selama paparan, partikel-partikel ini dapat diangkut bolak-balik melalui meniskus cairan dari tepi wafer ke pusat wafer. Metode untuk mengatasi masalah ini meliputi pemilihan photoresist, optimalisasi formulasi EBR, dan pengolahan wafer. Bantalan wafer juga merupakan sumber partikel yang potensial. Saat kepala yang terendam bergerak melintasi wafer, kepala yang terendam mengambil partikel dan menyimpannya kembali. Pembersihan meja wafer secara konvensional akan mengurangi jumlah partikel, dan teknologi pembersihan di tempat telah terbukti menjadi metode pembersihan lapangan yang sangat efektif. Cacat lain yang disebabkan oleh partikel photoresist/topcoat transparan yang mengendap pada permukaan film photoresist atau topcoat (sebagai cacat anti gelembung) dapat dikurangi dengan mengoptimalkan formulasi pelapis.
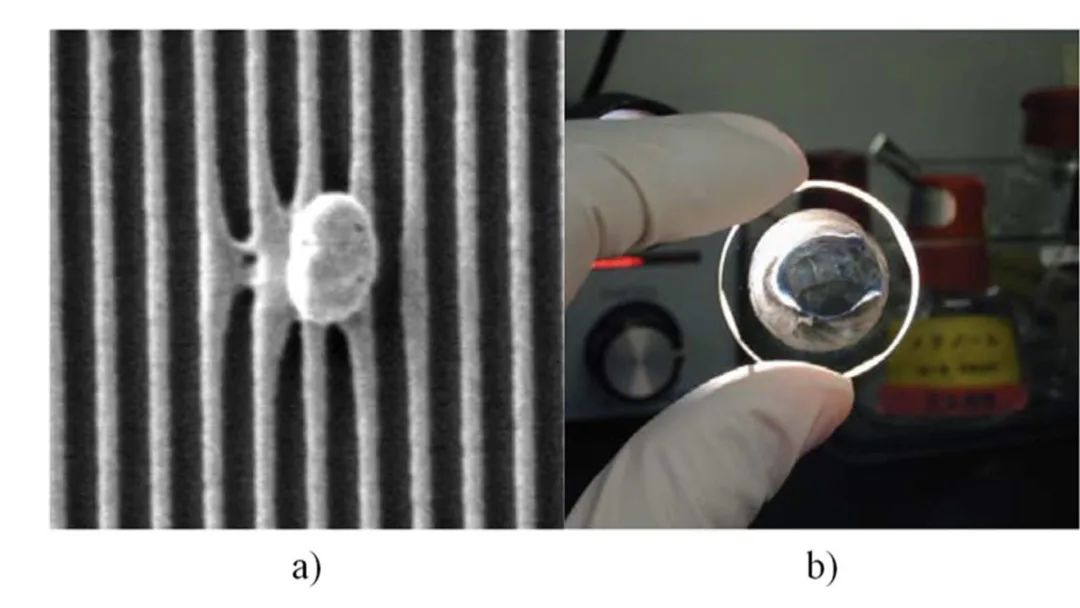
Cara efektif untuk memecahkan masalah pelindian adalah dengan menggunakan tingkat pelindian yang rendah pada lapisan penahan atau lapisan penghalang atas. Membilas film resisten dengan air deionisasi juga telah diteliti sebagai alternatif terhadap masalah pelindian. Selain itu, area kepala yang terendam lebih besar dibandingkan dengan area bidang paparan, yang berarti wafer direndam sebelum dan sesudah paparan, seperti pada proses pembilasan [38]. Karena cairan terus mengalir melalui kepala yang terendam selama pemaparan dan perendaman, kontaminan dalam cairan yang terendam akan banyak dihilangkan dan oleh karena itu dapat menggantikan proses pembilasan.
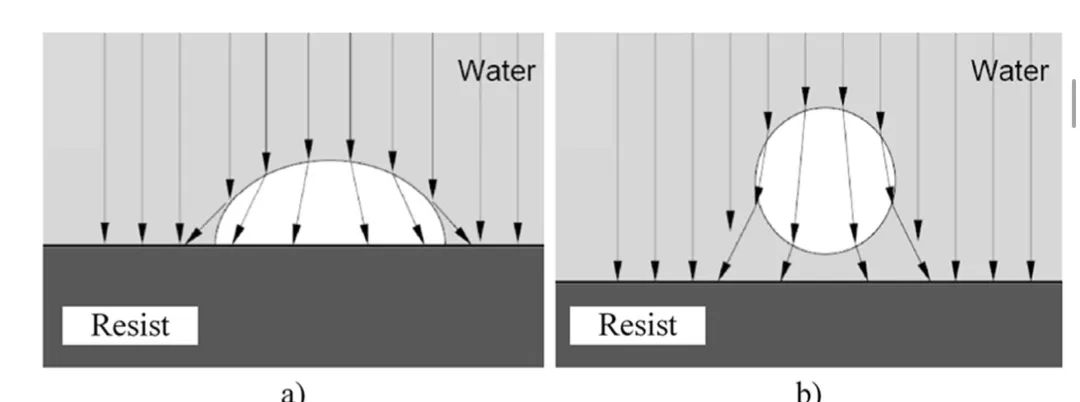
Gelembung memantulkan dan membiaskan cahaya yang masuk. a) pada permukaan photoresist, dan b) mengambang dalam larutan yang direndam.
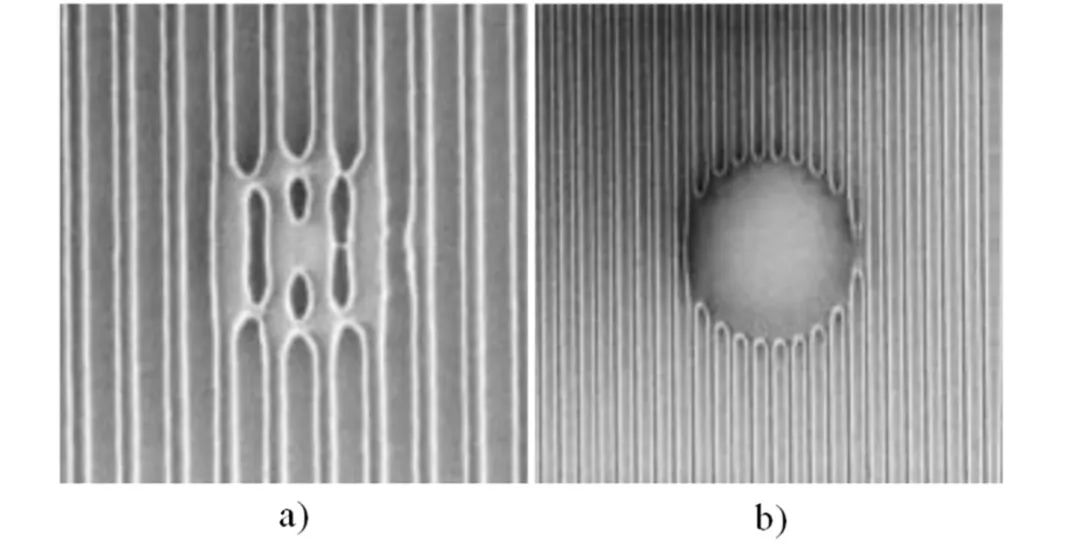
Cacat gelembung dengan ukuran berbeda. a) 0,85μm, b) 3μm.
1.1.2.Bgelembung
Salah satu tantangan utama litografi perendaman gelembung adalah persyaratan bahwa tidak ada gelembung yang muncul dalam larutan perendaman selama proses pemaparan. Antarmuka gas-cair yang melengkung yang disebabkan oleh gelembung memantulkan dan membiaskan cahaya yang datang, yang menciptakan diskontinuitas indeks bias dan meningkatkan efek hamburan, yang pada akhirnya mengakibatkan cacat pada pola dan mengurangi hasil.
Faktor utama yang mempengaruhi efek gelembung adalah waktu pemaparan, ukuran gelembung, dan ketinggian gelembung di atas wafer, dengan waktu pemaparan yang lebih pendek meningkatkan efek gelembung, menyebabkan fitur tetap berada di area yang lebih banyak bayangannya untuk waktu pemaparan yang lebih lama. . Kedua, jika ukuran gelembung sama dengan panjang gelombang cahaya yang digunakan untuk pemaparan, cahaya akan menyebar dan meningkatkan cahaya nyasar. Jika ukuran gelembung mikrometer atau lebih besar, sebagian gelembung akan menghalangi dan mengubah arah cahaya. Terakhir, penelitian ini juga menemukan bahwa efek keseluruhan gelembung pada gambar bergantung pada jarak gelembung dari permukaan wafer - semakin jauh jaraknya, semakin lemah efeknya, karena gelembung yang menjauh dari photoresist dapat dengan cepat tersapu bersih dalam waktu yang lama. fluida yang bergerak cepat. Jika perbandingan jarak gelembung dari wafer dengan diameter gelembung adalah 4:10, pengaruh satu gelembung mengambang dapat diabaikan. Saat gelembung semakin dekat ke wafer, karena aliran fluida yang lebih lambat di dekat permukaan wafer, bayangan gelembung pada bidang gambar menjadi lebih kuat dan masa pakainya di lokasi tertentu pada wafer menjadi lebih lama. Akibatnya, gelembung yang menempel pada permukaan wafer menimbulkan ancaman yang jauh lebih besar terhadap gambar bebas cacat. Melalui kajian sistematis efek hamburan gelembung pada litografi terendam, diperkirakan 60nm merupakan ukuran maksimum gelembung yang tidak akan menimbulkan cacat saat gelembung tersebut ditempelkan pada permukaan photoresist. Gelembung-gelembung pada litografi terendam mungkin disebabkan oleh campur tangan berbagai faktor seperti tekanan, suhu, reaksi fotokimia dan dinamika fluida.
1.1.3.Pemanasan
Selama pemaparan, cairan yang direndam dipanaskan secara tidak merata, dan distribusi suhu dapat mempengaruhi gambar dalam beberapa cara, sekaligus menghasilkan sejumlah kecil penyimpangan bola dan tingkat tinggi, dan cacat gambar utama adalah pengaburan. Jika kita hanya memperbolehkan jumlah pengaburan sebesar 1 nanometer, perubahan indeks bias harus dijaga agar tetap sangat kecil. Karena koefisien suhu air (dn/dτ=-10-4K-1) sangat besar dibandingkan dengan gas, suhu cairan perlu dijaga dalam 10 mK, yang memberikan batasan ketat pada penanganan cairan dan sistem kontrol suhu.
1.1.4.Menekankan
Untuk litografi perendaman, viskositas tinggi dan kepadatan tinggi dari cairan yang direndam, dibandingkan dengan udara dalam litografi kering, dapat menyebabkan tekanan yang signifikan pada permukaan lensa dan wafer. Tekanan normal dan tegangan geser ini dapat menyebabkan distorsi lensa dan birefringence, sehingga mengganggu jalur cahaya yang seragam.
1.2.Metode pengendalian
Ada tiga cara untuk mengurangi perilaku di atas yang memengaruhi kinerja paparan. Untuk menghindari kotoran dan gelembung dari proses pemaparan,
Di bagian
1.2.1 pelindian rendah dan photoresist pelepasan gas rendah digunakan. Untuk mencegah gelembung dan partikel membekas pada wafer, Bagian
1.2.2 menjelaskan metode pengkabelan spesifik dan metode pelapisan tebal. Terakhir, untuk menyeimbangkan distribusi suhu dan tekanan dengan menghilangkan kontaminan, partikel, gelembung, dan panas dari area paparan,
Bagian
1.2.3menggunakan metode pasokan dan pemulihan cairan.
Nikon adalah perusahaan pertama di dunia yang mengembangkan pemindai imersi ArF untuk produksi, NSR-S609B [75]. Sebelumnya, mereka telah melakukan banyak upaya pada struktur kepala terendam berdasarkan metode pengisian lokal. Mereka mensimulasikan metode pengisian lokal dengan dan tanpa sistem suplai dan pemulihan cairan [54,67] dan menemukan bahwa sistem suplai dan pemulihan cairan juga bertindak sebagai struktur penahanan cairan. Dengan tidak adanya sistem suplai dan pemulihan, sebagian cairan terletak di luar area lensa, dan sebagian ruang kosong di bawah area lensa. Dengan adanya sistem umpan dan pemulihan, aliran pemulihan memperkuat tegangan permukaan pada antarmuka gas-cair di sekitar lubang cairan, sehingga berhasil membatasi cairan pada area lokal di bawah lensa, sehingga menunjukkan penahanan cairan yang lebih baik.
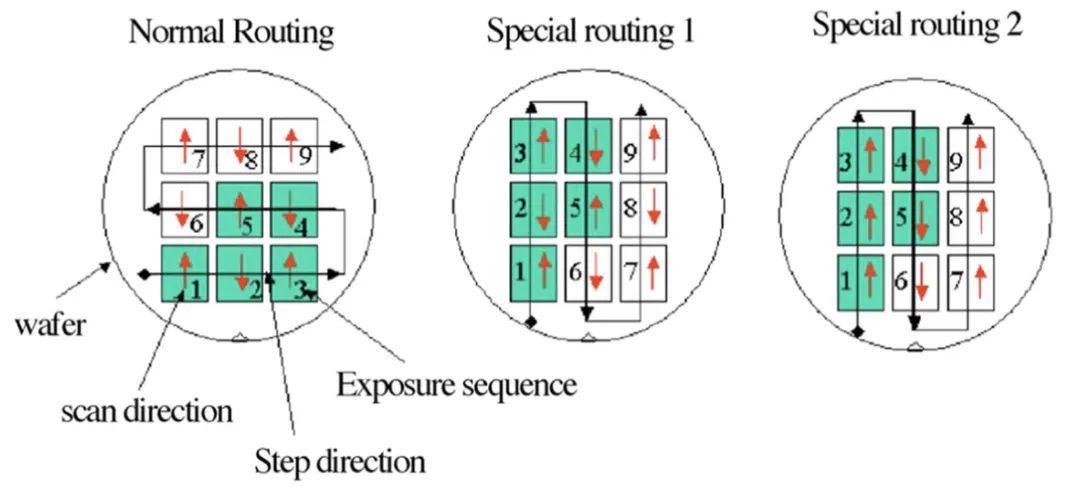
Kabel normal dan 2 kabel khusus untuk mengurangi cacat
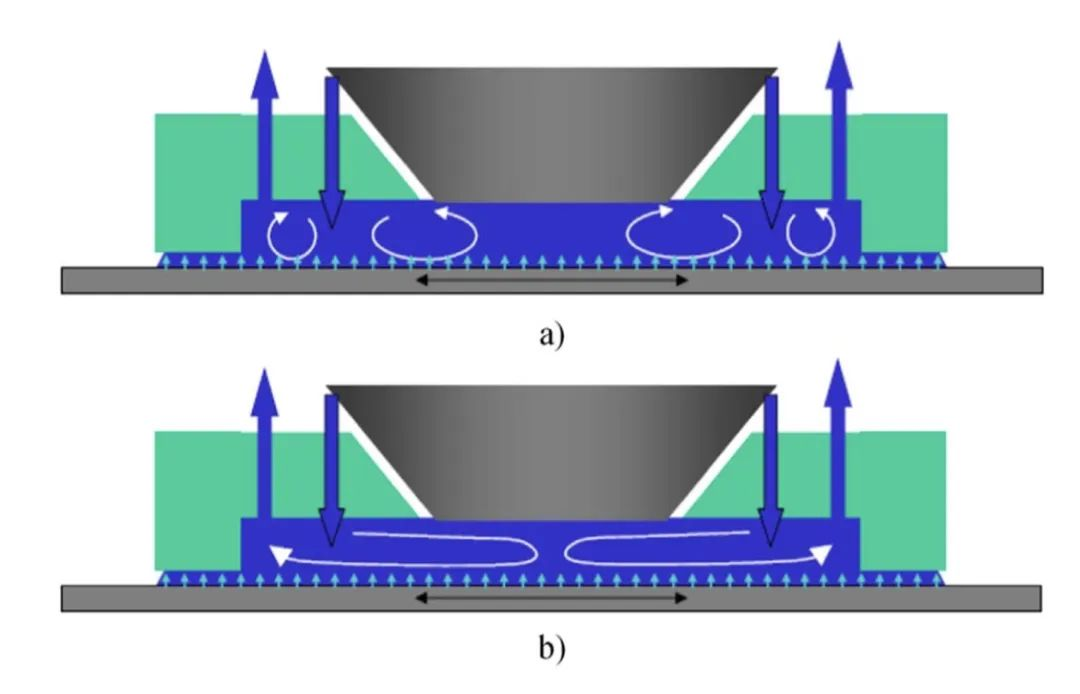
Dua pengaturan nosel yang berbeda. a) Nozel generasi lama; b) Nozel baru.
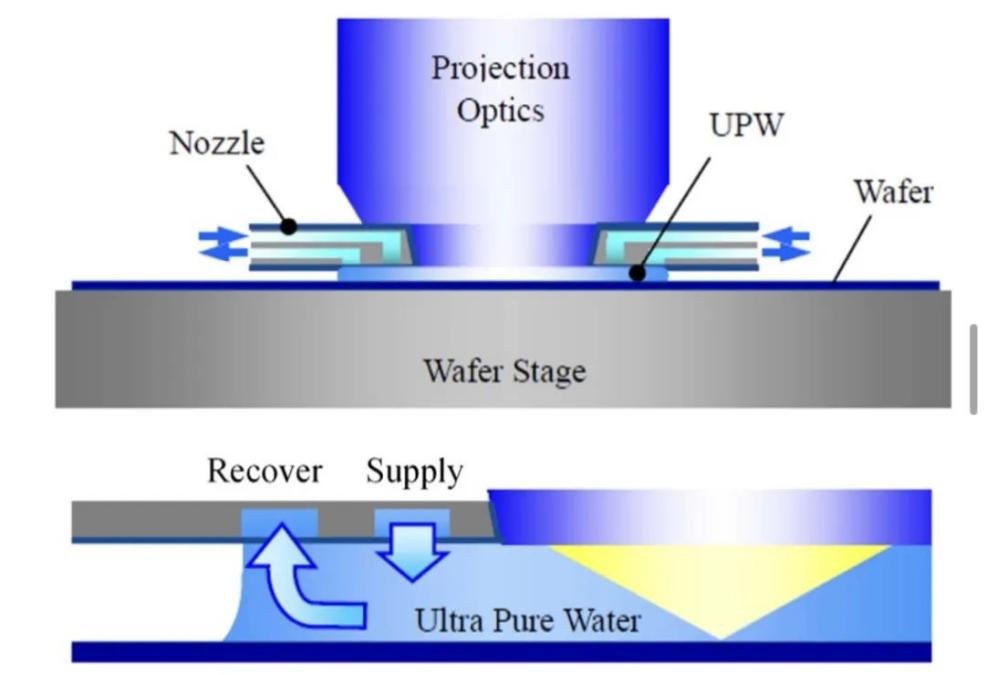
Struktur dasar sistem perendaman LLF.
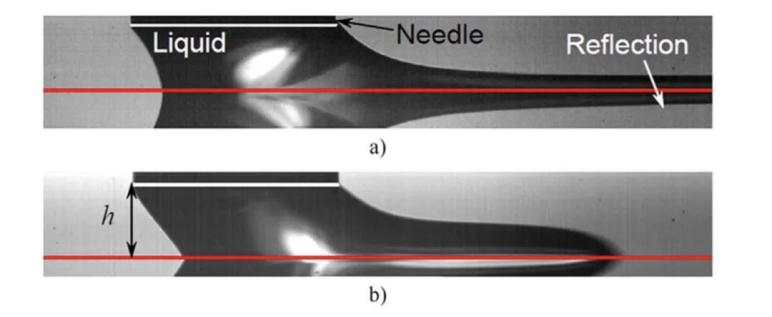
Bentuk meniskus yang khas. A). Peregangan film, b). Luapan inersia.
2. Kontrol perilaku aliran stabilitas meniskus
2.1.Ketidakstabilan meniskus dan sisa tetesan pada litografi perendaman
Sepanjang proses, cairan harus tetap berada dalam celah antara lensa optik terakhir dan wafer. Saat wafer bergerak di bawah cairan, gaya kental mulai menarik cairan ke arah pemindaian dan mempengaruhi meniskus. Di luar kecepatan tertentu, kestabilan meniskus yang surut terganggu, dan cairan ditarik keluar dari volume cairannya dan selanjutnya dipecah menjadi tetesan. Tetesan sisa ini dapat tertinggal di wafer dan menyebabkan banyak cacat gambar. Saat ini di industri semikonduktor, kecepatan pemindaian produksi massal adalah 800mm/s, dan akan lebih tinggi di masa depan. Oleh karena itu, penting untuk memastikan bahwa meniskus medan terendam tidak kehilangan stabilitas dalam persyaratan kecepatan ini.
2.2Penelitian dasar tentang stabilitas meniskus
Kecepatan kritis mengacu pada kecepatan maksimum yang dapat dicapai tanpa mengendapkan sisa cairan, dan merupakan parameter kinerja yang sangat penting dalam litografi perendaman. Melalui percobaan “drag drop” pada 41 photoresist berbeda [80,87,88], hasilnya menunjukkan bahwa kecepatan kritis meningkat secara signifikan dengan meningkatnya Sudut kontak resesi statis, baik dalam keadaan gambar film maupun dalam keadaan luapan inersia. .
2.3.Metode pengendalian
Ada tiga cara untuk mengurangi sisa tetesan pada wafer. Untuk meningkatkan stabilitas meniskus dan menghindari pembentukan tetesan sisa selama pemaparan, lebih banyak fotoresist hidrofobik dapat digunakan dalam litografi perendaman. Untuk menghilangkan sisa tetesan yang baru saja keluar dari meniskus, digunakan tirai udara dan media berpori. Untuk mengontrol laju aliran cairan di dekat saluran pemulihan dan memfasilitasi fungsi pemulihan, modifikasi permukaan berdasarkan permukaan heterogen dengan kontras keterbasahan dapat diterapkan pada kepala terendam.
2.3.1. Hidrofobisitas permukaan kubah yang dimodifikasi mengontrol kecepatan pemindaian dan pemaparan wafer. Hidrofobisitas yang lebih tinggi berarti Sudut kontak statis yang lebih tinggi, yang membuatnya lebih mudah dan cepat bagi cairan yang terendam untuk bergerak melintasi wafer tanpa meninggalkan tetesan sisa. Oleh karena itu, hidrofobisitas yang lebih tinggi merupakan kunci untuk memaksimalkan hasil dan, jika dikombinasikan dengan tingkat kerusakan yang lebih rendah, juga dapat meningkatkan hasil.
2.3.2.Metode penahanan cairan kedua
Cara lain untuk mengontrol stabilitas meniskus adalah desain khusus kepala yang terendam. Dengan mempertimbangkan sudut kontak yang berbeda antara ketahanan dan penyelesaian yang berbeda serta cairan yang terendam, struktur kepala yang terendam harus mampu mencapai jangkauan pengoperasian yang luas pada kecepatan pemindaian yang tinggi. ASML melaporkan bahwa penggunaan kepala terendam baru secara signifikan mengurangi total cacat (lebih dari 3x) ketika kecepatan pemindaian 600 mm/s.
Optimalisasi paling umum untuk kepala terendam adalah struktur tirai udara. Desain ini menciptakan tirai udara bertekanan tinggi di sekitar area terendam, menjaga cairan di celah di bawah elemen optik terakhir.
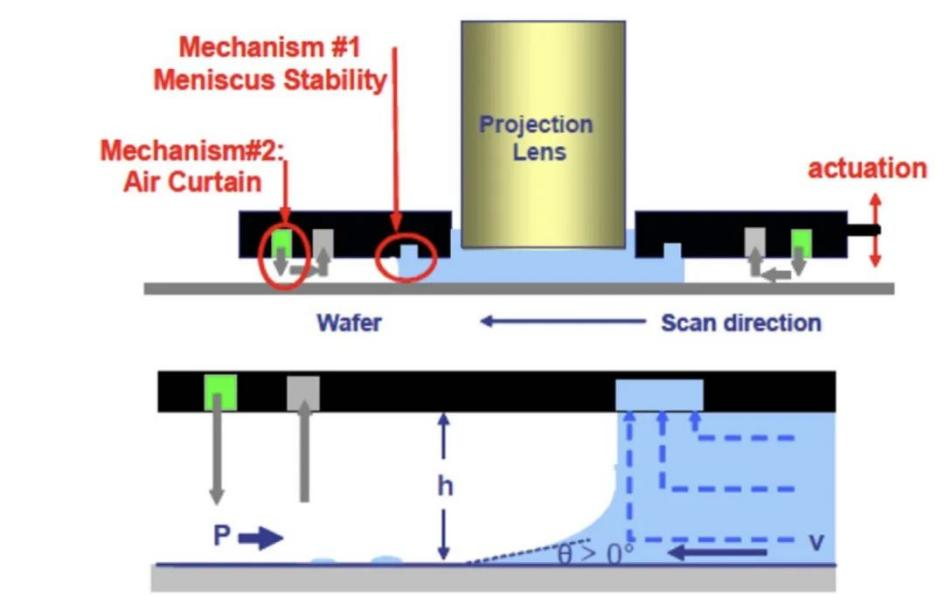
2.3.3.Modifikasi permukaan kepala yang terendam
Modifikasi permukaan di atas untuk kontrol stabilitas meniskus semuanya diterapkan pada wafer dan didasarkan pada permukaan homogen, namun permukaan heterogen dengan kontras keterbasahan juga dapat digunakan untuk menampung cairan di celah. Mengingat bahwa proses litografi yang sebenarnya mungkin tidak memungkinkan modifikasi heterogen pada permukaan penahan, metode ini dapat diterapkan pada kepala yang terendam.
Fountyl Technologies PTE Ltd, berfokus pada industri manufaktur semikonduktor, produk utama meliputi: Pin chuck, chuck keramik berpori, efektor ujung keramik, balok persegi keramik, spindel keramik, selamat datang untuk menghubungi dan negosiasi!











