液浸リソグラフィーにおけるフロー制御
10 年以上にわたり、液浸リソグラフィーは半導体製造における主要な露光技術でした。 この技術は、レンズとウエハ表面の間の隙間に高屈折率の液体を注入することにより、従来のドライリソグラフィー法と比較して、露光解像度を大幅に向上させます。 浸漬液体の純度と均一性を維持すること、および高速スキャンのプロセスでの残留液滴の形成を回避することは、浸漬リソグラフィ技術の開発が直面する 2 つの主要な課題です。 液体内の汚染物質、粒子、気泡、加熱、応力により、屈折率の連続性が損なわれる可能性があります。 スキャン中のウェハの高速移動により、液体と周囲のガスとの界面でメニスカスが不安定になり、ウェハ上に液滴が残留する可能性があります。 上記の現象は液浸リソグラフィーの露光性能に影響を与えるため、問題を解決するには対応する流れ挙動制御方法が必要です。
1、液体の純度と均一性に対する流れ挙動制御の影響
1.1.液体の純度と均一性に対する流れの挙動の影響
1.1.1.粒子と汚染物質
粒子と汚染物質は、浸漬された液体中の固体不純物の主な発生源です。 ウェーハ表面付近またはフォトレジスト上の浸漬液中に浮遊する粒子は、下にあるフォトレジストに像を形成したり、現像中にフォトレジストに転写されたりする可能性があります。
粒子は液体供給中に存在する可能性もあれば、液体が接触する任意の表面から発生する可能性もあります。 まず、浸漬に使用される液体には粒子や不純物が必然的に含まれるため、クリーンルームの脱イオン水が浸漬溶液として使用され、浸漬ヘッドに注入される前にさらに処理および濾過されます。 もう一つのパーティクルの問題は、ウェハのベベル周囲の膜の剥離であり、これはベベル表面と表面コーティングとの間の不十分な接着によって引き起こされる。 露光中、これらの粒子は液体メニスカスを通ってウエハの端からウエハの中心まで前後に輸送される可能性があります。 この問題を解決する方法には、フォトレジストの選択、EBR 配合の最適化、およびウェーハ処理が含まれます。 ウェーハパッドも粒子の発生源となる可能性があります。 浸漬ヘッドがウェーハ上を移動すると、浸漬ヘッドは粒子を拾い上げ、それらを再堆積させます。 ウェーハテーブルの従来の洗浄では粒子の数が減少し、その場洗浄技術は非常に効果的なフィールド洗浄方法であることが証明されています。 フォトレジストまたはトップコートフィルムの表面に堆積した透明なフォトレジスト/トップコート粒子によって引き起こされるその他の欠陥(気泡防止欠陥など)は、コーティング配合を最適化することで軽減できます。
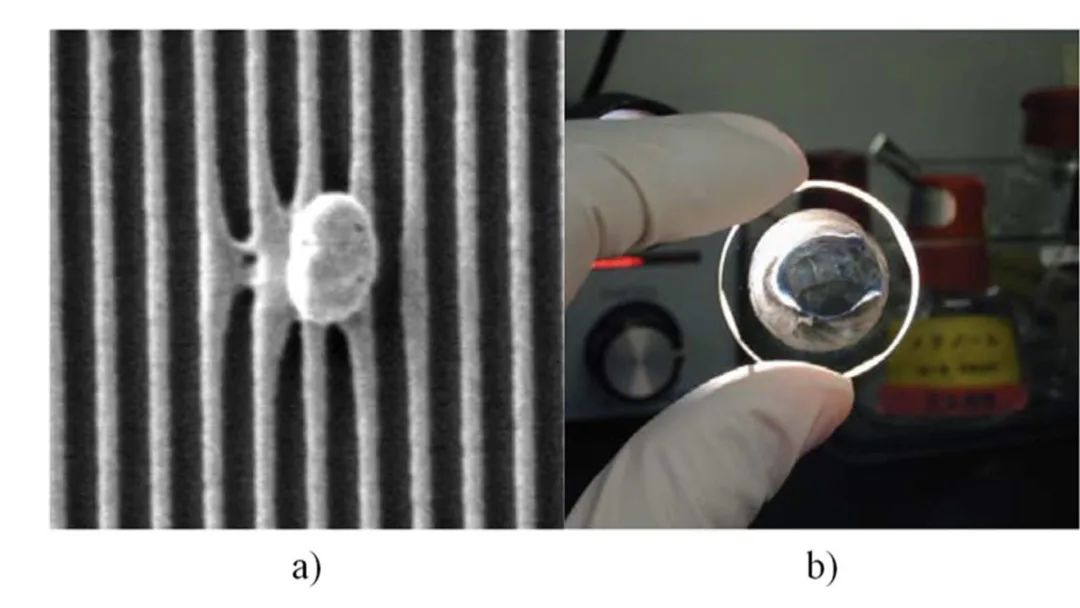
浸出問題を解決する効果的な方法は、レジストまたは上部バリア層の浸出速度を低くすることです。 レジスト膜を脱イオン水でリンスすることも、浸出問題の代替策として研究されている。 さらに、浸漬ヘッドの面積は露光フィールドの面積よりも大きいため、フラッシングプロセスと同様に、露光の前後にウェハが浸されることになります[38]。 露光および浸漬中、液体は浸漬ヘッド内を流れ続けるため、浸漬液体内の汚染物質が大幅に除去され、フラッシング プロセスを置き換えることができます。
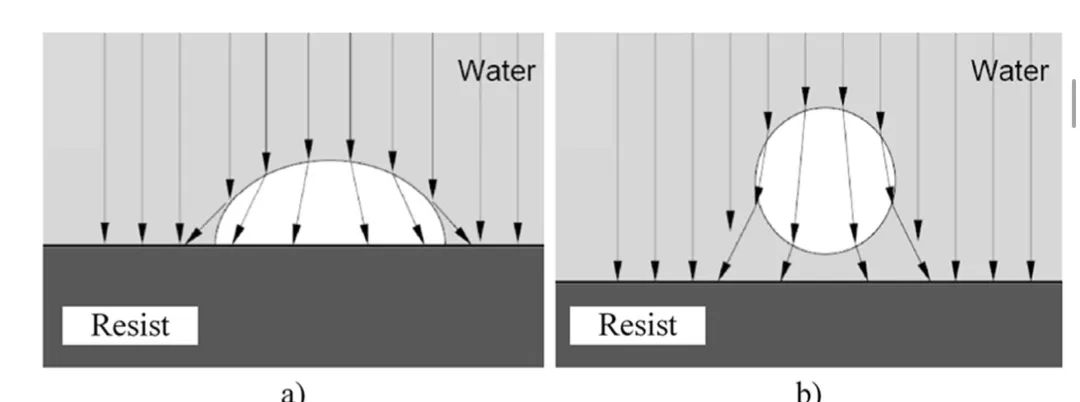
泡は入ってくる光を反射し、屈折させます。 a) フォトレジストの表面上、b) 浸漬溶液中に浮遊します。
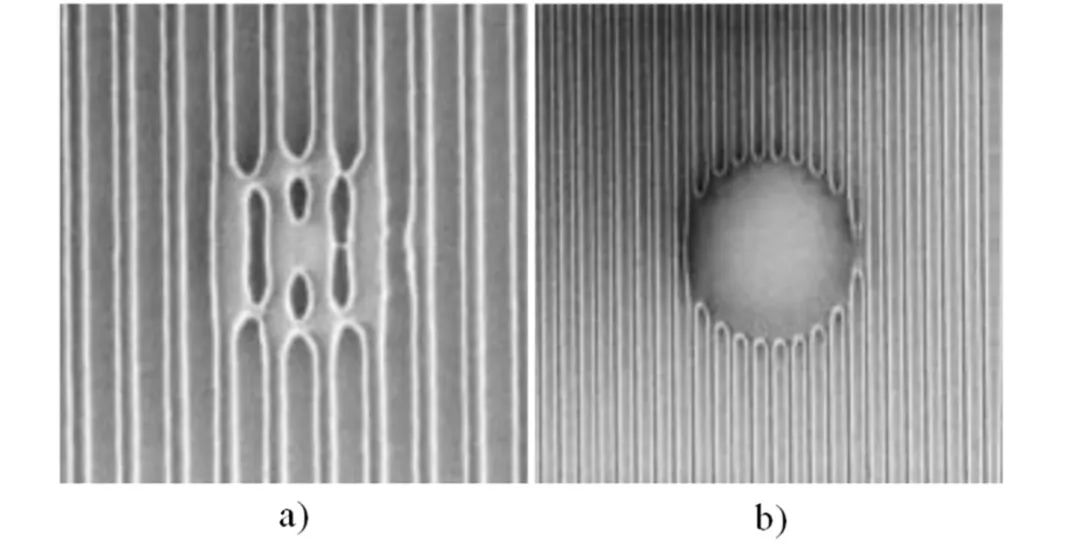
さまざまなサイズの気泡の欠陥。 a) 0.85μm、b) 3μm。
1.1.2.Bバブル
気泡浸漬リソグラフィーの主な課題の 1 つは、露光プロセス中に浸漬溶液中に気泡が発生しないという要件です。 気泡によって生じる湾曲した気液界面は入射光を反射および屈折させ、屈折率の不連続性を生み出し、散乱効果を増大させ、最終的にパターンの欠陥や歩留まりの低下をもたらします。
気泡の効果に影響を与える主な要因は、露光時間、気泡のサイズ、ウェーハ上の気泡の高さです。露光時間が短いほど気泡の効果が高まり、露光時間が長くなるにつれてフィーチャがより濃い影の領域に留まるようになります。 。 第二に、気泡が露光に使用される光の波長と同じサイズである場合、光は散乱し、迷光が増加します。 気泡のサイズがマイクロメートル以上になると、気泡が部分的に遮蔽して光の方向を変えます。 最後に、この研究では、画像に対する気泡の全体的な影響は、ウェーハ表面からの気泡の距離に依存することも判明しました。フォトレジストから離れた気泡はすぐに洗い流されてしまうため、距離が離れるほど影響は弱まります。速く動く流体。 ウェーハからの気泡の距離と気泡の直径の比が 4:10 の場合、単一の浮遊気泡の影響は無視できます。 気泡がウェハに近づくと、ウェハ表面近くの流体の流れが遅くなるため、像面内の気泡の影が強くなり、ウェハ上の特定の位置での気泡の寿命が長くなります。 その結果、ウェーハ表面に付着した気泡は、欠陥のない画像にとって非常に大きな脅威となります。 液中リソグラフィーにおける気泡散乱効果の体系的な研究により、フォトレジスト表面に気泡が付着しても欠陥が生じない最大気泡サイズは60nmであると予測されています。 液中リソグラフィーにおける気泡は、圧力、温度、光化学反応、流体力学などのさまざまな要因の干渉によって発生する可能性があります。
1.1.3.暖房
露光中、浸漬された液体は不均一に加熱され、温度分布が画像にさまざまな影響を与える可能性があるほか、少量の球面収差や高次収差も発生し、主な結像欠陥は焦点ぼけです。 1 ナノメートルのデフォーカス量のみを許容する場合、屈折率の変化を非常に小さく保つ必要があります。 水の温度係数 (dn/dτ=-10-4K-1) は気体に比べて非常に大きいため、液体の温度は 10 mK 以内に保つ必要があり、液体の取り扱いと温度制御システムに厳しい制限が課せられます。
1.1.4.ストレス
液浸リソグラフィーでは、乾式リソグラフィーの空気に比べて液浸液の粘度が高く、密度が高いため、レンズとウェーハの両方の表面に大きなストレスが発生する可能性があります。 これらの法線応力とせん断応力はレンズの歪みや複屈折を引き起こし、均一な光路を乱す可能性があります。
1.2.制御方法
露出パフォーマンスに影響を与える上記の動作を軽減するには、3 つの方法があります。 露光工程での不純物や気泡を避けるため、
セクション内
1.2.1浸出とガス放出が少ないフォトレジストが使用されています。 気泡やパーティクルがウェーハに転写されるのを防ぐために、セクション
1.2.2具体的な配線方法と厚塗り方法について説明します。 最後に、汚染物質、粒子、気泡、熱を露光領域から遠ざけることで温度と応力分布のバランスをとります。
セクション
1.2.3液体供給・回収方式を採用しています。
ニコンは、量産用 ArF 液浸スキャナ NSR-S609B を開発した世界初の企業です [75]。 これに先立って、彼らはローカルフィル法に基づいたサブマージヘッド構造について多くの試みを行ってきました。 彼らは、液体供給および回収システムを使用した場合と使用しない場合の局所充填方法をシミュレーションし[54,67]、液体供給および回収システムが液体封じ込め構造としても機能することを発見した。 供給および回収システムがない場合、液体の一部はレンズ領域の外側に位置し、レンズ領域の下には空きスペースがいくつかあります。 供給および回収システムが存在すると、回収流によって液体ピット周囲の気液界面の表面張力が強化され、液体をレンズの下の局所領域にうまく閉じ込めることができ、液体の封じ込めが向上します。
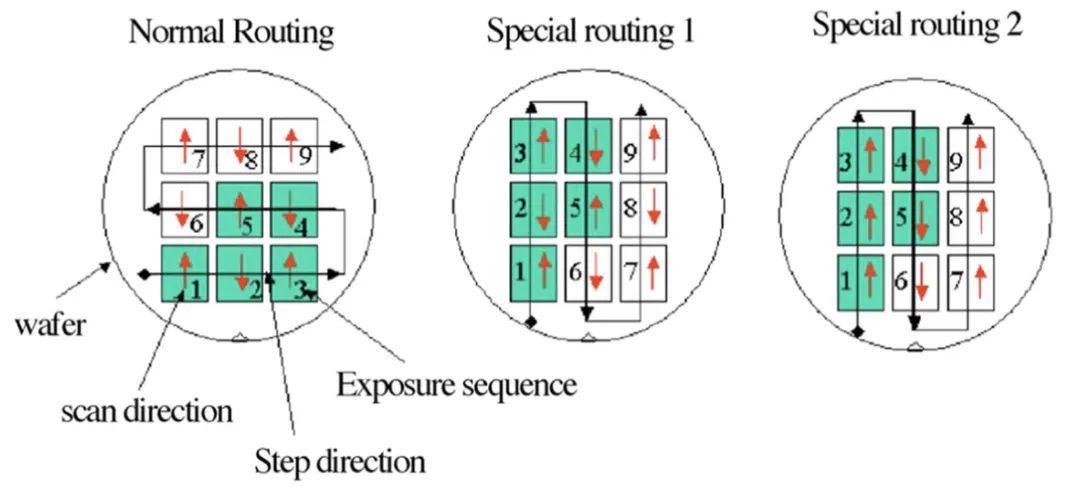
通常配線と2つの特殊配線で不良を軽減
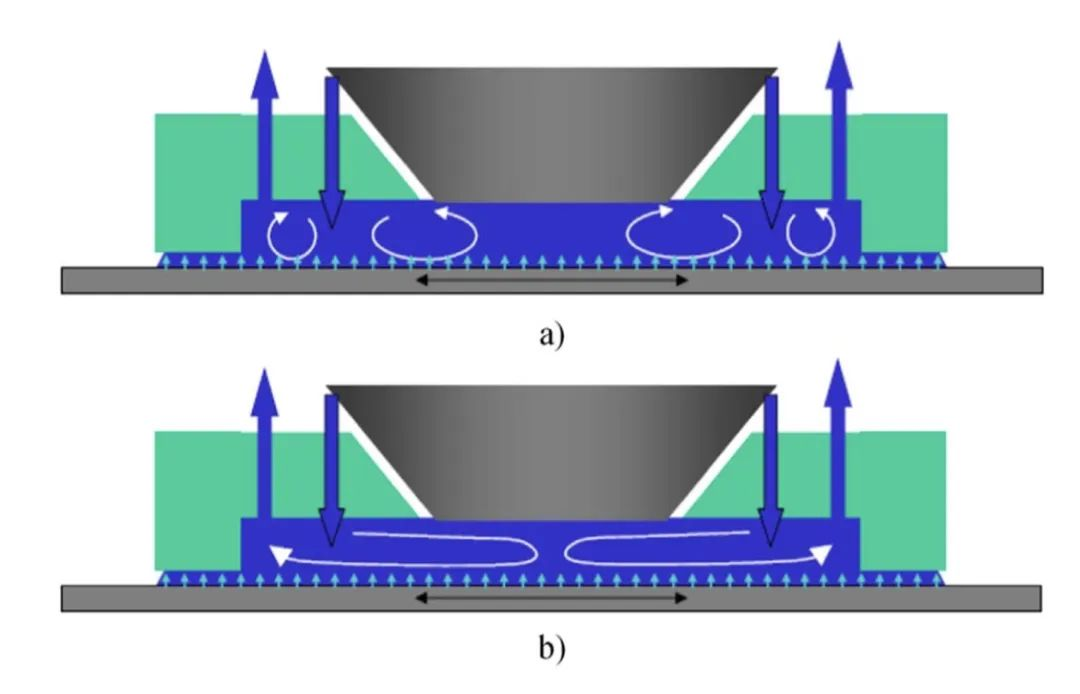
2 つの異なるノズル配置。 a) 古い世代のノズル。 b) 新しいノズル。
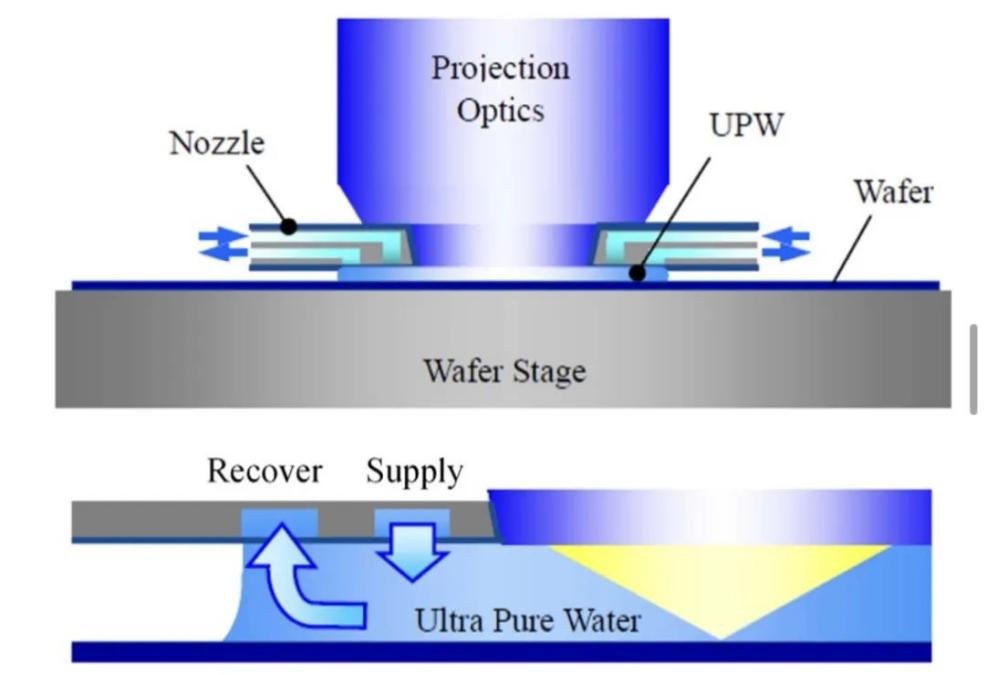
LLF液浸システムの基本構造。
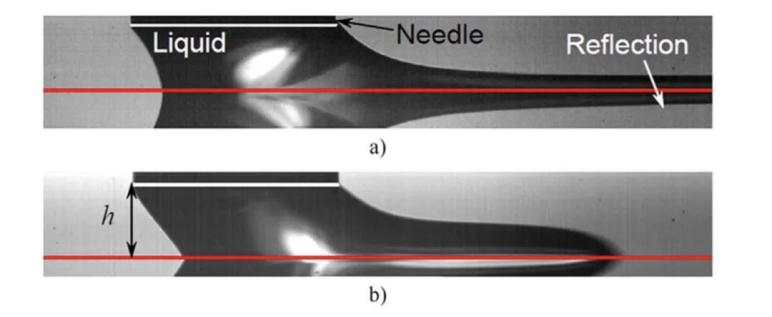
典型的なメニスカス形状。 a)。 フィルムの延伸、b)。 慣性オーバーフロー。
2. メニスカス安定性の流れ挙動制御
2.1.液浸リソグラフィーにおけるメニスカスの不安定性と残留液滴
プロセス全体を通じて、液体は最後の光学レンズとウェーハの間のギャップ内に留まる必要があります。 ウェハが液体の下を移動すると、粘性力が液体を走査方向に引っ張り始め、メニスカスに影響を与えます。 一定の速度を超えると、後退するメニスカスの安定性が崩れ、液体がその液体体積から引き抜かれ、その後液滴に分解されます。 これらの残留液滴はウェーハ上に残り、多数の画像欠陥を引き起こす可能性があります。 現在、半導体業界における量産時のスキャン速度は800mm/sですが、将来的にはさらに高速化されるでしょう。 したがって、この速度要件内で水中フィールドのメニスカスが安定性を失わないようにする必要があります。
2.2メニスカスの安定性に関する基礎研究
臨界速度とは、残留液体を堆積させることなく達成できる最大速度を指し、液浸リソグラフィーでは非常に重要な性能パラメータです。 41 種類の異なるフォトレジストに対する「ドラッグ ドロップ」実験 [80、87、88] による結果は、膜描画状態と慣性オーバーフロー状態の両方で、静的後退接触角の増加に伴って臨界速度が大幅に増加することを示しています。 。
2.3.制御方法
ウェハ上の残留液滴を減らすには 3 つの方法があります。 メニスカスの安定性を向上させ、露光中の残留液滴の形成を回避するために、液浸リソグラフィーではより疎水性の高いフォトレジストを使用できます。 メニスカスから出たばかりの残留液滴を除去するために、エア カーテンと多孔質媒体が使用されます。 回収チャネル付近の液体の流量を制御し、回収機能を促進するために、濡れ性のコントラストを備えた不均一な表面に基づく表面改質を浸漬ヘッドに適用することができます。
2.3.1.修飾されたドーム表面の疎水性により、ウェーハのスキャンと露光の速度が制御されます。 疎水性が高いということは、静的後退接触角がより高いことを意味し、これにより、浸された液体が残留液滴を残さずにウェハ上を移動することがより容易かつより速くなります。 したがって、より高い疎水性がスループットを最大化する鍵となり、より低い欠陥率と組み合わせることで歩留まりも向上させることができます。
2.3.2.第二の液体の封じ込め方法
メニスカスの安定性を制御するもう 1 つの方法は、浸漬ヘッドの特別な設計です。 異なるレジストおよび仕上げと浸漬液体の間の異なる接触角を考慮すると、浸漬ヘッド構造は高い走査速度で広い動作範囲を達成できなければなりません。 ASML は、新しい浸漬ヘッドを使用すると、スキャン速度が 600 mm/s の場合に総欠陥が大幅に減少する (3 倍以上) と報告しています。
水中ヘッドの最適化で最も一般的なのはエアカーテン構造です。 この設計により、浸水領域の周囲に高圧のエア カーテンが形成され、最後の光学素子の下のギャップに液体が保持されます。
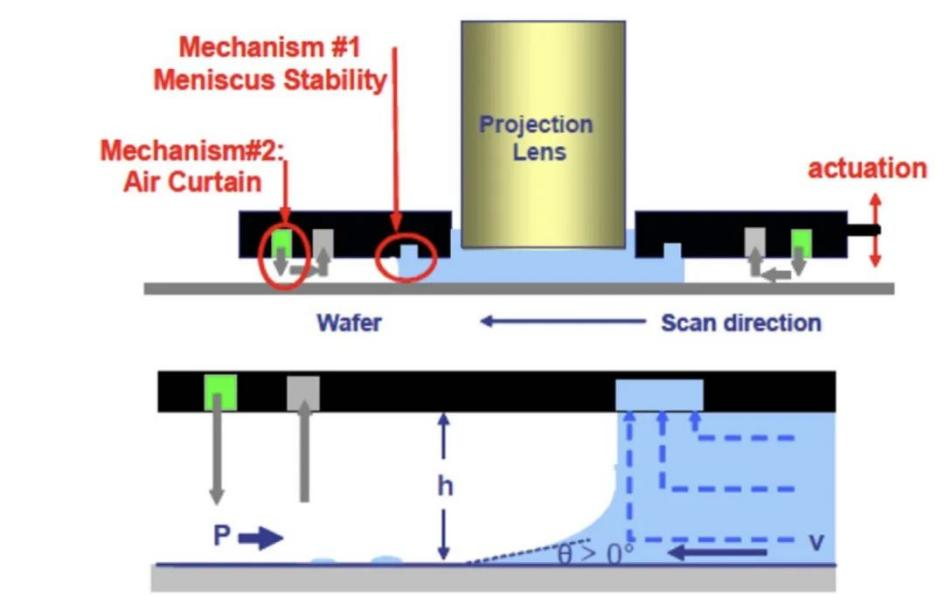
2.3.3.浸漬ヘッドの表面改質
メニスカス安定性制御のための上記の表面修正はすべてウェーハに適用され、均質な表面に基づいていますが、ギャップ内の液体を収容するために濡れ性コントラストのある不均質な表面を使用することもできます。 実際のリソグラフィープロセスではレジスト表面の不均一な改質ができない可能性があることを考慮すると、この方法は液中ヘッドにも適用できます。
Fountyl Technologies PTE Ltdは半導体製造業界に焦点を当てており、主な製品にはピンチャック、多孔質セラミックチャック、セラミックエンドエフェクタ、セラミック角形ビーム、セラミックスピンドルが含まれます。お問い合わせと交渉を歓迎します!











