半導体プロセス・装置:エッチングプロセス・装置
ウェハ上に回路図がリソグラフィーされた後、エッチングプロセスを使用して余分な酸化膜が除去され、半導体回路図が残ります。 エッチング。通常は化学溶液、ガス (または/および) プラズマを使用して、選択された余分な材料を除去します。tエッチングの利点は、サンプル作成コストが低く、一般的に使用される工業用金属材料のほとんどすべてをエッチングできることです。 金属の硬さには制限がありません。 設計が速く、シンプルで効率的です。
エッチングには、使用する物質によって大きく2つの方法があります。特定の薬液を用いて化学反応を進めて酸化膜を除去するウェットエッチングと、ガス(または/または)プラズマを使用するドライエッチング技術です。反応性イオンエッチング(RIE)、スパッタリングエッチング、気相エッチングに分けられます。 以下に、各エッチング方法のプロセスと装置について詳しく説明します。
I、ウェットエッチング工程
薬液を使用して酸化膜をウェットエッチングで除去するため、低コスト、エッチング速度が速く、生産性が高いという利点があります。 ただし、ウェット エッチングは、その速度がすべての方向で同じであるという点で等方性です。 その結果、マスク (または感応膜) がエッチングされた酸化膜と完全に位置合わせされなくなり、非常に微細な回路図を扱うことが困難になります。
ウェットエッチングの利点は、低コストで大量生産できることです。 同時に多数のウェーハをエッチングできます。 したがって、ウェット エッチングは、大型 MES デバイスや重要でない層の洗浄において依然として重要な役割を果たしています。 特にドライエッチングに比べて効果的かつ経済的です。特に酸化物除去残留物のエッチングやスキン剥離に最適です。
・ウェットエッチングの主な対象物は酸化シリコン、窒化シリコン、単結晶シリコン、多結晶シリコンです。 フッ化水素酸 (HF) は通常、酸化シリコンのウェット エッチングの主な化学キャリアとして使用されます。 選択性を向上させるために、フッ化アンモニウムで緩衝された希フッ化水素酸がプロセスで使用されます。 pHを安定に保つために、少量の強酸または他の元素を添加することができます。 ドープされた酸化シリコンは、純粋な酸化シリコンよりも腐食しやすくなります。 湿式化学剥離は主にフォトレジストとハードマスク (窒化シリコン) を除去するために使用されます。 熱安定性アルカリホスファターゼ (H3PO4) は、窒化ケイ素を除去するための湿式化学ストリッピングに使用される主な薬液であり、酸化ケイ素に対して優れた選択比を持っています。
II、ウェットエッチング装置
湿式プロセス装置は 3 つのカテゴリに分類できます。
1、ウェーハ洗浄装置、洗浄対象物には粒子、有機物、自然酸化層、汚染物質の金属不純物が含まれます。
2、ウェーハブラッシング装置、その主な目的はウェーハ表面の粒子を除去することです。
3、主に薄膜を除去するために使用されるウェーハエッチング装置。 プロセスのさまざまな用途に応じて、枚葉式エッチング装置は 2 つのタイプに分類できます。
A) ライトエッチング装置。主に高エネルギーイオン注入による表面膜のダメージを除去するために使用されます。
B) 犠牲層除去装置。主にウェーハの薄化または化学機械研磨後のバリア層の除去に使用されます。
機械の全体構造から見ると、あらゆる種類のウエハ湿式処理装置の基本アーキテクチャは類似しており、一般的にメインフレーム、ウエハ伝送システム、キャビティモジュール、薬液供給伝送モジュール、ソフトウェアシステム、電気制御モジュールの6つの部分で構成されています。 。

Ⅲ、ドライエッチング
ドライエッチングは指向性、ガス比、RF電源供給の良さからより精密な制御も可能で、主流のチッププロセスではチップエッチングの90%以上がドライエッチングです。
ドライエッチングは、化学エッチング、物理スパッタリング、イオンエッチングの3種類に分けられます。
1、化学エッチング: 化学エッチングは、化学反応を使用して材料の表面を除去するプロセスです。 エッチングガス(主にフッ化水素)を使用します。 この方法もウェットエッチングと同様に等方性であるため、微細なエッチングには不向きです。
2、P物理的スパッタリングチクチクする
物理エッチングは、グロー放電を利用して Ar ガスなどのガスを正電荷のイオンにイオン化し、バイアスをかけてイオンを加速し、エッチング対象物の表面に飛び散り、エッチングされた原子が衝突してスパッタリングされます。このプロセスは完全に物理的なエネルギーの伝達です。
物理スパッタリングは指向性が非常に良く、垂直に近いエッチングプロファイルが得られます。 しかし、イオンがチップ上に十分かつ均一にスパッタされるため、フォトレジストとエッチング材料が同時にエッチングされ、エッチング選択比が悪くなります。 同時に、叩き出される物質の多くは不揮発性物質であり、エッチング膜の表面や側壁に堆積しやすい。 したがって、超LSIの製造プロセスにおいては、完全に物理的なドライエッチング法が使用されることはほとんどない。
3、りえ:反応性イオンエッチング
RIE は最初の 2 つの方法を組み合わせたものです。つまり、プラズマをイオン化物理エッチングに使用し、プラズマ活性化後に生成されるフリーラジカルを化学エッチングに使用します。 RIE は、前 2 つの方法に比べてエッチング速度が速いことに加え、イオン異方性の特性を利用して高精度なパターンエッチングを実現します。
4、ドライエッチング装置
エッチングは、エッチング対象の材質に応じてシリコンエッチング、メディアエッチング、メタルエッチングに大別されます。
異なるエッチング材料に使用されるエッチング装置の間には大きなギャップがあります。 ドライエッチングエッチャーのプラズマ発生方式にはCCP(容量結合)とICP(誘導結合)があります。 さまざまな方法の異なる技術的特性により、下流のアプリケーション分野でも区別されます。 CCP 技術は高エネルギーですが、調整性が低く、硬質誘電体材料 (金属を含む) のエッチングに適しています。 ICPは低エネルギーながら制御性が高く、単結晶シリコン、硬度の低いポリシリコン、薄い材料のエッチングに適しています。
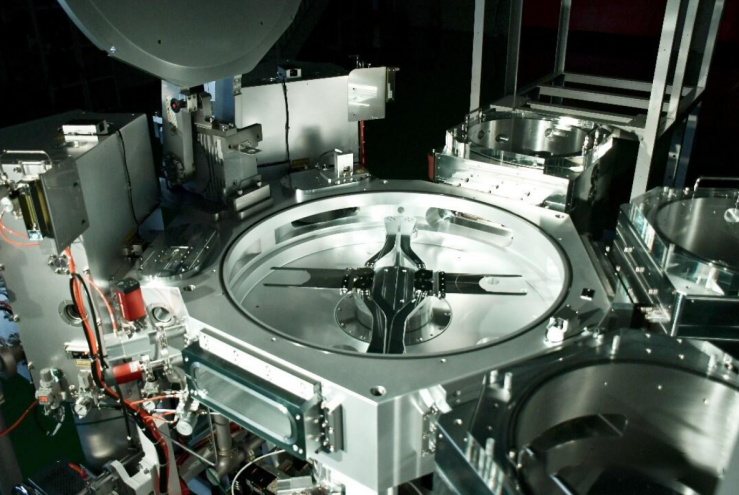
世界のエッチングマシン設備への参入企業は比較的少なく、業界全体としては寡占状態にあります。 主要なプレーヤーとしては、Lam Research (Pan-Forest Semiconductor)、米国の AMAT (Applied Materials)、日本の TEL (東京エレクトロニクス) などが挙げられます。 これら 3 社は半導体エッチング装置の世界市場シェアの 94% を占めていますが、他の企業を合わせてもわずか 6% にすぎません。 その中で、Lam Research は 55% もの高いシェアを占め、業界の絶対的なリーダーです。 東京エレクトロニクスが20%、アプライドマテリアルズが19%を占めた。
国内エッチングマシン市場という観点から見ると、Lam Research は依然として安定したトップの地位を占めています。 また、いくつかの国産エッチングマシンが成長し、上昇していることもわかります。 Fountyl Technologies PTE Ltdは半導体製造業界に焦点を当てており、主な製品にはピンチャック、多孔質セラミックチャック、セラミックエンドエフェクタ、セラミック角形ビーム、セラミックスピンドルが含まれます。お問い合わせと交渉を歓迎します!











