칩 본딩(Chip Bonding) : 기판 위에 칩을 올려놓는 과정
패키징 공정은 반도체 제조의 마지막 단계로 연삭, 절단, 실장, 배선, 성형의 순서로 이루어진다. 이러한 공정의 순서는 패키징 기술의 변화에 따라 변경될 수 있으며, 서로 밀접하게 연관되거나 결합될 수도 있습니다. 이 기사에서는 절단 공정 후 웨이퍼에서 분리된 칩을 캡슐화 기판(리드 프레임 또는 PCB)에 결합하는 데 사용되는 캡슐화 기술인 웨이퍼 본딩에 중점을 둡니다.

1.결속이란 무엇입니까?
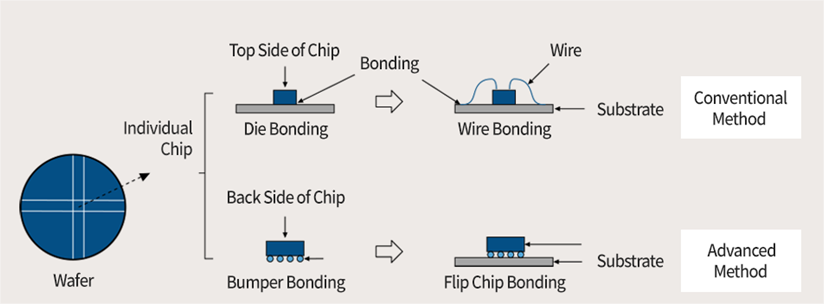
반도체 공정에서 '본딩'은 웨이퍼 칩을 기판에 연결하는 것을 의미한다. 본딩은 전통적인 방식과 고급 방식의 두 가지 유형으로 나눌 수 있습니다. 전통적인 방법에는 칩 연결(또는 칩 연결)과 와이어 연결이 포함되는 반면, 고급 방법에는 1960년대 후반 IBM이 개발한 플립 칩 연결이 포함됩니다. 플립칩 본딩은 다이본딩과 와이어본딩을 결합한 방식으로, 칩 라이너에 볼록한 부분을 형성해 칩과 기판을 연결하는 방식이다.
2. 본딩과정
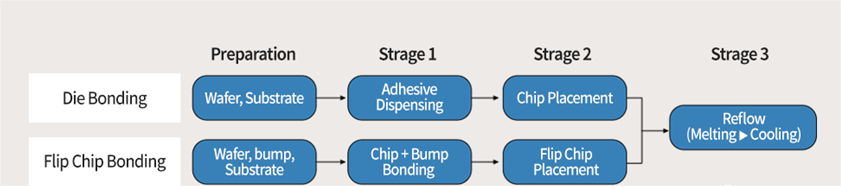
칩 본딩을 위해 가장 먼저 해야 할 일은 패키지 기판에 접착제를 코팅하는 것이다. 그런 다음 그 위에 칩을 올려 놓고 핀을 위로 향하게 하세요. 대신 좀 더 발전된 방식인 플립칩 본딩의 경우 솔더볼이라고 불리는 작은 돌기를 칩의 라이너에 부착한다. 그런 다음 칩은 핀 쪽이 아래로 향하도록 기판 위에 배치됩니다. 두 방법 모두 조립된 장치는 접착제나 솔더 볼을 녹이기 위해 시간이 지남에 따라 조정될 수 있는 온도 환류 채널을 통과합니다. 그런 다음 냉각되어 칩(또는 범프)을 기판에 부착합니다.
3. 칩 선택 및 배치
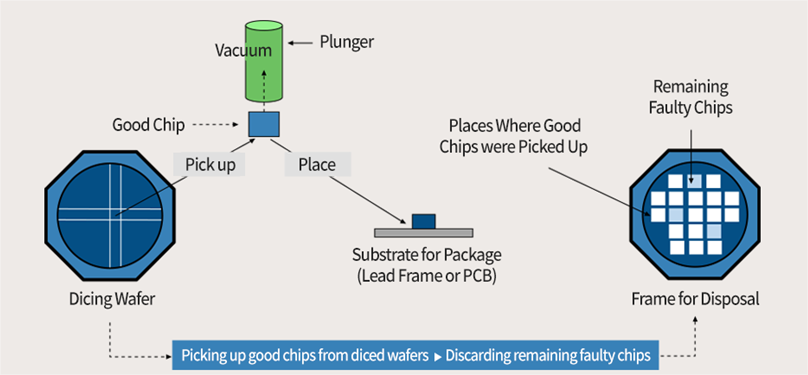
테이프에 붙어 있는 칩을 낱개로 떼어내는 것을 '픽'이라고 합니다. 플런저를 사용하여 웨이퍼에서 양호한 칩을 제거할 때 이를 패키지 기판 표면에 올려놓는 것을 "플레이스(Place)"라고 합니다. "Pick & Place"라고 불리는 이 두 가지 작업은 Die Bonde에서 수행됩니다.
4. 칩 배출
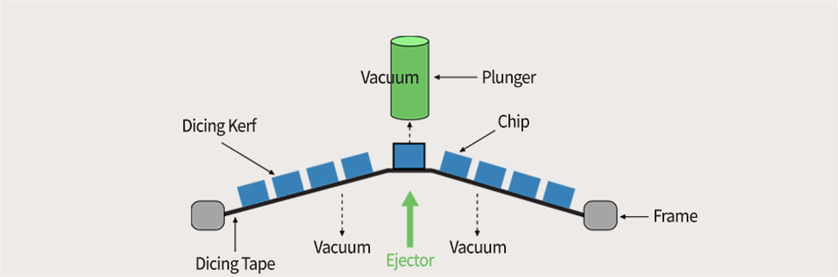
칩을 집기 쉬운 방법인 "배출"을 사용하십시오. 이젝터는 대상 칩에 물리적인 힘을 가하는 데 사용되며, 이로 인해 다른 칩과 단계 크기가 약간 다릅니다. 칩을 하단에서 배출한 후 진공 밴드 플런저를 사용하여 칩을 위에서 위로 잡아당깁니다. 동시에 테이프 바닥을 진공 청소기로 당겨 테이프 표면을 매끄럽게 만듭니다.
5. 칩은 에폭시 수지로 접착됩니다.
칩 본딩 시 금속(Power Tr)이 포함된 솔더나 페이스트를 이용해 연결하거나, 폴리머(폴리이미드)를 사용해 칩 본딩을 할 수도 있다. 고분자 재료에서는 은을 함유한 페이스트나 액상 에폭시 수지가 상대적으로 사용하기 쉽고 사용 빈도가 높습니다.
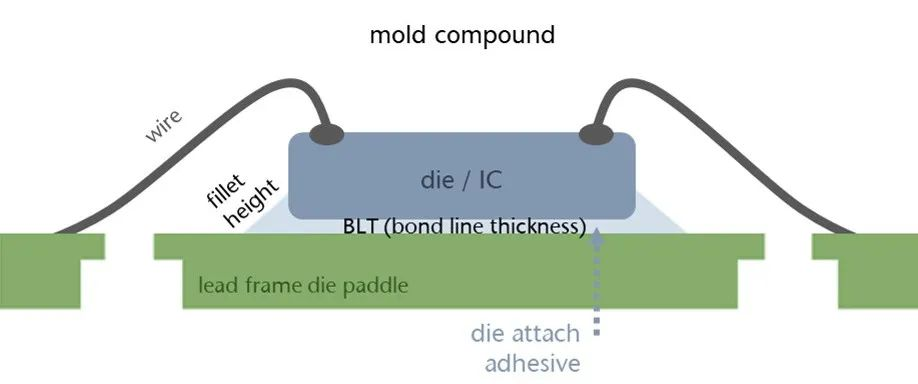
6. 칩 본딩에는 다이코팅(DAF)을 사용했습니다.
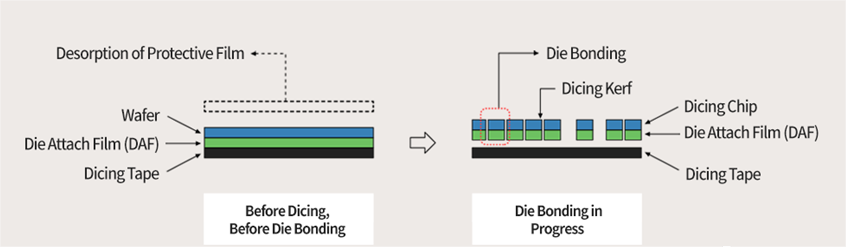
DAF는 칩 바닥에 부착된 얇은 필름이다. DAF의 두께는 매우 얇고 일정한 두께로 조절이 가능합니다. 칩과 기판의 본딩뿐만 아니라 멀티칩 패키지(MCP)를 만들기 위한 칩과 칩의 본딩에도 널리 사용됩니다. 칩의 구조상 칩 하단의 DAF가 칩에 접착되고, 슬라이싱 테이프가 그 아래의 DAF에 접착되어 접착력이 약합니다. 이 구조에서 칩 본딩을 수행하기 위해 칩과 DAF를 테이프에서 제거한 후 에폭시 수지를 사용하지 않고 칩을 기판에 직접 배치합니다.
Fountyl Technologies PTE Ltd는 반도체 제조 산업에 주력하고 있으며 주요 제품은 다음과 같습니다: 핀 척, 다공성 세라믹 척, 세라믹 엔드 이펙터, 세라믹 사각 빔, 세라믹 스핀들, 연락 및 협상 환영!











