Colagem de cavacos: O processo de colocação de um cavaco em um substrato
O processo de embalagem é a última etapa na fabricação de semicondutores e sua sequência é retificação, corte, montagem, fiação e conformação. A sequência desses processos pode mudar de acordo com as mudanças na tecnologia de embalagens e também podem estar intimamente relacionadas entre si ou combinadas. Este artigo se concentra na ligação de wafer, que é uma técnica de encapsulamento usada para envolver um chip separado de um wafer em um substrato de encapsulamento (estrutura de chumbo ou PCB) após um processo de corte.

1.O que é vínculo?
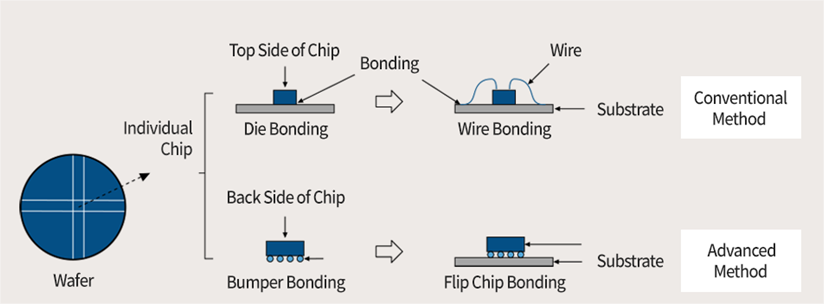
No processo semicondutor, “ligação” refere-se à conexão de um chip wafer a um substrato. A colagem pode ser dividida em dois tipos, nomeadamente o método tradicional e o método avançado. Os métodos tradicionais incluem conexões de chip (ou conexões de chip) e conexões de fio, enquanto os métodos avançados incluem conexões flip chip desenvolvidas pela IBM no final da década de 1960. A ligação flip chip é um método que combina a ligação da matriz e a ligação do fio e conecta o chip e o substrato formando um revestimento convexo no chip.
2. Processo de colagem
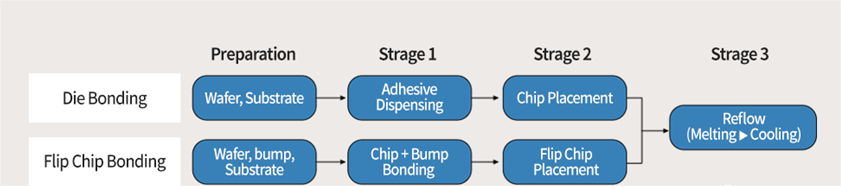
Para colagem de cavacos, a primeira coisa a fazer é revestir o adesivo no substrato da embalagem. Em seguida, coloque um chip nele, com o alfinete voltado para cima. Em vez disso, no caso da ligação flip chip, que é um método mais avançado, pequenas saliências chamadas bolas de solda são fixadas no revestimento do chip. Em seguida, o chip é colocado no substrato com o pino voltado para baixo. Em ambos os métodos, a unidade montada passa por um canal de refluxo de temperatura que pode ser ajustado ao longo do tempo para derreter o adesivo ou a bola de solda. Em seguida, é resfriado para fixar o chip (ou colisão) ao substrato.
3. Escolha e colocação de fichas
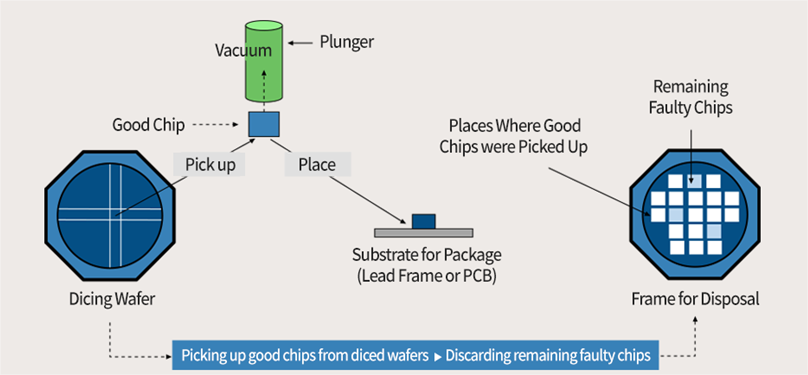
A remoção individual do chip preso à fita é chamada de “Pick”. Quando os cavacos bons são removidos do wafer com o êmbolo, colocá-los na superfície do substrato da embalagem é denominado "Local". Essas duas tarefas, chamadas "Pick & Place", são realizadas em um Die Bonde.
4. Ejeção de chips
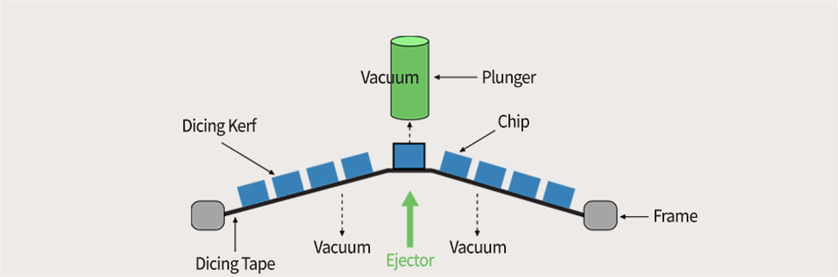
Use um método que seja fácil de pegar o chip: “ejeção”. Um ejetor é usado para aplicar forças físicas ao chip alvo, fazendo com que ele difira ligeiramente em tamanho de passo de outros chips. Depois de ejetar o chip pela parte inferior, puxe-o por cima com um êmbolo de banda de vácuo. Ao mesmo tempo, puxe a parte inferior da fita com vácuo para deixar a superfície da fita lisa.
5. Os chips são colados com resina epóxi
Na colagem do chip, a conexão é feita com solda ou pasta contendo metal (Power Tr), ou polímero (poliimida) também pode ser utilizado para colagem do chip. Em materiais poliméricos, resinas epóxi pastosas ou líquidas contendo prata são relativamente fáceis de usar e têm alta frequência de uso.
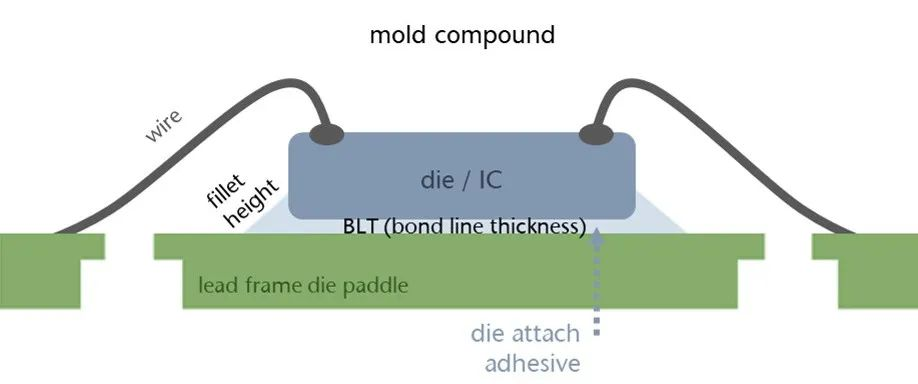
6. O revestimento de matriz (DAF) foi usado para colagem de cavacos
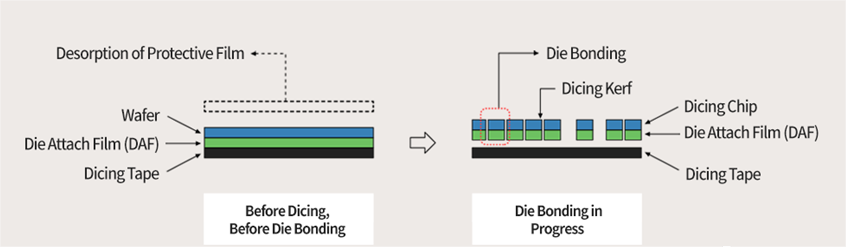
DAF é uma película fina fixada na parte inferior do chip. A espessura do DAF pode ser ajustada para uma espessura muito fina e constante. É amplamente utilizado não apenas na ligação chip-substrato, mas também na ligação chip-a-chip para criar pacotes multi-chip (MCP). Pela estrutura do chip, o DAF na parte inferior do chip é colado ao chip e a fita de corte é colada ao DAF abaixo dele, e a adesão é fraca. Para realizar a colagem de cavacos nesta estrutura, após a retirada do cavaco e do DAF da fita, o cavaco é colocado diretamente no substrato sem o uso de resina epóxi
Fountyl Technologies PTE Ltd, está se concentrando na indústria de fabricação de semicondutores, os principais produtos incluem: mandril de pino, mandril de cerâmica porosa, efetor final de cerâmica, viga quadrada de cerâmica, fuso de cerâmica, bem-vindo ao contato e negociação!











