Приклеивание чипа: процесс размещения чипа на подложке.
Процесс упаковки является последним этапом производства полупроводников, и его последовательность включает шлифовку, резку, монтаж, монтаж проводов и формование. Последовательность этих процессов может меняться в зависимости от изменений в технологии упаковки, а также может быть тесно связана друг с другом или сочетаться. В этой статье основное внимание уделяется соединению пластин — методу инкапсуляции, используемому для прикрепления чипа, отделенного от пластины, к герметизирующей подложке (выводной рамке или печатной плате) после процесса резки.

1.Что такое связь?
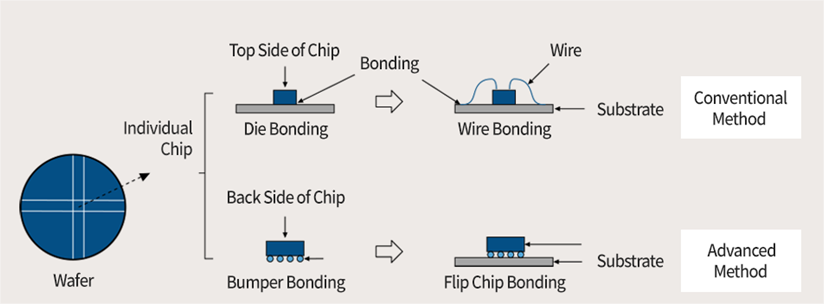
В полупроводниковом процессе «связывание» означает соединение пластины с подложкой. Склеивание можно разделить на два типа: традиционный метод и усовершенствованный метод. Традиционные методы включают соединения микросхем (или соединения микросхем) и проводные соединения, а продвинутые методы включают соединения с перевернутыми микросхемами, разработанные IBM в конце 1960-х годов. Соединение с перевернутым чипом — это метод, который сочетает в себе соединение кристалла и соединение проводов и соединяет чип и подложку путем формирования выпуклости на вкладыше чипа.
2. Процесс склеивания
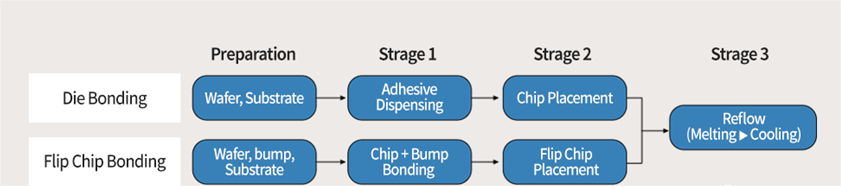
При склеивании чипов первое, что нужно сделать, — это нанести клей на подложку упаковки. Затем поместите на него чип булавкой вверх. Вместо этого в случае склеивания перевернутого чипа, который является более продвинутым методом, к внутренней поверхности чипа прикрепляются небольшие выступы, называемые шариками припоя. Затем чип помещается на подложку контактной стороной вниз. В обоих методах собранный блок проходит через канал температурного орошения, температуру которого можно регулировать с течением времени, чтобы расплавить клей или шарик припоя. Затем его охлаждают, чтобы прикрепить чип (или выступ) к подложке.
3. Выбор и размещение фишек
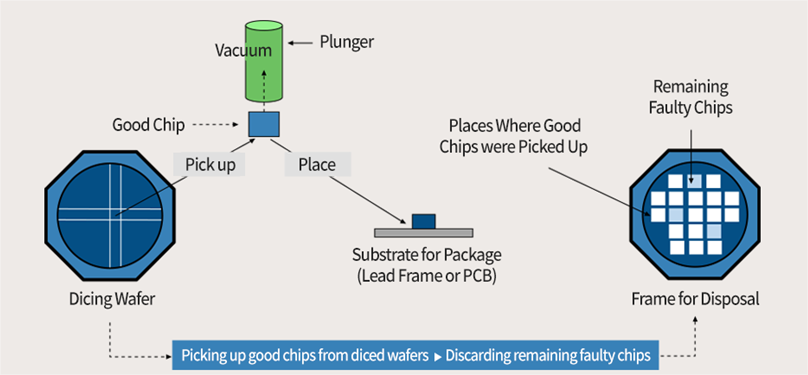
Удаление чипа, прикрепленного к ленте, по отдельности называется «Выбором». Когда исправные чипы удаляются с пластины с помощью плунжера, их размещение на поверхности подложки корпуса называется «Размещение». Эти две задачи, называемые «Выбор и размещение», выполняются на Die Bonde.
4. Выброс стружки
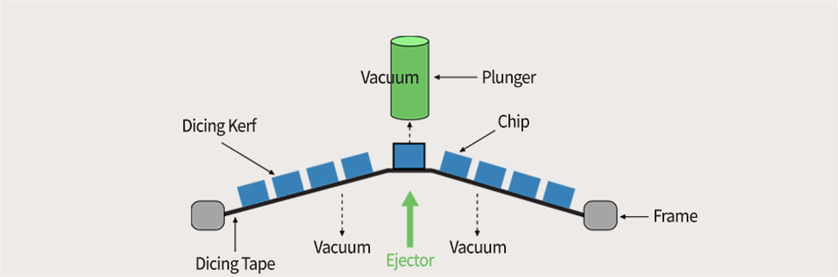
Используйте метод, которым легко подобрать фишку: «выброс». Выталкиватель используется для приложения физических сил к целевому чипу, в результате чего он немного отличается по размеру шага от других чипов. После извлечения стружки снизу потяните ее вверх с помощью плунжера вакуумной ленты. В то же время потяните нижнюю часть ленты вакуумом, чтобы поверхность ленты стала гладкой.
5. Чипы склеены эпоксидной смолой.
При склейке чипа соединение осуществляется с помощью припоя или пасты, содержащей металл (Power Tr), либо для склеивания чипа может быть использован полимер (полиимид). В полимерных материалах пасты или жидкие эпоксидные смолы, содержащие серебро, относительно просты в использовании и имеют высокую частоту использования.
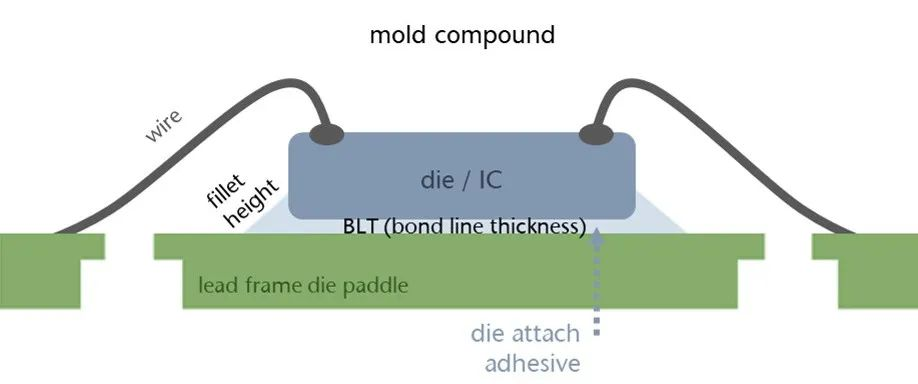
6. Для склеивания чипов использовалось покрытие DAF.
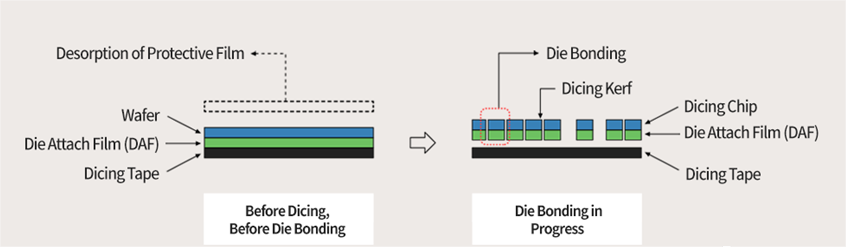
DAF — это тонкая пленка, прикрепленная к нижней части чипа. Толщину DAF можно регулировать до очень тонкой и постоянной толщины. Он широко используется не только при соединении чип-подложка, но и при соединении чип-чип для создания многочиповых корпусов (MCP). Судя по структуре чипа, DAF в нижней части чипа приклеен к чипу, а отрезная лента приклеена к DAF под ним, и адгезия слабая. Чтобы выполнить склеивание чипа в этой конструкции, после снятия чипа и DAF с ленты чип помещается непосредственно на подложку без использования эпоксидной смолы.
Fountyl Technologies PTE Ltd специализируется на производстве полупроводников, основная продукция включает в себя: штифтовый патрон, пористый керамический патрон, керамический концевой эффектор, керамическую квадратную балку, керамический шпиндель, добро пожаловать к контакту и переговорам!











