Control de flujo en litografía de inmersión.
Durante más de diez años, la litografía por inmersión ha sido la principal tecnología de exposición en la fabricación de semiconductores. En comparación con los métodos tradicionales de litografía seca, esta técnica mejora enormemente la resolución de exposición al inyectar un líquido de alto índice de refracción en el espacio entre la lente y la superficie de la oblea. Mantener la pureza y uniformidad del líquido sumergido y evitar la formación de gotas residuales en el proceso de escaneo de alta velocidad son dos desafíos importantes que enfrenta el desarrollo de la tecnología de litografía sumergida. Los contaminantes, las partículas, las burbujas, el calentamiento y la tensión en el líquido pueden alterar la continuidad del índice de refracción. El movimiento de alta velocidad de la oblea durante el escaneo puede desestabilizar el menisco en la interfaz entre el líquido y el gas circundante, lo que da como resultado gotas residuales en la oblea. Los fenómenos anteriores afectarán el rendimiento de exposición de la litografía de inmersión y se necesita el método de control del comportamiento del flujo correspondiente para resolver el problema.
1, Influencia del control del comportamiento del flujo en la pureza y uniformidad del líquido.
1.1.Influencia del comportamiento del flujo en la pureza y uniformidad del líquido.
1.1.1.Partículas y contaminantes
Las partículas y los contaminantes son las principales fuentes de impurezas sólidas en los líquidos sumergidos. Las partículas suspendidas en un líquido sumergido cerca de la superficie de la oblea o encima del fotorresistente pueden visualizarse en el fotorresistente subyacente o transferirse al fotorresistente durante el revelado.
Las partículas pueden estar presentes en el suministro de líquido o pueden provenir de cualquier superficie que toque el líquido. En primer lugar, el líquido utilizado para la inmersión inevitablemente contiene partículas e impurezas, por lo que se utiliza agua desionizada de sala limpia como solución de inmersión y se trata y filtra adicionalmente antes de inyectarla en el cabezal de inmersión. Otro problema de partículas es el despegue de la película alrededor del bisel de la oblea, que se debe a una adhesión insuficiente entre la superficie del bisel y el revestimiento de la superficie. Durante la exposición, estas partículas pueden transportarse hacia adelante y hacia atrás a través del menisco líquido desde el borde de la oblea hasta el centro de la oblea. Los métodos para resolver este problema incluyen la selección de fotoprotectores, la optimización de la formulación de EBR y el procesamiento de obleas. Las almohadillas tipo oblea también son una fuente potencial de partículas. A medida que la cabeza sumergida se mueve a través de la oblea, recoge partículas y las vuelve a depositar. La limpieza convencional de la mesa de obleas reducirá la cantidad de partículas y se ha demostrado que la tecnología de limpieza in situ es un método de limpieza de campo muy eficaz. Otros defectos causados por partículas de fotorresistente/revestimiento superior transparentes depositadas sobre la superficie de la película fotorresistente o de revestimiento superior (como defectos antiburbujas) se pueden reducir optimizando la formulación del recubrimiento.
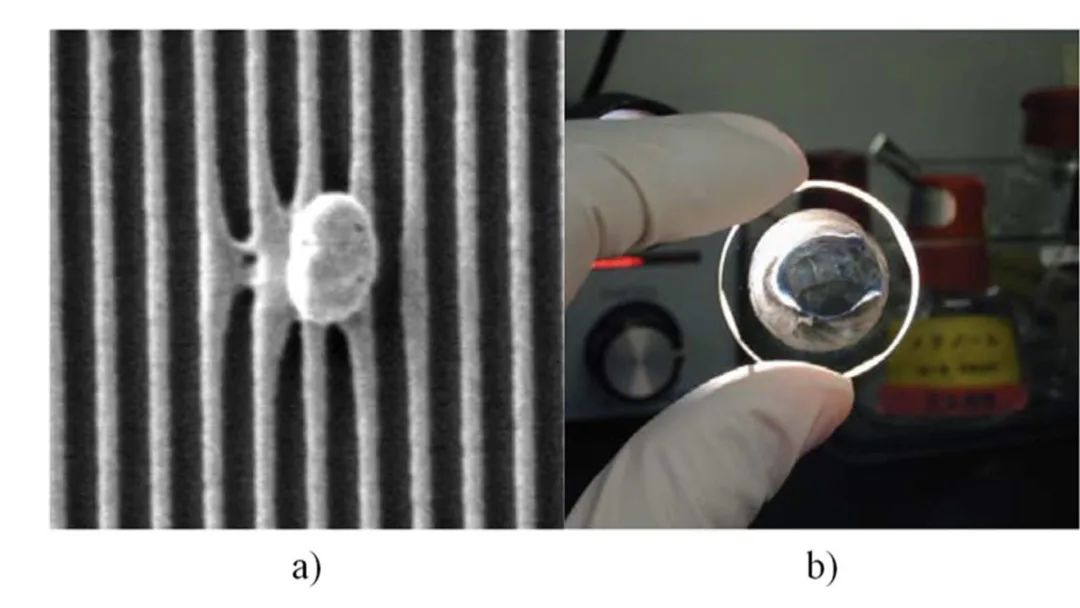
La forma eficaz de resolver el problema de la lixiviación es utilizar una tasa de lixiviación baja de la capa protectora o barrera superior. También se ha investigado el enjuague de las películas resistentes con agua desionizada como una alternativa al problema de la lixiviación. Además, el área de la cabeza sumergida es mayor que el área del campo de exposición, lo que significa que la oblea se empapa antes y después de la exposición, como en el proceso de lavado [38]. Dado que el líquido continúa fluyendo a través del cabezal sumergido durante la exposición y la inmersión, los contaminantes del líquido sumergido se eliminarán en gran medida y, por lo tanto, pueden reemplazar el proceso de lavado.
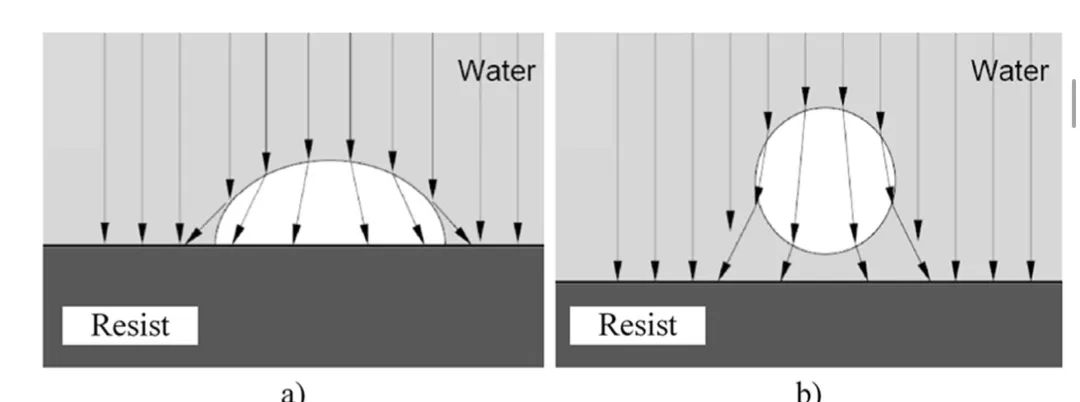
Las burbujas reflejan y refractan la luz entrante. a) en la superficie del fotoprotector, y b) flotando en la solución sumergida.
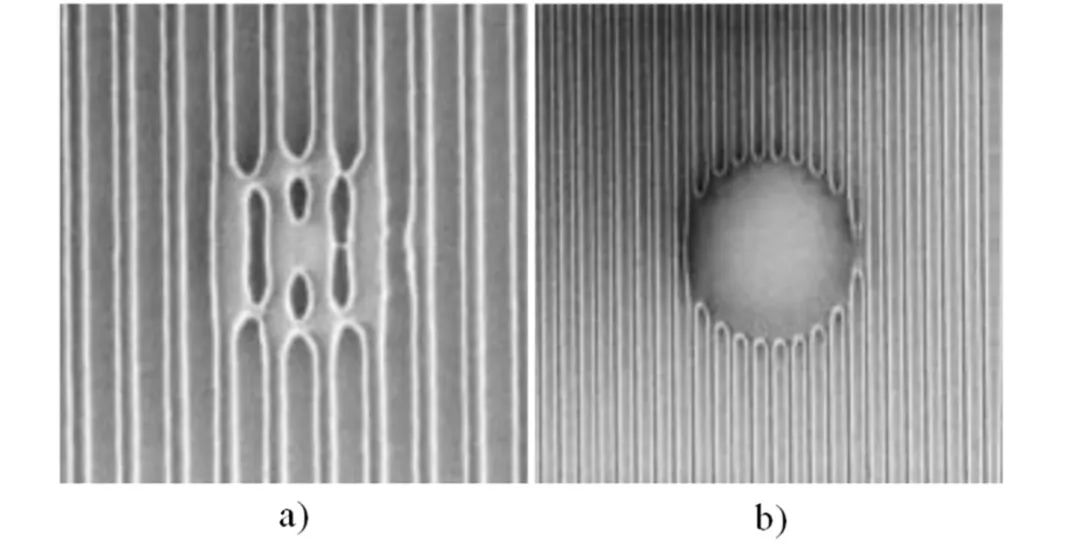
Defectos de burbujas de diferentes tamaños. a) 0,85 µm, b) 3 µm.
1.1.2.Bburbuja
Uno de los principales desafíos de la litografía por inmersión en burbujas es el requisito de que no aparezcan burbujas en la solución de inmersión durante el proceso de exposición. La interfaz curva gas-líquido causada por las burbujas refleja y refracta la luz incidente, lo que crea discontinuidades en el índice de refracción y aumenta los efectos de dispersión, lo que en última instancia produce defectos en el patrón y un rendimiento reducido.
Los principales factores que afectan el efecto de las burbujas son el tiempo de exposición, el tamaño de las burbujas y la altura de las burbujas sobre la oblea; tiempos de exposición más cortos mejoran el efecto de las burbujas, lo que hace que las características permanezcan en el área más sombreada durante más tiempo de exposición. . En segundo lugar, si la burbuja tiene el mismo tamaño que la longitud de onda de la luz utilizada para la exposición, la luz se dispersa y aumenta la luz dispersa. Si el tamaño de la burbuja es de micrómetros o mayor, la burbuja bloqueará parcialmente y cambiará la dirección de la luz. Finalmente, el estudio también encontró que el efecto general de las burbujas en la imagen depende de la distancia de las burbujas a la superficie de la oblea: cuanto mayor es la distancia, más débil es el efecto, ya que las burbujas alejadas del fotoprotector pueden eliminarse rápidamente en un fluido que se mueve rápidamente. Si la relación entre la distancia de la burbuja desde la oblea y el diámetro de la burbuja es 4:10, el efecto de una sola burbuja flotante es insignificante. A medida que la burbuja se acerca a la oblea, debido al flujo de fluido más lento cerca de la superficie de la oblea, la sombra de la burbuja en el plano de la imagen se vuelve más intensa y su vida útil en un lugar determinado de la oblea se vuelve más larga. Como resultado, las burbujas adheridas a la superficie de la oblea representan una amenaza mucho mayor para una imagen sin defectos. A través del estudio sistemático del efecto de dispersión de burbujas en litografía sumergida, se predice que 60 nm es el tamaño máximo de burbuja que no causará defectos cuando la burbuja se adhiere a la superficie del fotorresistente. Las burbujas en la litografía sumergida pueden ser causadas por la interferencia de diversos factores como la presión, la temperatura, la reacción fotoquímica y la dinámica de fluidos.
1.1.3.Calefacción
Durante la exposición, el líquido sumergido se calienta de manera desigual y la distribución de la temperatura puede afectar la imagen de varias maneras, al mismo tiempo que produce pequeñas cantidades de aberraciones esféricas y de orden superior, y el principal defecto de la imagen es el desenfoque. Si sólo permitimos una cantidad de desenfoque de 1 nanómetro, el cambio del índice de refracción debe mantenerse muy pequeño. Dado que el coeficiente de temperatura del agua (dn/dτ=-10-4K-1) es muy grande en comparación con el gas, la temperatura del líquido debe mantenerse dentro de los 10 mK, lo que impone límites estrictos a los sistemas de control de temperatura y manipulación de líquidos.
1.1.4.Estrés
Para la litografía por inmersión, la alta viscosidad y la alta densidad del líquido sumergido, en comparación con el aire en la litografía seca, pueden causar una tensión significativa tanto en la superficie de la lente como en la de la oblea. Estas tensiones normales y de corte pueden provocar distorsión y birrefringencia de la lente, alterando así el camino uniforme de la luz.
1.2.Métodos de control
Hay tres formas de reducir los comportamientos anteriores que afectan el rendimiento de la exposición. Para evitar impurezas y burbujas del proceso de exposición,
En la sección
1.2.1 Se utilizan fotoprotectores de baja lixiviación y baja liberación de gas. Para evitar que se queden burbujas y partículas en la oblea, la Sección
1.2.2 Describe el método de cableado específico y el método de recubrimiento grueso. Finalmente, para equilibrar la distribución de la temperatura y la tensión alejando los contaminantes, las partículas, las burbujas y el calor del área de exposición,
Sección
1.2.3utiliza métodos de suministro y recuperación de líquidos.
Nikon fue la primera empresa del mundo en desarrollar un escáner de inmersión ArF para producción, el NSR-S609B [75]. Antes de esto, habían hecho muchos intentos de estructuras de cabeza sumergidas basadas en el método de relleno local. Simularon el método de llenado local con y sin sistema de recuperación y suministro de líquido [54,67] y descubrieron que el sistema de recuperación y suministro de líquido también actuaba como una estructura de contención de líquido. En ausencia de un sistema de suministro y recuperación, parte del líquido se encuentra fuera del área de la lente, con algo de espacio vacío debajo del área de la lente. En presencia de un sistema de alimentación y recuperación, el flujo de recuperación fortalece la tensión superficial en la interfaz gas-líquido alrededor del pozo de líquido, confinando exitosamente el líquido a un área local debajo de la lente, mostrando una mejor contención del líquido.
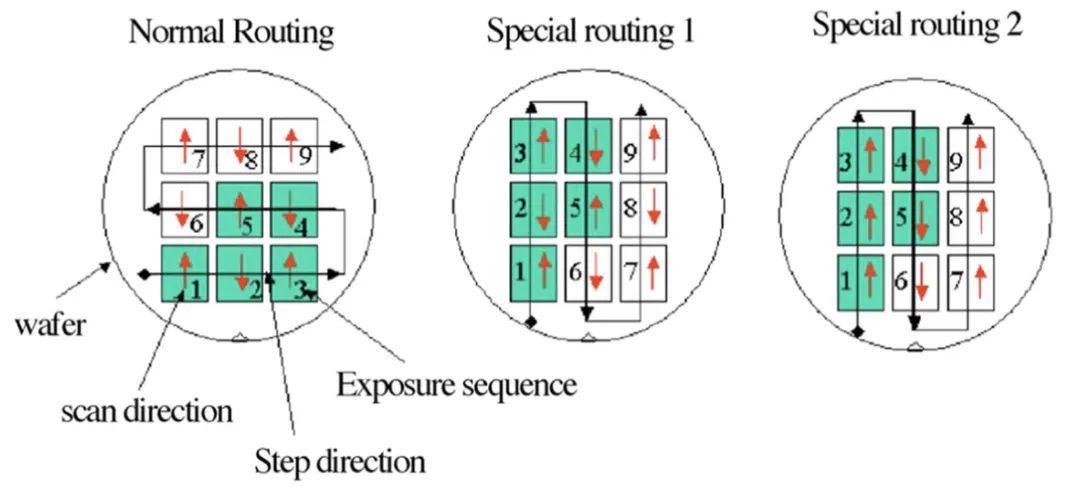
Cableado normal y 2 cableados especiales para reducir defectos.
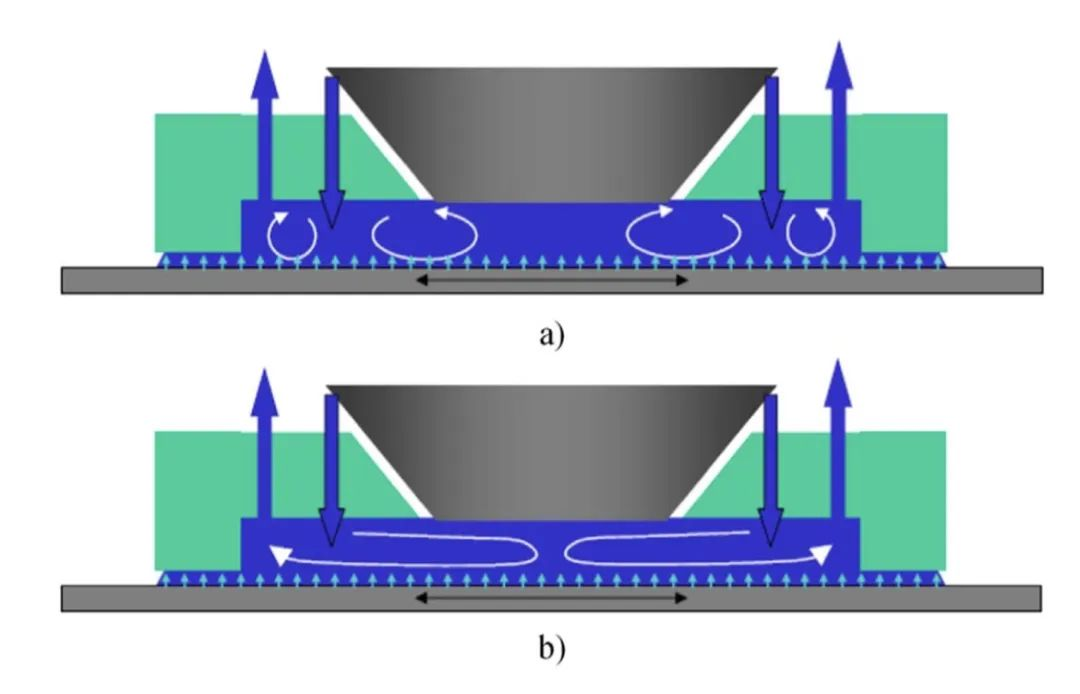
Dos disposiciones diferentes de boquillas. a) Boquilla de generación anterior; b) Boquillas nuevas.
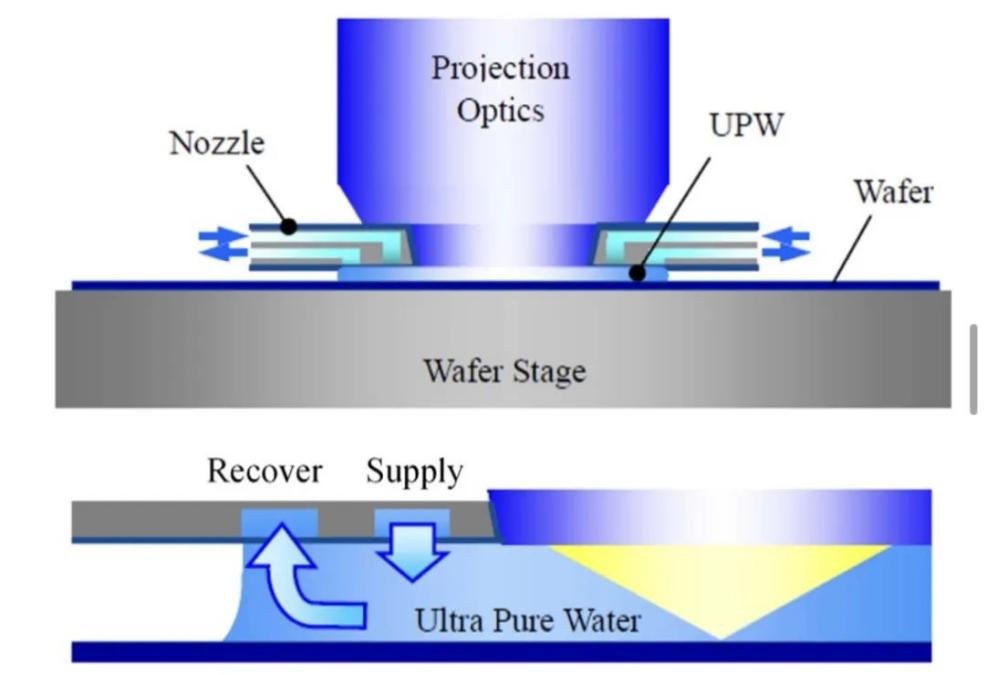
Estructura básica del sistema de inmersión LLF.
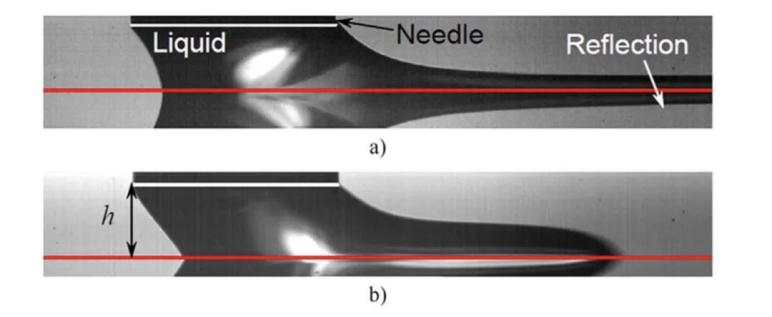
Una forma típica de menisco. a). Estiramiento de la película, b). Desbordamiento inercial.
2. Control del comportamiento del flujo de la estabilidad del menisco.
2.1.Inestabilidad de menisco y gotas residuales en litografía de inmersión.
Durante todo el proceso, el fluido debe permanecer dentro del espacio entre la última lente óptica y la oblea. A medida que la oblea se mueve debajo del líquido, fuerzas viscosas comienzan a tirar del líquido hacia la dirección de exploración y afectan el menisco. A partir de cierta velocidad se altera la estabilidad del menisco que retrocede y el líquido se extrae de su volumen y posteriormente se descompone en gotas. Estas gotas residuales pueden permanecer en la oblea y provocar numerosos defectos en la imagen. Actualmente, en la industria de los semiconductores, la velocidad de escaneo de la fabricación en masa es de 800 mm/s y será mayor en el futuro. Por lo tanto, es necesario asegurar que el menisco del campo sumergido no pierda estabilidad dentro de este requisito de velocidad.
2.2Investigación básica sobre la estabilidad del menisco.
La velocidad crítica se refiere a la velocidad máxima que se puede alcanzar sin depositar líquido residual y es un parámetro de rendimiento muy importante en la litografía de inmersión. A través de experimentos de "arrastre y caída" en 41 fotorresistentes diferentes [80,87,88], los resultados muestran que la velocidad crítica aumenta significativamente con el aumento del ángulo de contacto estático de recesión, tanto en el estado de dibujo de la película como en el estado de desbordamiento inercial. .
2.3.Métodos de control
Hay tres formas de reducir las gotas residuales en la oblea. Para mejorar la estabilidad del menisco y evitar la formación de gotas residuales durante la exposición, se puede utilizar más fotorresistente hidrófobo en la litografía de inmersión. Para eliminar las gotas residuales que acaban de salir del menisco se utiliza una cortina de aire y un medio poroso. Para controlar el caudal de líquido cerca del canal de recuperación y facilitar la función de recuperación, se puede aplicar al cabezal sumergido una modificación de la superficie basada en superficies heterogéneas con contraste de humectabilidad.
2.3.1. La hidrofobicidad de la superficie de la cúpula modificada controla la velocidad de escaneo y exposición de la oblea. Una mayor hidrofobicidad significa un mayor ángulo de contacto de retroceso estático, lo que hace que sea más fácil y rápido que el líquido sumergido se mueva a través de la oblea sin dejar gotas residuales. Por lo tanto, una mayor hidrofobicidad es clave para maximizar el rendimiento y, cuando se combina con tasas de defectos más bajas, también puede aumentar los rendimientos.
2.3.2.Segundo método de contención de líquidos.
Otra forma de controlar la estabilidad del menisco es el diseño especial de la cabeza sumergida. Teniendo en cuenta los diferentes ángulos de contacto entre diferentes resistencias y acabados y el líquido sumergido, la estructura del cabezal sumergido debe poder alcanzar un amplio rango operativo a altas velocidades de escaneo. ASML informa que el uso del nuevo cabezal sumergido reduce significativamente los defectos totales (más de 3 veces) cuando la velocidad de escaneo es de 600 mm/s.
La optimización más común para cabezales sumergidos es la estructura de la cortina de aire. Este diseño crea una cortina de aire de alta presión alrededor del área sumergida, manteniendo el fluido en el espacio debajo del último elemento óptico.
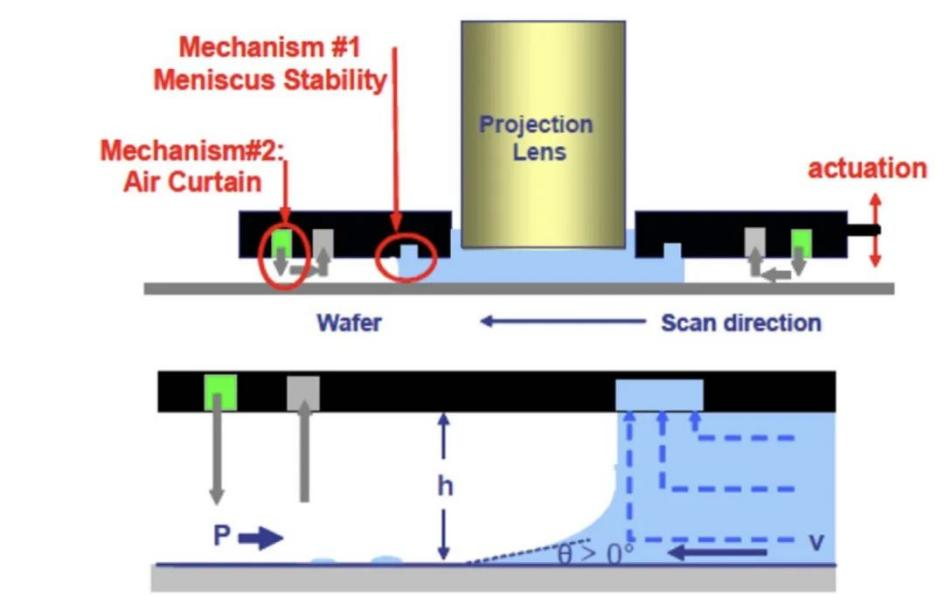
2.3.3.Modificación superficial de cabeza sumergida.
Todas las modificaciones de superficie anteriores para el control de la estabilidad del menisco se aplican en obleas y se basan en superficies homogéneas, pero también se pueden usar superficies heterogéneas con contraste de humectabilidad para acomodar el líquido en el espacio. Considerando que el proceso de litografía real puede no permitir la modificación heterogénea de la superficie resistente, este método se puede aplicar a la cabeza sumergida.
Fountyl Technologies PTE Ltd, se centra en la industria de fabricación de semiconductores, sus principales productos incluyen: mandril de pasador, mandril de cerámica porosa, efector final de cerámica, viga cuadrada de cerámica, husillo de cerámica, ¡bienvenido a contactar y negociar!











