روش های ویفر نویسی چیست؟
برش ویفر (برش) به فرآیند برش یک ویفر به چند تراشه مستقل (" قالب ") اشاره دارد. این فرآیند پس از تکمیل تمام فرآیندهای ساخت نیمه هادی بر روی ویفر برای بسته بندی و آزمایش بعدی انجام می شود. روش های زیادی برای برش وجود دارد و امروز به صورت سیستماتیک به معرفی آن می پردازیم.
چرا فرآیند نوشتن وجود دارد؟
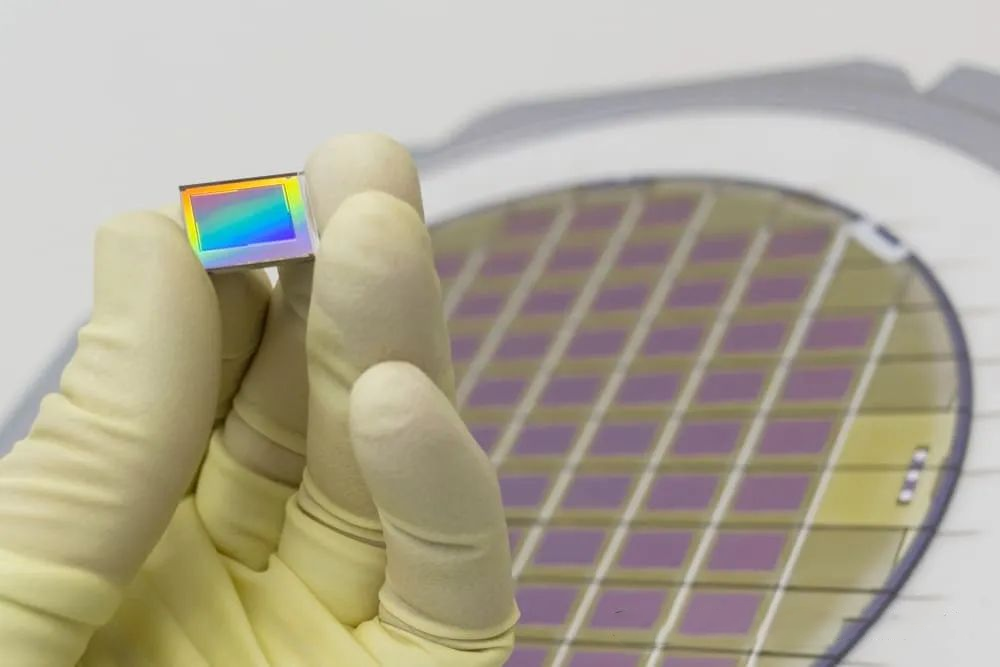
ویفر حاوی هزاران تراشه است، هر تراشه یک واحد مستقل است. هنگامی که ساخت تراشه به پایان رسید، تراشه در حالت نشتی است و خوردگی شیمیایی، گرد و غبار، رطوبت و غیره در محیط ترمینال باعث آسیب کشنده به تراشه می شود، بنابراین تراشه باید روی آن قرار گیرد. لباس» (پوسته) برای محافظت از تراشه، یعنی بسته بندی. فرآیند نوشتن اجازه می دهد تا هر تراشه به صورت جداگانه برای استفاده در یک محیط ترمینال بسته بندی شود.
روش غالب برای برش؟
به طور کلی خط نویسی مکانیکی، خط زدن لیزری وجود دارد. خط لیزر را می توان به برش پنهان لیزری و برش کل لیزری تقسیم کرد. مسیرهای برش متقاطع روی ویفر وجود خواهد داشت، و مسیرهای برش باید در مرزهای تراشه های جداگانه بریده شوند، که معمولاً در امتداد مسیرهای برش برش داده می شوند.
خط نویسی مکانیکی
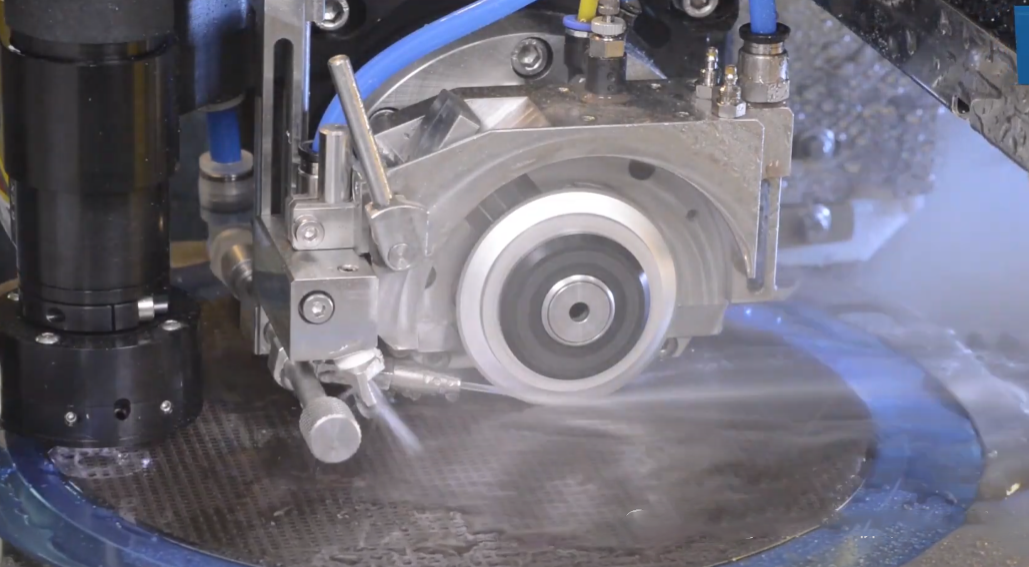
خطکشی مکانیکی استفاده از تیغههای الماسی برای برش فیزیکی ویفر است که سنتیترین و متداولترین روش در خطکشی ویفر است. تیغه الماس برای بریدن ویفر با سرعت بالا می چرخد و گرما و زباله های تولید شده توسط آب منتقل می شود.
مزایای:
1، تجهیزات ارزان است
2، مناسب برای مواد مختلف ویفر
معایب:
1، دقت خط نویسی بالا نیست
2، نرخ نوشتن کم است
3، مستعد شکستگی لبه و سایر ناهنجاری ها است
4، برای ویفرهای خیلی نازک مناسب نیست، به طور کلی بیش از 100 میلی متر ضخامت ویفر مناسب برای خط کشی مکانیکی است.
برش لیزری
برخی از ویفرها نسبتا شکننده و نازک هستند، بنابراین مشکل لبهها و ترک خوردن با تیغههای الماسی به راحتی رخ میدهد، بنابراین برش لیزری باید در نظر گرفته شود.
Laser Stealth Dicing یک فرآیند دو مرحله ای است:
اولین مرحله استفاده از پرتو لیزر برای فوکوس روی داخل ویفر است، دقیقاً عمق فوکوس لیزر را کنترل میکند و شکاف ظریفی را در داخل ویفر ایجاد میکند، در حالی که سطح آن دست نخورده باقی میماند.
مرحله دوم، کشش مکانیکی نوار چسبیده به پشت ویفر است. همانطور که نوار منبسط می شود، تراشه های جداگانه روی ویفر در امتداد مسیر پیش برش لیزری از هم جدا می شوند.
برش کامل لیزری
برش کامل لیزر به این اشاره دارد که پرتو لیزر به طور مستقیم بر روی سطح ویفر، در کل ضخامت ویفر تابش می شود، ویفر را به طور کامل برش می دهد و مستقیماً یک تراشه واحد را جدا می کند. برش کلی لیزری امکان کنترل دقیق قدرت، فوکوس و سرعت لیزر را برای انطباق با مواد مختلف و نیازهای ضخامت فراهم می کند. بر خلاف برش کریپتو با لیزر، برش کامل لیزری نیازی به مراحل گسترش نوار بعدی برای جدا کردن تراشه ندارد.
مزایای برش لیزر؟
1، سرعت نوشتن بسیار سریع است،
2، آسیب استرس کوچک است
3، دقت نوشتن بسیار بالا است
معایب:
1، قیمت گران است
2، زباله های تولید شده توسط لیزر سوزاندن به سختی تمیز می شود.
خط شکافی چیست؟
به منظور کاهش لبه مشکل خط زدن، می توانید ابتدا از شکاف لیزر استفاده کنید و سپس از تیغه الماس برای خط زدن استفاده کنید. همچنین می توان آن را با یک تیغه الماس ضخیم تر سوراخ کرد و سپس با یک تیغه الماس برش داد.
فرآیند DBG چیست؟
فرآیند DBG انحصاری شرکت دیسکو ژاپن (Dicing Before Grinding) به اولین قسمت جلویی ویفر تا عمق مشخص شده (از میان ویفر بریده نشده) و سپس پشت ویفر به عمق برش مربوطه اشاره دارد تا مشکل را کاهش دهد. ترک خوردگی ویفر
Fountyl Technologies PTE Ltd، بر صنعت تولید نیمه هادی تمرکز دارد، محصولات اصلی عبارتند از: پین چاک، چاک سرامیکی متخلخل، افکتور انتهایی سرامیکی، پرتو مربع سرامیکی، دوک سرامیکی، خوش آمدید به تماس و مذاکره!











