Liaison de puce : processus de placement d'une puce sur un substrat
Le processus d'emballage est la dernière étape de la fabrication des semi-conducteurs et sa séquence comprend le meulage, la découpe, le montage, le câblage et le formage. La séquence de ces processus peut changer en fonction de l'évolution de la technologie d'emballage et peut également être étroitement liée les unes aux autres ou combinée. Cet article se concentre sur le collage de tranches, qui est une technique d'encapsulation utilisée pour engager une puce séparée d'une tranche sur un substrat d'encapsulation (cadre de connexion ou PCB) après un processus de découpe.

1.Qu’est-ce que le lien ?
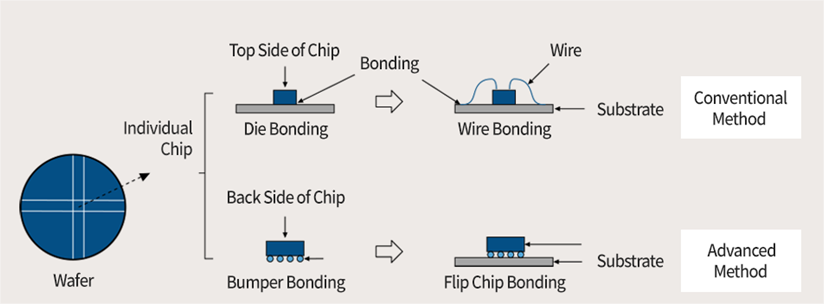
Dans le processus des semi-conducteurs, le « collage » fait référence à la connexion d’une puce à un substrat. Le collage peut être divisé en deux types, à savoir la méthode traditionnelle et la méthode avancée. Les méthodes traditionnelles incluent les connexions de puces (ou connexions de puces) et les connexions filaires, tandis que les méthodes avancées incluent les connexions de puces retournées développées par IBM à la fin des années 1960. Le collage de puces retournées est une méthode qui combine le collage de puces et le collage de fils, et relie la puce et le substrat en formant un convexe sur le revêtement de la puce.
2. Processus de liaison
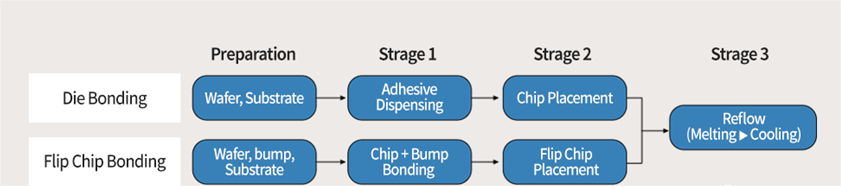
Pour le collage de puces, la première chose à faire est d’appliquer l’adhésif sur le substrat du boîtier. Ensuite, placez une puce dessus, côté épingle vers le haut. Au lieu de cela, dans le cas du flip chip bonding, qui est une méthode plus avancée, de petites bosses appelées billes de soudure sont fixées au revêtement de la puce. Ensuite, la puce est placée sur le substrat avec le côté broche vers le bas. Dans les deux méthodes, l'unité assemblée passe par un canal de reflux de température qui peut être ajusté au fil du temps pour faire fondre l'adhésif ou la bille de soudure. Il est ensuite refroidi pour fixer la puce (ou bosse) au substrat.
3. Sélection et placement des chips
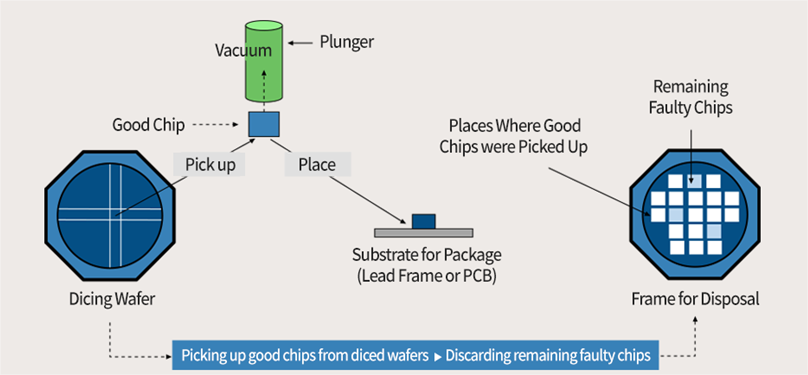
Le retrait individuel de la puce attachée à la bande est appelé « Pick ». Lorsque les bonnes puces sont retirées de la tranche avec le piston, leur placement sur la surface du substrat du boîtier est appelé « Place ». Ces deux tâches, appelées « Pick & Place », sont réalisées sur une Die Bonde.
4. Éjection des copeaux
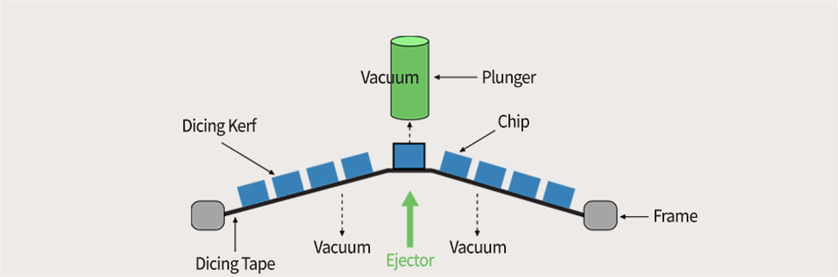
Utilisez une méthode simple pour récupérer la puce : « l’éjection ». Un éjecteur est utilisé pour appliquer des forces physiques à la puce cible, ce qui la fait différer légèrement en termes de taille de pas par rapport aux autres puces. Après avoir éjecté la puce par le bas, tirez-la vers le haut avec un piston à bande à vide. En même temps, tirez le bas du ruban avec un aspirateur pour rendre la surface du ruban lisse.
5. Les copeaux sont liés avec de la résine époxy
Lors du collage de la puce, la connexion est réalisée à l'aide de soudure ou de pâte contenant du métal (Power Tr), ou un polymère (polyimide) peut également être utilisé pour le collage de la puce. Dans les matériaux polymères, les résines époxy pâteuses ou liquides contenant de l'argent sont relativement faciles à utiliser et ont une fréquence d'utilisation élevée.
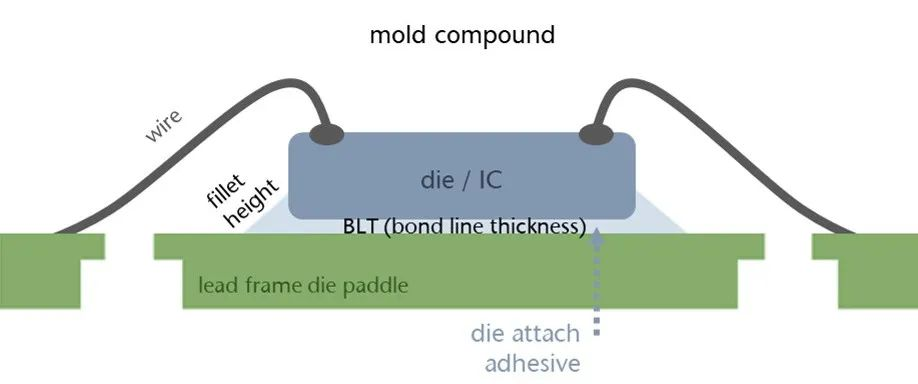
6. Le revêtement sous pression (DAF) a été utilisé pour le collage des copeaux
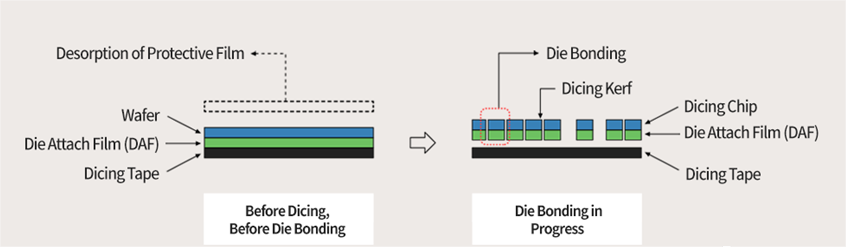
Le DAF est un film mince fixé au bas de la puce. L'épaisseur du DAF peut être ajustée à une épaisseur très fine et constante. Il est largement utilisé non seulement dans la liaison puce-substrat, mais également dans la liaison puce-à-puce pour créer des boîtiers multi-puces (MCP). De par la structure de la puce, le DAF au bas de la puce est collé à la puce, et le ruban de découpe est collé au DAF en dessous, et l'adhérence est faible. Afin d'effectuer une liaison de puce dans cette structure, une fois la puce et le DAF retirés du ruban, la puce est placée directement sur le substrat sans utiliser de résine époxy.
Fountyl Technologies PTE Ltd, se concentre sur l'industrie de fabrication de semi-conducteurs, les principaux produits comprennent : mandrin à broches, mandrin en céramique poreuse, effecteur d'extrémité en céramique, poutre carrée en céramique, broche en céramique, bienvenue au contact et à la négociation !












