Incollaggio del chip: il processo di posizionamento di un chip su un substrato
Il processo di confezionamento è l'ultima fase nella produzione di semiconduttori e la sua sequenza è macinazione, taglio, montaggio, cablaggio e formatura. La sequenza di questi processi può cambiare in base ai cambiamenti nella tecnologia di confezionamento, e può anche essere strettamente correlata tra loro o combinata. Questo articolo si concentra sul wafer bonding, che è una tecnica di incapsulamento utilizzata per agganciare un chip separato da un wafer a un substrato di incapsulamento (lead frame o PCB) dopo un processo di taglio.

1.Cos'è il legame?
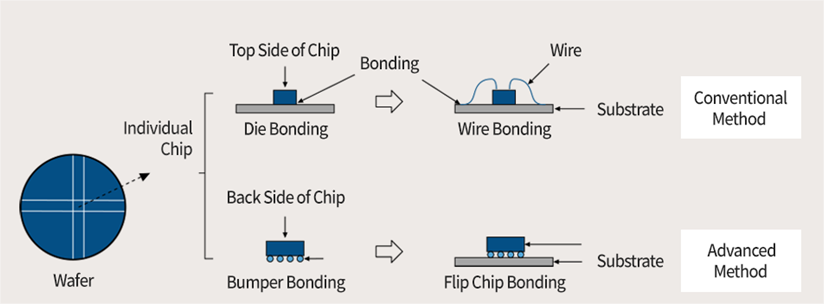
Nel processo dei semiconduttori il termine "bonding" si riferisce al collegamento di un chip wafer a un substrato. L'incollaggio può essere suddiviso in due tipologie, ovvero il metodo tradizionale e il metodo avanzato. I metodi tradizionali includono connessioni chip (o connessioni chip) e connessioni cablate, mentre i metodi avanzati includono connessioni flip chip sviluppate da IBM alla fine degli anni '60. L'incollaggio del chip flip è un metodo che combina l'incollaggio del die e l'incollaggio del filo e collega il chip e il substrato formando un rivestimento convesso sul rivestimento del chip.
2. Processo di incollaggio
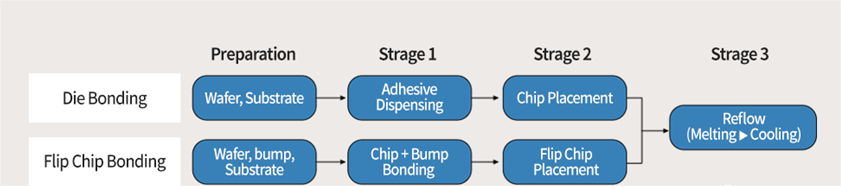
Per l'incollaggio dei trucioli, la prima cosa da fare è rivestire l'adesivo sul substrato della confezione. Quindi, mettici sopra un chip, con lo spillo rivolto verso l'alto. Invece, nel caso del flip chip bonding, che è un metodo più avanzato, piccole protuberanze chiamate sfere di saldatura vengono attaccate al rivestimento del chip. Quindi, il chip viene posizionato sul substrato con il perno rivolto verso il basso. In entrambi i metodi, l'unità assemblata passa attraverso un canale di riflusso della temperatura che può essere regolato nel tempo per sciogliere l'adesivo o la sfera di saldatura. Viene quindi raffreddato per fissare il chip (o la protuberanza) al substrato.
3. Scegli e posiziona le fiches
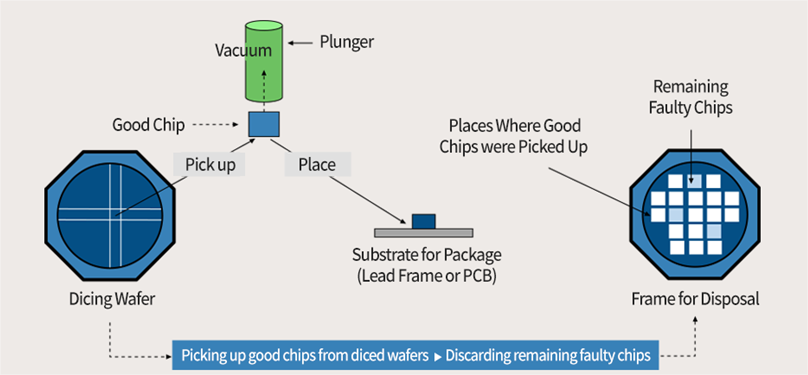
La rimozione individuale del chip attaccato al nastro viene chiamata "Pick". Quando i trucioli buoni vengono rimossi dal wafer con lo stantuffo, il loro posizionamento sulla superficie del substrato della confezione viene chiamato "Place". Questi due compiti, chiamati "Pick & Place", vengono eseguiti su un Die Bonde.
4. Espulsione del truciolo
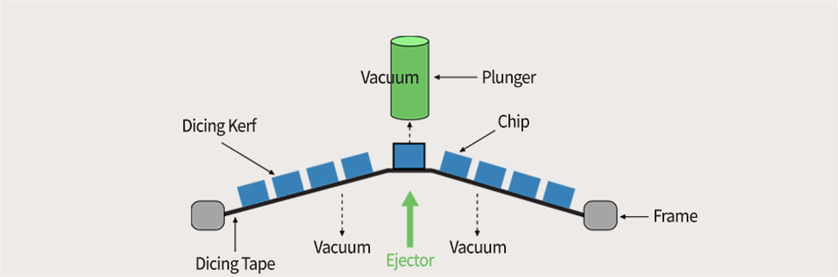
Utilizzare un metodo semplice per raccogliere il chip: "espulsione". Un eiettore viene utilizzato per applicare forze fisiche al chip target, facendolo differire leggermente nella dimensione del passo rispetto agli altri chip. Dopo aver espulso il chip dal basso, tirarlo verso l'alto dall'alto con uno stantuffo della fascia a vuoto. Allo stesso tempo, tirare la parte inferiore del nastro con l'aspirapolvere per rendere liscia la superficie del nastro.
5. I trucioli sono incollati con resina epossidica
Quando si incolla il chip, la connessione viene effettuata utilizzando una lega per saldatura o una pasta contenente metallo (Power Tr), oppure un polimero (poliimmide) che può essere utilizzato anche per l'incollaggio del chip. Nei materiali polimerici, le resine epossidiche in pasta o liquide contenenti argento sono relativamente facili da usare e hanno un'elevata frequenza di utilizzo.
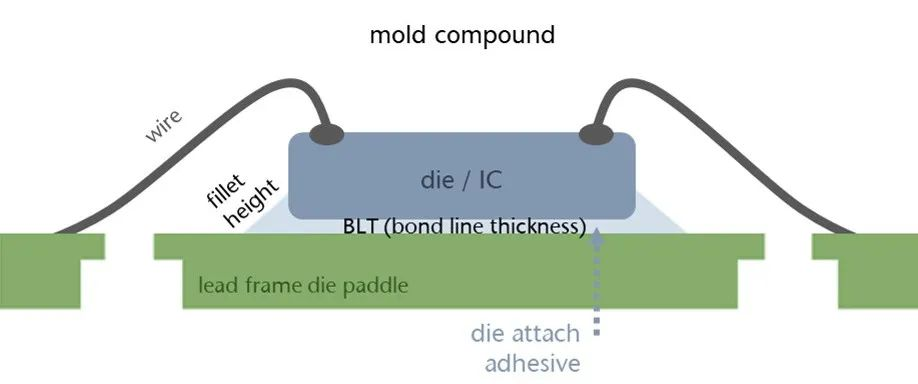
6. Il rivestimento della matrice (DAF) è stato utilizzato per l'incollaggio dei trucioli
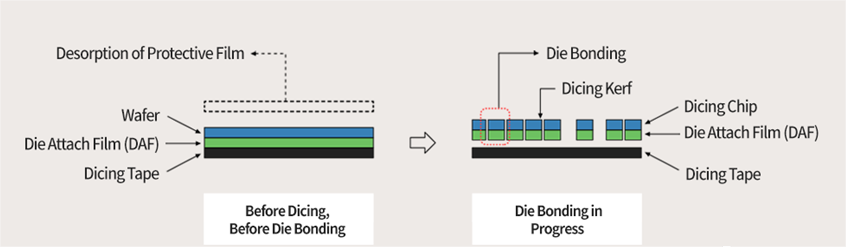
DAF è una pellicola sottile fissata sul fondo del chip. Lo spessore del DAF può essere regolato su uno spessore molto sottile e costante. È ampiamente utilizzato non solo nel collegamento chip-substrato, ma anche nel collegamento chip-to-chip per creare pacchetti multi-chip (MCP). Dalla struttura del chip, il DAF nella parte inferiore del chip è incollato al chip e il nastro per affettare è incollato al DAF sottostante e l'adesione è debole. Per eseguire l'incollaggio del chip in questa struttura, dopo che il chip e il DAF sono stati rimossi dal nastro, il chip viene posizionato direttamente sul substrato senza l'uso di resina epossidica
Fountyl Technologies PTE Ltd, si concentra sull'industria manifatturiera dei semiconduttori, i prodotti principali includono: mandrino a perno, mandrino in ceramica porosa, effettore finale in ceramica, trave quadrata in ceramica, mandrino in ceramica, benvenuto per contatto e negoziazione!











