Quali sono i metodi di scrittura dei wafer?
L'affettatura (taglio) del wafer si riferisce al processo di taglio di un singolo wafer in più chip indipendenti ("matrici"). Questo processo viene eseguito dopo che tutti i processi di produzione dei semiconduttori sono stati completati sul wafer per il successivo confezionamento e test. Esistono molti modi per affettare e oggi lo presenteremo in modo sistematico.
Perché esiste un processo di scrittura?
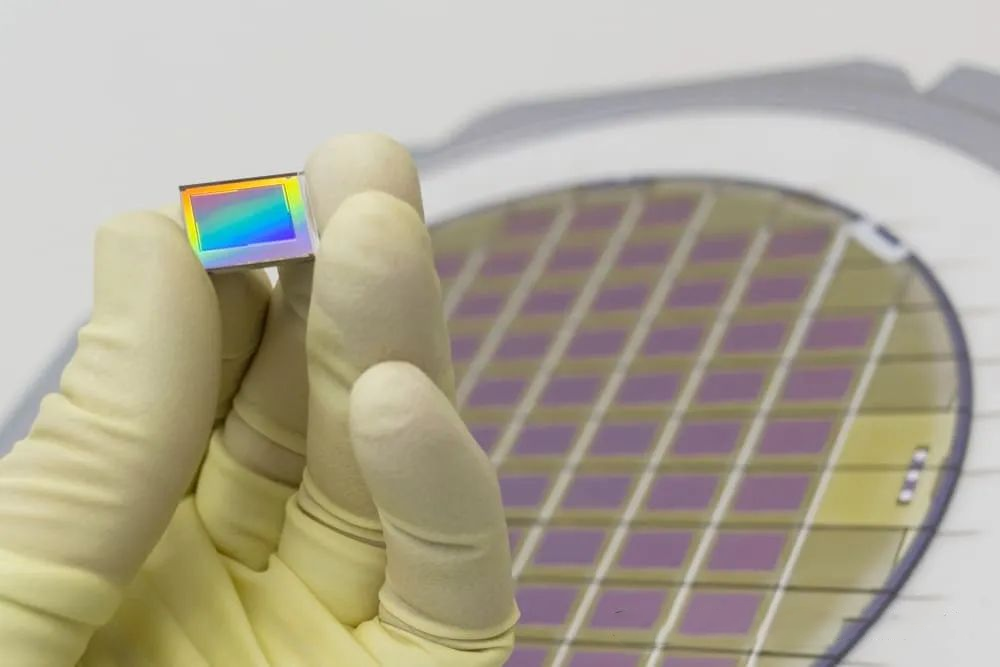
Il wafer contiene migliaia di chip, ogni chip è un'unità indipendente. Una volta terminata la produzione del chip, il chip si trova in uno stato di perfetta perdita e la corrosione chimica, la polvere, l'umidità e così via nell'ambiente terminale causeranno danni fatali al chip, quindi il chip deve essere installato " vestiti" (guscio) per proteggere il chip, cioè l'imballaggio. Il processo di scrittura consente di confezionare singolarmente ciascun chip per l'utilizzo in un ambiente terminale.
Il modo dominante di affettare?
Generalmente ci sono incisioni meccaniche e incisioni laser. La tracciatura laser può essere suddivisa in taglio laser nascosto e taglio laser totale. Ci saranno percorsi di taglio incrociati sul wafer e i percorsi di taglio devono essere tagliati entro i confini dei singoli chip, che generalmente vengono tagliati lungo i percorsi di taglio.
Scritta meccanica
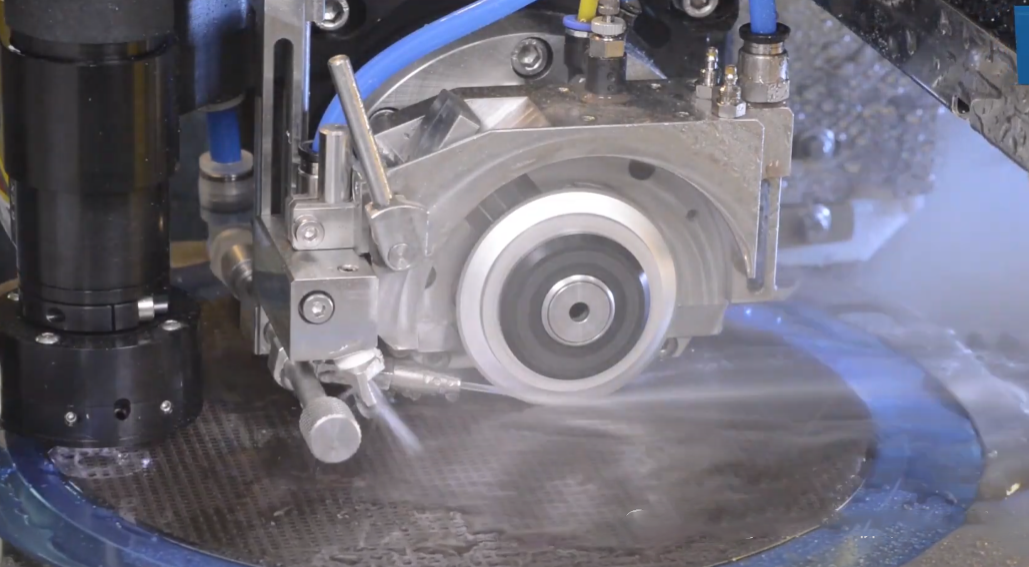
L'incisione meccanica è l'uso di lame diamantate per tagliare fisicamente i wafer, che è il metodo più tradizionale e comunemente utilizzato nell'incisione dei wafer. La lama diamantata viene fatta ruotare ad alta velocità per tagliare il wafer e il calore e i detriti generati vengono portati via dall'acqua.
Vantaggi:
1, l'attrezzatura è economica
2, adatto a vari materiali del wafer
svantaggi:
1, la precisione della tracciatura non è elevata
2, il tasso di scrittura è basso
3, incline alla rottura dei bordi e ad altre anomalie
4, non adatto per wafer troppo sottili, generalmente più di 100um di spessore del wafer adatto per l'incisione meccanica.
Taglio laser
Alcuni wafer sono relativamente fragili e sottili, quindi è facile che si verifichi il problema dei bordi e delle crepe con le lame diamantate, quindi è necessario prendere in considerazione il taglio laser.
Laser Stealth Dicing è un processo in due fasi:
Il primo passo consiste nell'utilizzare il raggio laser per focalizzarlo all'interno del wafer, controllando con precisione la profondità di fuoco del laser, formando una sottile fessura all'interno del wafer, mentre la superficie rimane intatta.
Il secondo passo consiste nell'allungare meccanicamente in modo uniforme il nastro attaccato al retro del wafer. Man mano che il nastro si espande, i singoli chip sul wafer vengono separati lungo il percorso pretagliato al laser.
Taglio completo al laser
Il taglio completo laser si riferisce al raggio laser che viene irradiato direttamente sulla superficie del wafer, attraverso l'intero spessore del wafer, taglia completamente il wafer e separa direttamente un singolo chip. Il taglio totale laser consente un controllo preciso della potenza, della messa a fuoco e della velocità del laser per adattarsi ai diversi requisiti di materiale e spessore. A differenza del taglio laser crittografico, il taglio laser completo non richiede fasi successive di espansione del nastro per separare il chip.
Vantaggi del taglio laser?
1, il tasso di scrittura è molto veloce,
2, il danno da stress è piccolo
3, la precisione della tracciatura è molto elevata
Svantaggi:
1, il prezzo è costoso
2, i detriti generati dalla combustione del laser sono difficili da pulire.
Cos'è la scrittura a fessura?
Per ridurre il problema dell'incisione, è possibile utilizzare prima la fessura del laser, quindi utilizzare la lama diamantata per l'incisione. Può anche essere intagliato con una lama diamantata più spessa e poi affettato con una lama diamantata.
Qual è il processo DBG?
L'esclusivo processo DBG (Dicing Before Grinding) della società Japan Disco si riferisce alla prima parte anteriore del wafer alla profondità specificata (non tagliata attraverso il wafer), quindi alla macinazione della parte posteriore del wafer alla profondità di taglio corrispondente, per ridurre il problema della rottura dei wafer.
Fountyl Technologies PTE Ltd, si concentra sull'industria manifatturiera dei semiconduttori, i prodotti principali includono: mandrino a perno, mandrino in ceramica porosa, effettore finale in ceramica, trave quadrata in ceramica, mandrino in ceramica, benvenuto per contatto e negoziazione!











