Ikatan cip: Proses meletakkan cip pada substrat
Proses pembungkusan adalah langkah terakhir dalam pembuatan semikonduktor, dan urutannya adalah pengisaran, pemotongan, pemasangan, pendawaian, dan pembentukan. Urutan proses ini boleh berubah mengikut perubahan dalam teknologi pembungkusan, dan juga boleh berkait rapat antara satu sama lain atau digabungkan. Artikel ini memfokuskan pada ikatan wafer, iaitu teknik enkapsulasi yang digunakan untuk melibatkan cip yang diasingkan daripada wafer ke substrat enkapsulasi (bingkai plumbum atau PCB) selepas proses pemotongan.

1.Apakah ikatan?
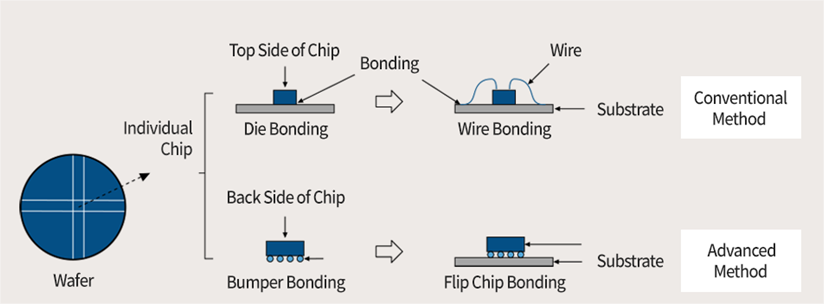
Dalam proses semikonduktor, "ikatan" merujuk kepada sambungan cip wafer ke substrat. Ikatan boleh dibahagikan kepada dua jenis iaitu kaedah tradisional dan kaedah lanjutan. Kaedah tradisional termasuk sambungan cip (atau sambungan cip) dan sambungan wayar, manakala kaedah lanjutan termasuk sambungan cip flip yang dibangunkan oleh IBM pada akhir 1960-an. Ikatan cip terbalik ialah kaedah yang menggabungkan ikatan die dan ikatan wayar, dan menyambungkan cip dan substrat dengan membentuk cembung pada pelapik cip.
2. Proses ikatan
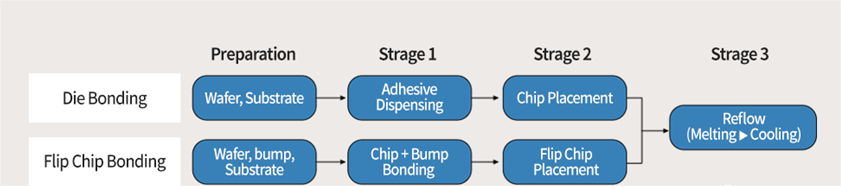
Untuk ikatan cip, perkara pertama yang perlu dilakukan ialah menyalut pelekat pada substrat pakej. Kemudian, letakkan cip di atasnya, sematkan sisi ke atas. Sebaliknya, dalam kes ikatan cip flip, yang merupakan kaedah yang lebih maju, bonggol kecil yang dipanggil bola pateri dilekatkan pada pelapik cip. Kemudian, cip diletakkan pada substrat dengan bahagian pin ke bawah. Dalam kedua-dua kaedah, unit yang dipasang melalui saluran refluks suhu yang boleh dilaraskan dari semasa ke semasa untuk mencairkan pelekat atau bola pateri. Ia kemudiannya disejukkan untuk melekatkan cip (atau benjolan) pada substrat.
3. Pilih & Tempat Kerepek
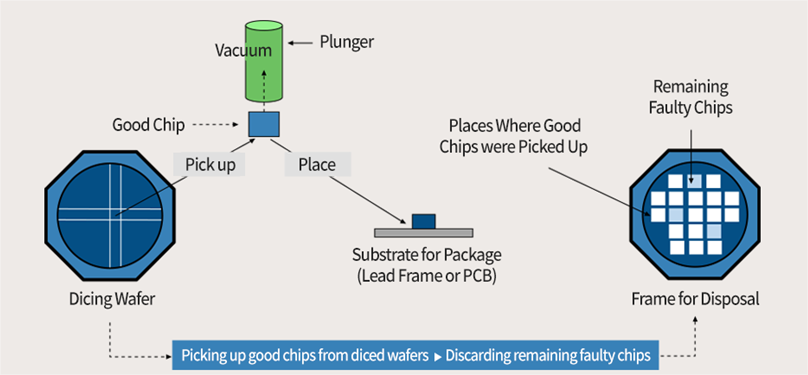
Mengeluarkan cip yang dipasang pada pita secara individu dipanggil "Pilih." Apabila cip yang baik dikeluarkan dari wafer dengan pelocok, meletakkannya di permukaan substrat pakej dipanggil "Tempat". Kedua-dua tugas ini, dipanggil "Pick & Place," dilakukan pada Die Bonde.
4. Pelepasan cip
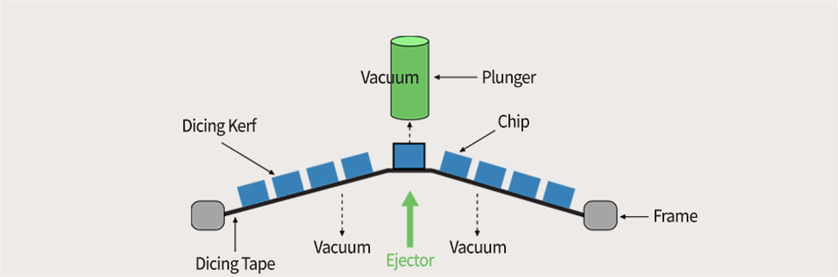
Gunakan kaedah yang mudah untuk mengambil cip: "ejection." Ejector digunakan untuk menggunakan daya fizikal pada cip sasaran, menyebabkan ia berbeza sedikit dalam saiz langkah daripada cip lain. Selepas mengeluarkan cip dari bawah, tarik cip ke atas dari atas dengan pelocok jalur vakum. Pada masa yang sama, tarik bahagian bawah pita dengan vakum untuk menjadikan permukaan pita licin.
5. Cip diikat dengan resin epoksi
Apabila mengikat cip, sambungan dibuat dengan menggunakan pateri atau tampal yang mengandungi logam (Power Tr), atau polimer (polyimide) juga boleh digunakan untuk ikatan cip. Dalam bahan polimer, resin epoksi pes atau cecair yang mengandungi perak agak mudah digunakan dan mempunyai kekerapan penggunaan yang tinggi.
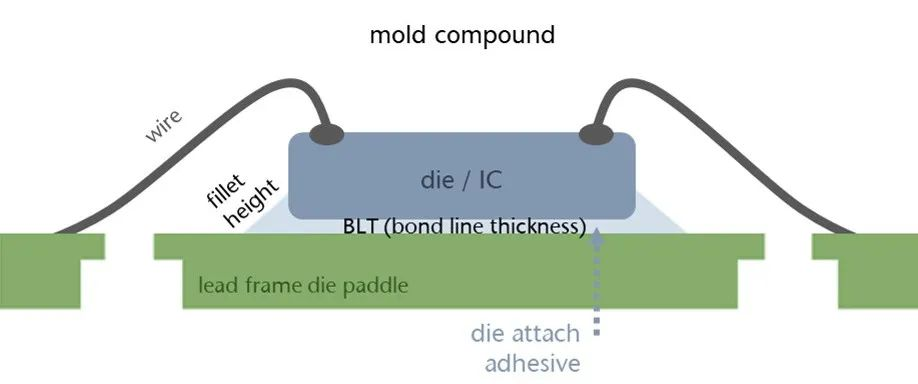
6. Die coating (DAF) digunakan untuk ikatan cip
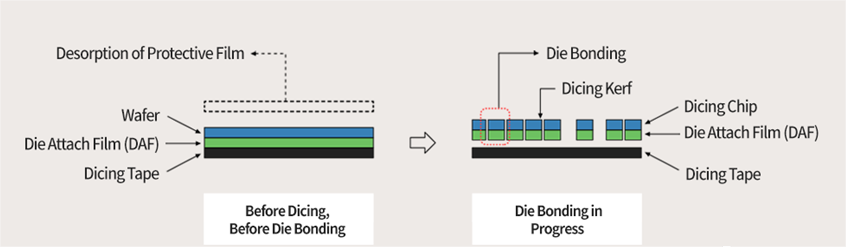
DAF ialah filem nipis yang dilekatkan pada bahagian bawah cip. Ketebalan DAF boleh dilaraskan kepada ketebalan yang sangat nipis dan berterusan. Ia digunakan secara meluas bukan sahaja dalam ikatan cip-ke-substrat, tetapi juga dalam ikatan cip-ke-cip untuk mencipta pakej berbilang cip (MCP). Dari struktur cip, DAF di bahagian bawah cip dilekatkan pada cip, dan pita penghiris dilekatkan pada DAF di bawahnya, dan lekatannya lemah. Untuk melakukan ikatan cip dalam struktur ini, selepas cip dan DAF dikeluarkan dari pita, cip diletakkan terus pada substrat tanpa menggunakan resin epoksi
Fountyl Technologies PTE Ltd, memberi tumpuan kepada industri pembuatan semikonduktor, produk utama termasuk: Pin chuck, poros ceramic chuck, seramik end effector, seramik square rasuk, seramik spindle, dialu-alukan untuk menghubungi dan rundingan!











