Kawalan aliran dalam litografi rendaman
Selama lebih daripada sepuluh tahun, litografi rendaman telah menjadi teknologi pendedahan utama dalam pembuatan semikonduktor. Berbanding dengan kaedah litografi kering tradisional, teknik ini meningkatkan resolusi pendedahan dengan menyuntik cecair indeks biasan tinggi ke dalam celah antara kanta dan permukaan wafer. Mengekalkan ketulenan dan keseragaman cecair tenggelam dan mengelakkan pembentukan titisan sisa dalam proses pengimbasan berkelajuan tinggi adalah dua cabaran utama yang dihadapi oleh pembangunan teknologi litografi tenggelam. Bahan cemar, zarah, buih, pemanasan dan tegasan dalam cecair boleh mengganggu kesinambungan indeks biasan. Pergerakan wafer berkelajuan tinggi semasa pengimbasan boleh menjejaskan kestabilan meniskus pada antara muka antara cecair dan gas di sekeliling, mengakibatkan titisan sisa pada wafer. Fenomena di atas akan menjejaskan prestasi pendedahan litografi rendaman, dan kaedah kawalan tingkah laku aliran yang sepadan diperlukan untuk menyelesaikan masalah.
1, Pengaruh kawalan tingkah laku aliran terhadap ketulenan dan keseragaman cecair
1.1.Pengaruh kelakuan aliran terhadap ketulenan dan keseragaman cecair
1.1.1.Zarah dan bahan cemar
Zarah dan bahan cemar adalah sumber utama kekotoran pepejal dalam cecair yang tenggelam. Zarah-zarah yang terampai dalam cecair yang direndam berhampiran permukaan wafer atau di atas photoresist boleh diimej ke dalam photoresist yang mendasari atau dipindahkan ke dalam photoresist semasa pembangunan.
Zarah mungkin terdapat dalam bekalan cecair atau mungkin datang dari mana-mana permukaan yang disentuh cecair. Pertama, cecair yang digunakan untuk rendaman tidak dapat dielakkan mengandungi zarah dan kekotoran, jadi air ternyahion bilik bersih digunakan sebagai larutan rendaman dan ia selanjutnya dirawat dan ditapis sebelum disuntik ke dalam kepala rendaman. Masalah zarah lain ialah pengelupasan filem di sekeliling serong wafer, yang disebabkan oleh lekatan yang tidak mencukupi antara permukaan serong dan salutan permukaan. Semasa pendedahan, zarah ini boleh diangkut ke sana ke mari melalui meniskus cecair dari tepi wafer ke pusat wafer. Kaedah untuk menyelesaikan masalah ini termasuk pemilihan photoresist, pengoptimuman formulasi EBR, dan pemprosesan wafer. Pad wafer juga merupakan sumber zarah yang berpotensi. Apabila kepala yang tenggelam bergerak melintasi wafer, kepala yang tenggelam mengambil zarah dan menyimpannya semula. Pembersihan konvensional meja wafer akan mengurangkan bilangan zarah, dan teknologi pembersihan in-situ telah terbukti sebagai kaedah pembersihan medan yang sangat berkesan. Kecacatan lain yang disebabkan oleh zarah fotoresist/lapisan telus yang diendapkan pada permukaan fotoresist atau filem lapisan atas (sebagai kecacatan anti-gelembung) boleh dikurangkan dengan mengoptimumkan formulasi salutan.
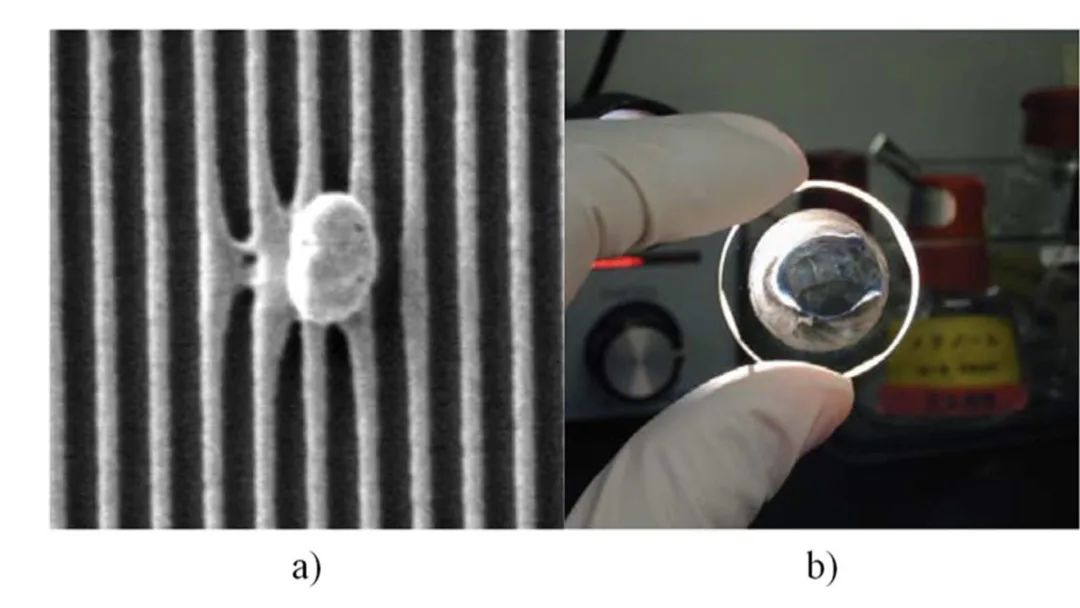
Cara yang berkesan untuk menyelesaikan masalah larut lesap adalah dengan menggunakan kadar larut lesap yang rendah bagi lapisan rintangan atau penghalang atas. Membilas filem tahan dengan air ternyahion juga telah disiasat sebagai alternatif kepada masalah larut lesap. Di samping itu, kawasan kepala terendam adalah lebih besar daripada kawasan medan pendedahan, yang bermaksud bahawa wafer direndam sebelum dan selepas pendedahan, seperti dalam proses pembilasan [38]. Oleh kerana cecair terus mengalir melalui kepala terendam semasa pendedahan dan rendaman, bahan cemar dalam cecair terendam akan disingkirkan dengan banyak dan oleh itu boleh menggantikan proses pembilasan.
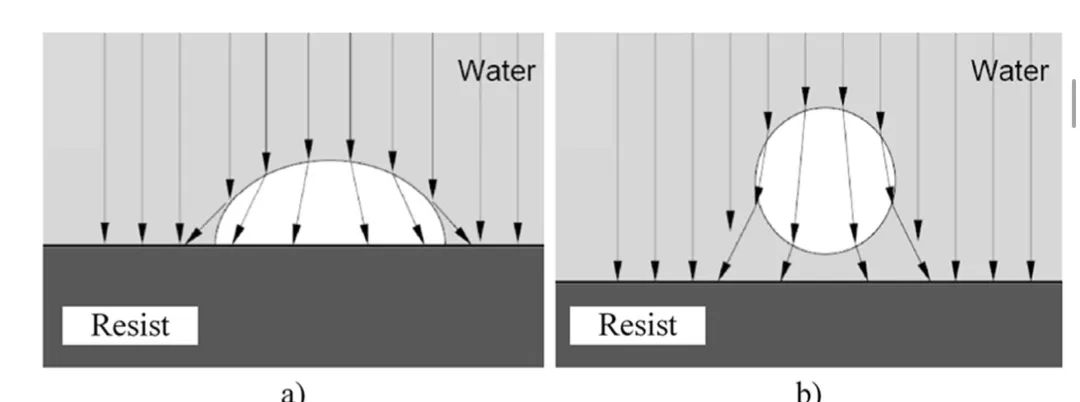
Gelembung memantul dan membiaskan cahaya masuk. a) pada permukaan photoresist, dan b) terapung dalam larutan yang direndam.
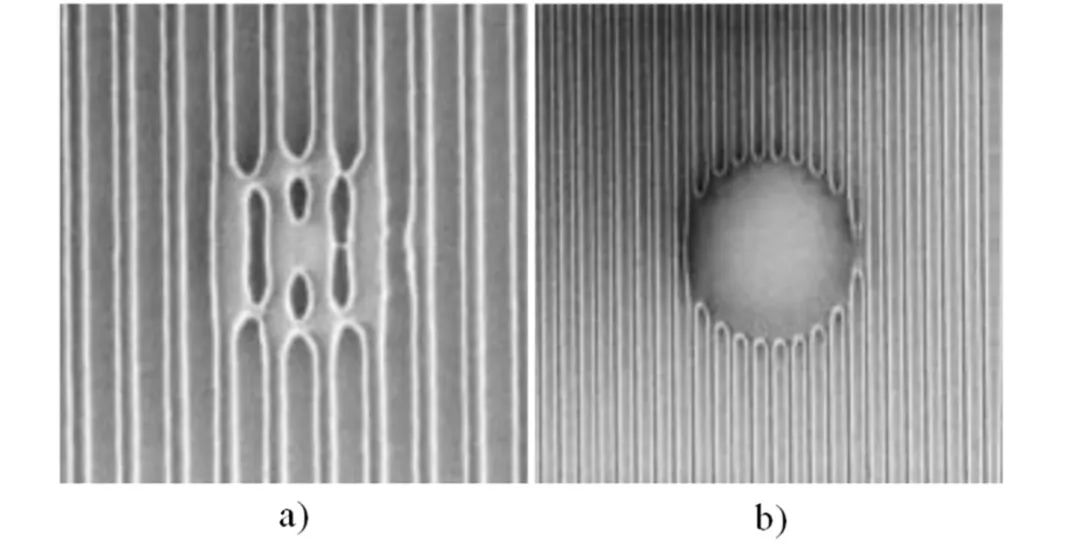
Kecacatan buih pelbagai saiz. a) 0.85μm, b) 3μm.
1.1.2.Bubble
Salah satu cabaran utama litografi rendaman gelembung ialah keperluan supaya tiada gelembung muncul dalam larutan rendaman semasa proses pendedahan. Antara muka gas-cecair melengkung yang disebabkan oleh buih memantulkan dan membiaskan cahaya kejadian, yang mewujudkan ketakselanjaran indeks biasan dan meningkatkan kesan serakan, akhirnya mengakibatkan kecacatan pada corak dan mengurangkan hasil.
Faktor utama yang mempengaruhi kesan buih ialah masa pendedahan, saiz buih dan ketinggian buih di atas wafer, dengan masa pendedahan yang lebih pendek meningkatkan kesan buih, menyebabkan ciri kekal di kawasan yang lebih berbayang untuk lebih banyak masa pendedahan . Kedua, jika gelembung adalah saiz yang sama dengan panjang gelombang cahaya yang digunakan untuk pendedahan, cahaya menyerakkan dan meningkatkan cahaya sesat. Jika saiz gelembung adalah mikrometer atau lebih besar, gelembung akan sebahagiannya menyekat dan menukar arah cahaya. Akhir sekali, kajian itu juga mendapati bahawa kesan keseluruhan buih pada imej bergantung pada jarak buih dari permukaan wafer - semakin jauh jaraknya, semakin lemah kesannya, kerana buih dari fotoresist boleh dihanyutkan dengan cepat dalam cecair yang bergerak pantas. Jika nisbah jarak gelembung dari wafer kepada diameter gelembung ialah 4:10, kesan gelembung terapung tunggal adalah diabaikan. Apabila gelembung semakin hampir dengan wafer, disebabkan oleh aliran bendalir yang lebih perlahan berhampiran permukaan wafer, bayang gelembung dalam satah imej menjadi lebih kuat dan hayatnya di lokasi tertentu pada wafer menjadi lebih lama. Akibatnya, gelembung yang melekat pada permukaan wafer menimbulkan ancaman yang lebih besar kepada imej tanpa kecacatan. Melalui kajian sistematik kesan penyebaran gelembung dalam litografi tenggelam, diramalkan bahawa 60nm adalah saiz gelembung maksimum yang tidak akan menyebabkan kecacatan apabila gelembung dilekatkan pada permukaan fotoresist. Gelembung dalam litografi tenggelam mungkin disebabkan oleh gangguan pelbagai faktor seperti tekanan, suhu, tindak balas fotokimia dan dinamik bendalir.
1.1.3.Pemanasan
Semasa pendedahan, cecair yang direndam dipanaskan secara tidak sekata, dan taburan suhu boleh menjejaskan imej dalam beberapa cara, di samping menghasilkan sejumlah kecil penyimpangan sfera dan lebih tinggi, dan kecacatan pengimejan utama ialah nyahfokus. Jika kita hanya membenarkan jumlah penyahfokusan sebanyak 1 nanometer, perubahan indeks biasan perlu dikekalkan sangat kecil. Oleh kerana pekali suhu air (dn/dτ=-10-4K-1) adalah sangat besar berbanding dengan gas, suhu cecair perlu dikekalkan dalam lingkungan 10 mK, yang meletakkan had ketat pada pengendalian cecair dan sistem kawalan suhu.
1.1.4.Tekanan
Untuk litografi rendaman, kelikatan tinggi dan ketumpatan tinggi cecair yang direndam, berbanding udara dalam litografi kering, boleh menyebabkan tekanan yang ketara pada kedua-dua permukaan kanta dan wafer. Tegasan normal dan ricih ini boleh menyebabkan herotan kanta dan birefringence, sekali gus mengganggu laluan cahaya seragam.
1.2.Kaedah kawalan
Terdapat tiga cara untuk mengurangkan tingkah laku di atas yang menjejaskan prestasi pendedahan. Untuk mengelakkan kekotoran dan buih daripada proses pendedahan,
Dalam Bahagian
1.2.1 larut lesap rendah dan fotoresist pelepasan gas rendah digunakan. Untuk mengelakkan gelembung dan zarah daripada dicetak pada wafer, Bahagian
1.2.2 menerangkan kaedah pendawaian khusus dan kaedah salutan tebal. Akhir sekali, untuk mengimbangi taburan suhu dan tegasan dengan membawa bahan cemar, zarah, buih, dan haba dari kawasan pendedahan,
Bahagian
1.2.3menggunakan kaedah bekalan dan pemulihan cecair.
Nikon ialah syarikat pertama di dunia yang membangunkan pengimbas rendaman ArF untuk pengeluaran, NSR-S609B [75]. Sebelum ini, mereka telah membuat banyak percubaan pada struktur kepala terendam berdasarkan kaedah pengisian tempatan. Mereka mensimulasikan kaedah pengisian tempatan dengan dan tanpa sistem bekalan dan pemulihan cecair [54,67] dan mendapati bahawa sistem bekalan dan pemulihan cecair juga bertindak sebagai struktur pembendungan cecair. Dengan ketiadaan sistem bekalan dan pemulihan, sebahagian cecair terletak di luar kawasan kanta, dengan beberapa ruang kosong di bawah kawasan kanta. Dengan adanya sistem suapan dan pemulihan, aliran pemulihan menguatkan ketegangan permukaan pada antara muka gas-cecair di sekeliling lubang cecair, berjaya mengurung cecair ke kawasan setempat di bawah kanta, menunjukkan pembendungan cecair yang lebih baik.
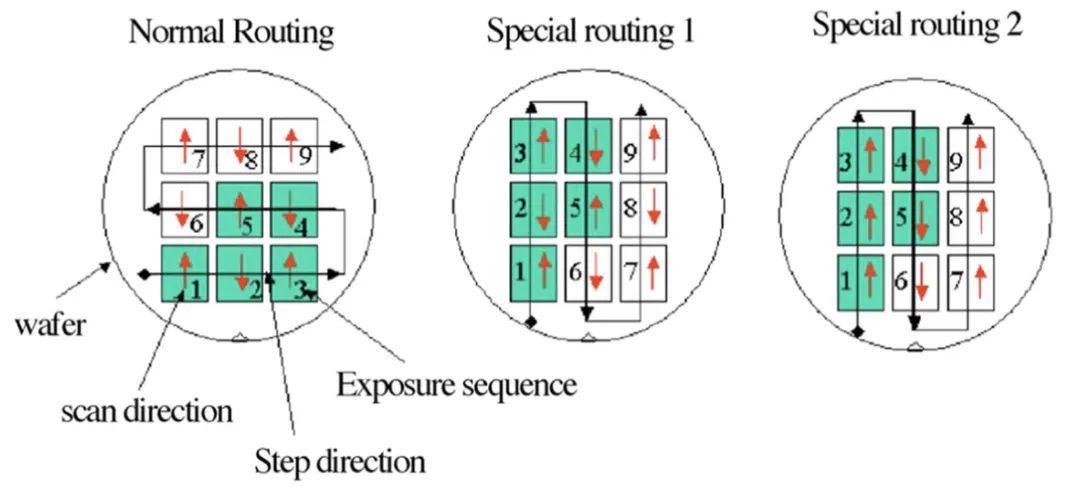
Pendawaian biasa dan 2 pendawaian khas untuk mengurangkan kecacatan
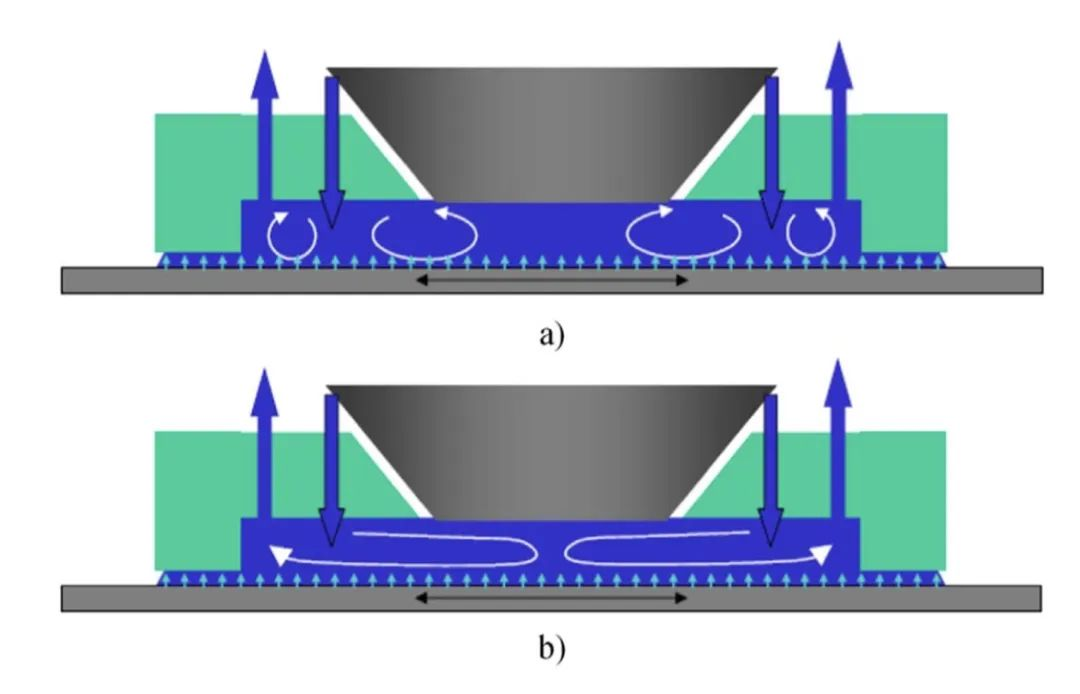
Dua susunan muncung yang berbeza. a) muncung generasi lama; b) Muncung baru.
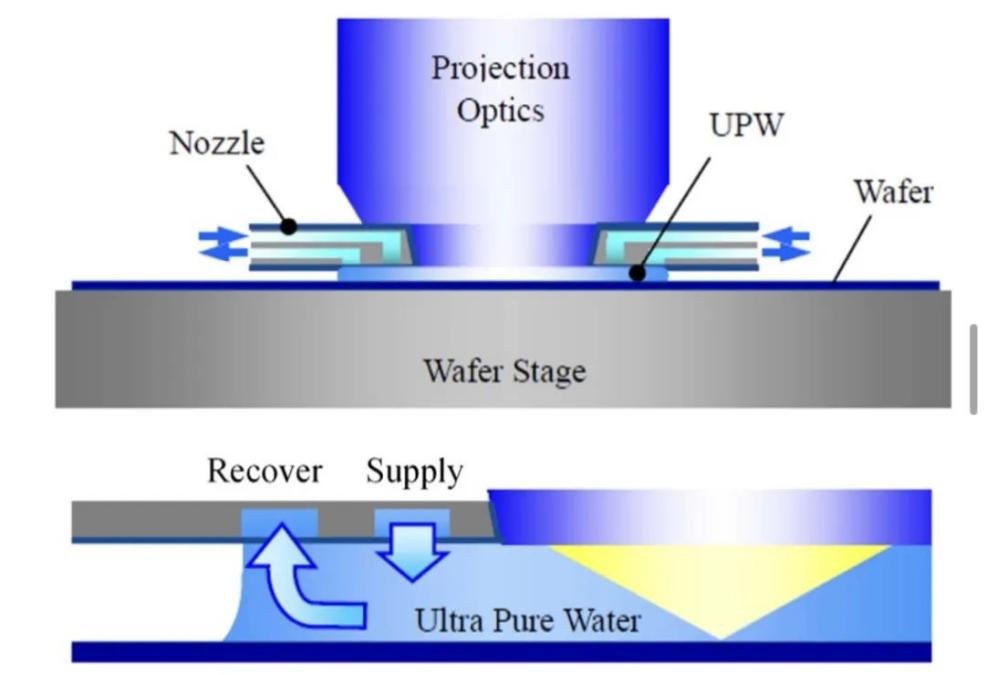
Struktur asas sistem rendaman LLF.
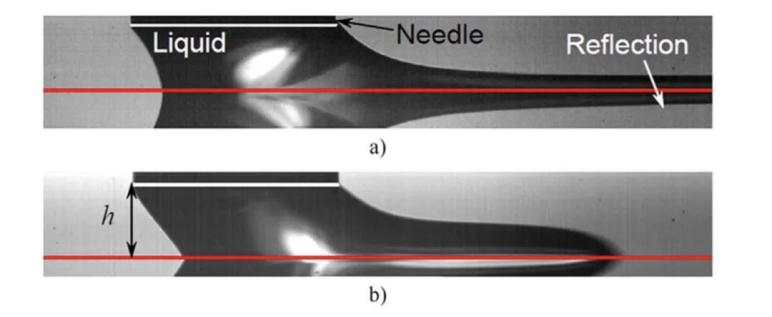
Bentuk meniskus yang tipikal. a). Peregangan filem, b). Limpahan inersia.
2. Kawalan tingkah laku aliran kestabilan meniskus
2.1.Ketidakstabilan meniskus dan titisan sisa dalam litografi rendaman
Sepanjang proses, bendalir mesti kekal dalam jurang antara kanta optik terakhir dan wafer. Apabila wafer bergerak di bawah cecair, daya likat mula menarik cecair ke arah pengimbasan dan menjejaskan meniskus. Melangkaui kelajuan tertentu, kestabilan meniskus yang surut terganggu, dan cecair ditarik keluar daripada isipadu cecairnya dan seterusnya dipecahkan kepada titisan. Titisan sisa ini boleh kekal pada wafer dan menyebabkan banyak kecacatan imej. Kini dalam industri semikonduktor, kelajuan pengimbasan pembuatan besar-besaran ialah 800mm/s, dan ia akan menjadi lebih tinggi pada masa hadapan. Oleh itu, adalah perlu untuk memastikan bahawa meniskus medan tenggelam tidak kehilangan kestabilan dalam keperluan halaju ini.
2.2Penyelidikan asas mengenai kestabilan meniskus
Halaju kritikal merujuk kepada halaju maksimum yang boleh dicapai tanpa memendapkan sisa cecair, dan merupakan parameter prestasi yang sangat penting dalam litografi rendaman. Melalui eksperimen "drag drop" pada 41 photoresist yang berbeza [80,87,88], keputusan menunjukkan bahawa halaju kritikal meningkat dengan ketara dengan peningkatan Sudut sentuhan kemelesetan statik, kedua-dua dalam keadaan lukisan filem dan dalam keadaan limpahan inersia. .
2.3.Kaedah kawalan
Terdapat tiga cara untuk mengurangkan titisan sisa pada wafer. Untuk meningkatkan kestabilan meniskus dan mengelakkan pembentukan titisan sisa semasa pendedahan, lebih banyak fotoresist hidrofobik boleh digunakan dalam litografi rendaman. Untuk mengeluarkan sisa titisan yang baru sahaja meninggalkan meniskus, tirai udara dan medium berliang digunakan. Untuk mengawal kadar aliran cecair berhampiran saluran pemulihan dan memudahkan fungsi pemulihan, pengubahsuaian permukaan berdasarkan permukaan heterogen dengan kontras kebolehbasahan boleh digunakan pada kepala yang tenggelam.
2.3.1. Hidrofobisiti permukaan kubah yang diubah suai mengawal kelajuan pengimbasan dan pendedahan wafer. Hidrofobisiti yang lebih tinggi bermakna Sudut sentuhan surut statik yang lebih tinggi, yang menjadikannya lebih mudah dan lebih cepat untuk cecair yang terendam bergerak merentasi wafer tanpa meninggalkan sisa titisan. Oleh itu, hidrofobisiti yang lebih tinggi adalah kunci untuk memaksimumkan daya pemprosesan dan, apabila digabungkan dengan kadar kecacatan yang lebih rendah, juga boleh meningkatkan hasil.
2.3.2.Kaedah pembendungan cecair kedua
Satu lagi cara untuk mengawal kestabilan meniskus ialah reka bentuk khas kepala yang tenggelam. Dengan mengambil kira sudut sentuhan yang berbeza antara rintangan dan kemasan yang berbeza dan cecair yang tenggelam, struktur kepala yang terendam mesti dapat mencapai julat operasi yang luas pada kelajuan pengimbasan yang tinggi. ASML melaporkan bahawa menggunakan kepala terendam baharu dengan ketara mengurangkan jumlah kecacatan (lebih daripada 3x) apabila kelajuan imbasan ialah 600 mm/s.
Pengoptimuman yang paling biasa untuk kepala terendam ialah struktur tirai udara. Reka bentuk ini mencipta tirai udara bertekanan tinggi di sekeliling kawasan terendam, mengekalkan cecair dalam celah di bawah elemen optik terakhir.
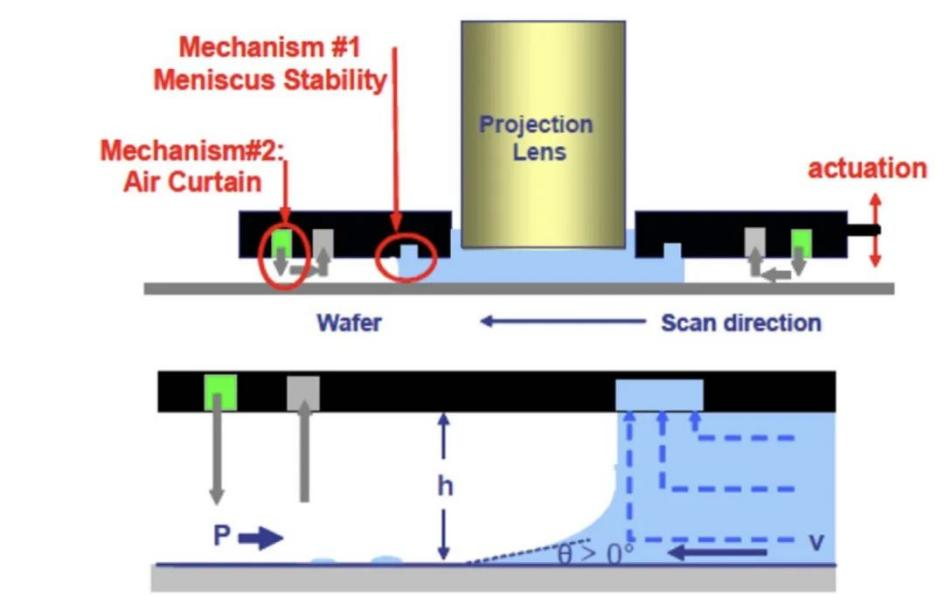
2.3.3.Pengubahsuaian permukaan kepala terendam
Pengubahsuaian permukaan di atas untuk kawalan kestabilan meniskus semuanya digunakan pada wafer dan berdasarkan permukaan homogen, tetapi permukaan heterogen dengan kontras kebolehbasahan juga boleh digunakan untuk menampung cecair dalam celah. Memandangkan proses litografi sebenar mungkin tidak membenarkan pengubahsuaian heterogen permukaan rintangan, kaedah ini boleh digunakan pada kepala yang tenggelam.
Fountyl Technologies PTE Ltd, memberi tumpuan kepada industri pembuatan semikonduktor, produk utama termasuk: Pin chuck, poros ceramic chuck, seramik end effector, seramik square rasuk, seramik spindle, dialu-alukan untuk menghubungi dan rundingan!











