Jenis pemotongan wafer silikon karbida
Silikon karbida ialah bahan yang sangat keras dan rapuh (Kekerasan Mohs 9.2), yang boleh menyebabkan masalah pemprosesan. Ini benar terutamanya semasa proses bahagian belakang, di mana wafer mesti dipecahkan kepada cip yang diasingkan sebelum dibungkus.
1, pemotongan pisau berlian
Pemotongan bilah berlian mekanikal ialah teknik tradisional untuk mengasingkan wafer SiC.
Wafer dipasang pada filem biru dan dipotong oleh bilah bersalut berlian yang berputar pada kelajuan tinggi. Lebar landasan pemotongan biasanya dalam lingkungan 50 hingga 100 mikron.
Disebabkan oleh kekerasan SiC, kelajuan pemotongan bilah lebih rendah, dan lelasan bilah pemotong lebih tinggi, mengakibatkan kos yang lebih tinggi. Di samping itu, pemotongan bilah boleh menyebabkan pemecahan tepi cip dan penembusan. dengan saiz wafer silikon karbida berubah daripada 4 inci kepada 6 inci diameter, panjang landasan terkumpul lebih daripada dua kali ganda, melebihi keupayaan bilah standard untuk melakukan semua pemotongan. Akibatnya, bilah mesti diganti semasa wafer masih dalam kedudukan berfungsi dan boleh pecah semasa proses pemotongan, merosakkan wafer.
Sebagai contoh, satu pc tulisan wafer SiC dalam 100mm (4 inci) perlu mengambil masa 6 hingga 8 jam, dan ia mudah menyebabkan pecahnya tepi. Oleh itu, kaedah pemprosesan tradisional yang tidak cekap ini telah digantikan secara beransur-ansur dengan scribing laser.
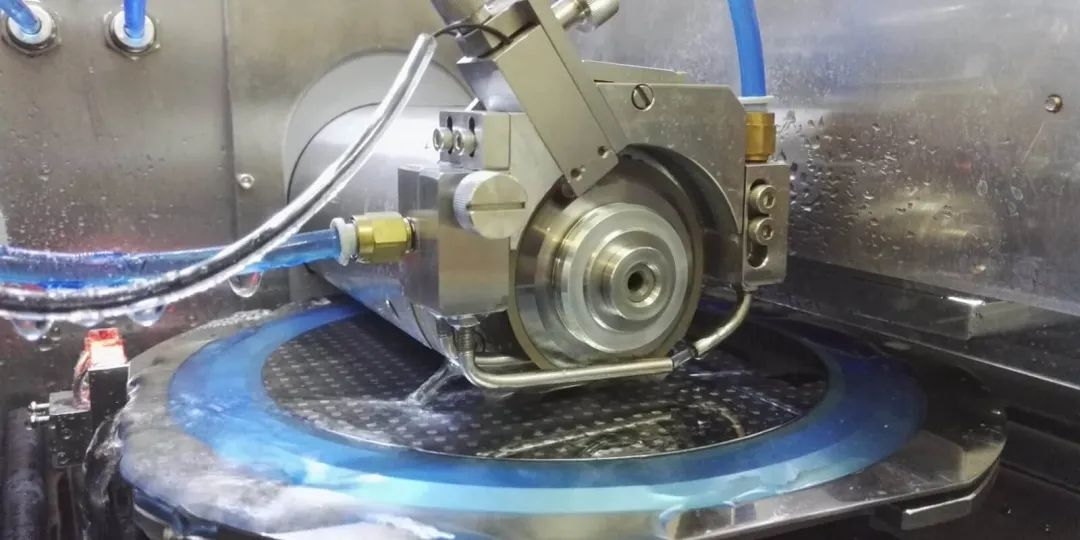
2, pemotongan ablasi laser
Ablasi laser adalah alternatif kepada pemotongan wafer mekanikal. Pancaran laser tertumpu pada landasan pemotongan. Bahan dipanaskan oleh tenaga laser yang diserap. Ini mengakibatkan kawasan terjejas haba yang ketara dan retakan mikro. Filem biru juga mungkin dipengaruhi oleh haba, yang mungkin menjejaskan proses pembungkusan seterusnya. Di samping itu, kadar ablasi adalah sangat rendah dan perlu dilakukan beberapa kali untuk memisahkan cip. Bilangan ulangan bergantung pada ketebalan wafer dan kelajuan pemotongan. Untuk mengelakkan sisa bahan pada cip, permukaan wafer mesti disalut dengan salutan pelindung. Kelemahan utama teknologi pemotongan ini adalah kualiti kelebihan rendah dan produktiviti rendah.
Dalam pemotongan senyap, pancaran laser panjang gelombang pendek yang melalui wafer SiC difokuskan di dalam bahan. Ia mencipta lapisan kecacatan setempat di dalam bahan, yang menjadi titik permulaan untuk pemisahan wafer. Pertama, pancaran laser difokuskan pada bahagian bawah wafer dan bergerak ke atas lapisan demi lapisan. Disebabkan oleh proses perpecahan, tiada penyingkiran bahan dalam laluan pemotongan, mengakibatkan hirisan sifar. Kedua, pemisahan akhir cip mesti dicapai dengan proses penyambungan mekanikal yang berasingan serta pengembangan filem biru. Kerana laser memanaskan bahan di dalam wafer, tiada kerosakan haba pada permukaan wafer. Kecacatan pada corak rantai mutiara dengan kawasan bertindih hanya boleh timbul di dalam bahan. Di samping itu, setiap kadar pemotongan adalah kira-kira 200mm/s, dan dalam beberapa aplikasi boleh mencapai 300mm/s. Walau bagaimanapun, bergantung kepada ketebalan bahan, laser perlu melalui beberapa kali sebelum ia dapat memisahkan cip. Ini mengakibatkan kerosakan pada dinding sisi cip disebabkan oleh lapisan yang diubah. Untuk memfokuskan pancaran laser pada titik yang sangat kecil di dalam wafer, pancaran yang bertaburan pada permukaan rata di landasan pemotongan perlu licin dan diminimumkan. Untuk mengelakkan pantulan laser, landasan bebas potong logam diperlukan. Kelemahan lain ialah lebar yang diperlukan untuk membuka landasan adalah fungsi ketebalan wafer (biasanya 40% daripada ketebalan wafer), yang bermaksud bahawa untuk wafer SiC standard dengan ketebalan 350μm, lebar landasan potongan minimum yang diperlukan ialah 140μm.
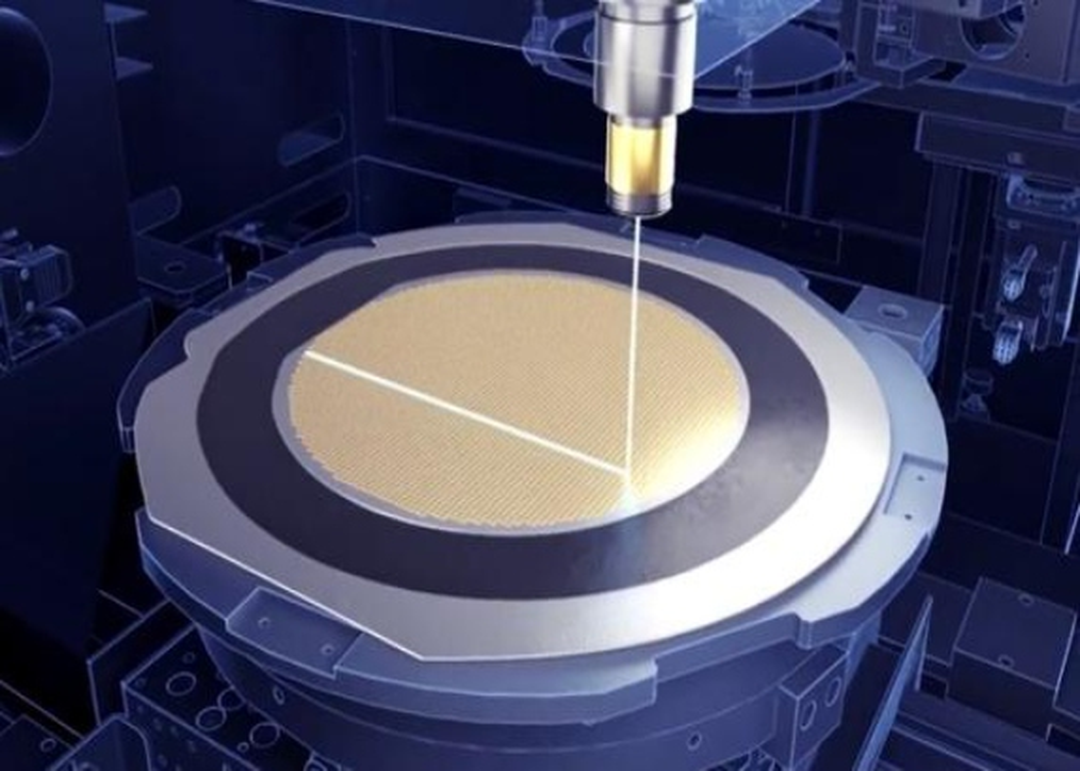
3, pemotongan TLS
Pemisahan Laser Terma adalah alternatif yang pantas, bersih dan kos efektif untuk mengasingkan wafer silikon karbida. Laser memanaskan bahan dan mencipta kawasan tegasan mampatan yang dikelilingi oleh corak tegasan tegangan tangen. Kemudian sejumlah kecil semburan air ternyahion disembur, yang mewujudkan zon sejuk kedua berhampiran zon pertama, menyebabkan corak tegasan tegangan tangen. Tegasan tegangan dicipta di kawasan di mana dua corak tegasan bertindih, yang membuka dan membimbing hujung retak melalui keseluruhan bahan.
Pemotongan TLS ialah proses satu langkah yang boleh memisahkan wafer keseluruhan ketebalan pada kelajuan pengasingan sehingga 300mm/s. Titik permulaan ialah calar cetek setempat atau berterusan pada permukaan wafer. Memandangkan pemotongan TLS adalah proses split, ia berpotensi untuk mengurangkan lebar landasan pemotongan dan meningkatkan bilangan cip pada setiap wafer. Tepi cip adalah licin, tanpa tegasan sisa atau retak mikro dan zon pemecahan. Struktur logam (PCM) pada landasan hadapan dan polimida pada cip boleh diterima. Di samping itu, oleh kerana pemisahan berasal daripada lobus dan bukannya pemisahan/patahan fizikal berikutnya, logam pelapis boleh diasingkan tanpa penyimpangan atau dipengaruhi oleh haba. Analisis hasil menggunakan proses pemotongan TLS pada wafer peranti kuasa biasa dengan bahagian belakang logam sepenuhnya menunjukkan bahawa hasil purata polimida dan struktur logam pada landasan pemotongan melebihi 98%.
4,Tulisan laser berpandukan air
Laser panduan air adalah untuk memfokuskan laser ke dalam lajur air mikro, diameter lajur air berbeza-beza mengikut apertur muncung, terdapat 100 ~ 30 μm pelbagai spesifikasi. Menggunakan prinsip pantulan total antara lajur air dan antara muka udara, laser akan disebarkan sepanjang arah perjalanan lajur air selepas dimasukkan ke dalam lajur air. Ia boleh diproses dalam julat tiang air yang stabil, dan jarak kerja berkesan yang terlalu lama amat sesuai untuk pemotongan bahan tebal. Apabila pemotongan laser tradisional, pengumpulan dan pengaliran tenaga adalah punca utama kerosakan haba pada kedua-dua belah laluan pemotongan, dan laser berpandukan air dengan cepat akan menghilangkan haba baki setiap nadi kerana peranan lajur air. , dan tidak akan terkumpul pada bahan kerja, jadi laluan pemotongan adalah bersih. Berdasarkan kelebihan ini, dalam teori pemotongan laser silikon karbida berpandukan air adalah pilihan yang baik, tetapi teknologinya sukar, kematangan peralatan yang berkaitan tidak tinggi, sebagai bahagian memakai muncung dengan kesukaran pengeluaran yang besar, jika anda tidak boleh dengan tepat dan stabil mengawal lajur air kecil, percikan titisan air ablasi cip, menjejaskan hasil. Oleh itu, proses itu belum lagi digunakan untuk pengeluaran wafer silikon karbida.
Fountyl Technologies PTE Ltd mengkhususkan diri dalam chuck vakum seramik, menyediakan lekapan seramik terbaik untuk proses pemotongan SIC, pelbagai chuck dalam 2/3/6/8/12/14 inci.












