Wiązanie wiórów: Proces umieszczania chipa na podłożu
Proces pakowania to ostatni etap produkcji półprzewodników, a jego sekwencja obejmuje szlifowanie, cięcie, montaż, okablowanie i formowanie. Kolejność tych procesów może zmieniać się w zależności od zmian w technologii pakowania, a także mogą być ze sobą ściśle powiązane lub łączone. W tym artykule skupiono się na łączeniu płytek, czyli technice kapsułkowania stosowanej do łączenia chipa oddzielonego od płytki z podłożem kapsułkowania (ramą wyprowadzeniową lub płytką drukowaną) po procesie cięcia.

1.Co to jest wiązanie?
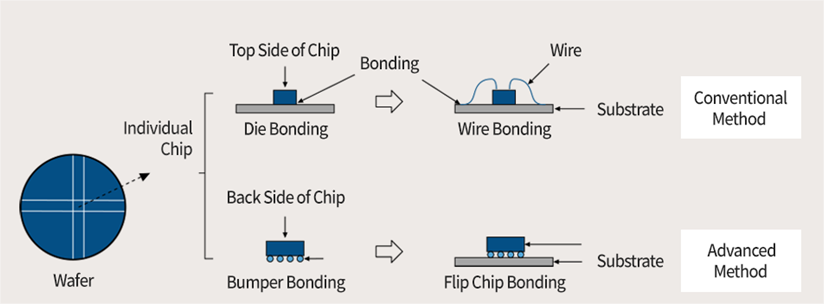
W procesie półprzewodnikowym „wiązanie” odnosi się do połączenia chipa waflowego z podłożem. Klejenie można podzielić na dwa rodzaje, a mianowicie metodę tradycyjną i metodę zaawansowaną. Tradycyjne metody obejmują połączenia chipowe (lub połączenia chipowe) i połączenia przewodowe, podczas gdy metody zaawansowane obejmują połączenia typu flip chip opracowane przez IBM pod koniec lat sześćdziesiątych. Flip chip bonding to metoda, która łączy łączenie matrycowe i łączenie drutowe oraz łączy chip z podłożem poprzez utworzenie wypukłości na wkładce wiórowej.
2. Proces klejenia
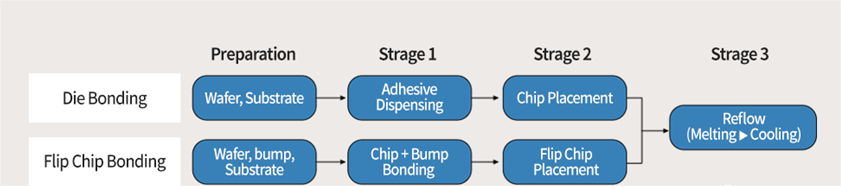
W przypadku klejenia wiórów pierwszą rzeczą do zrobienia jest nałożenie kleju na podłoże opakowania. Następnie połóż na nim chip, pinem do góry. Zamiast tego, w przypadku bardziej zaawansowanej metody łączenia typu flip chip, do wyściółki chipa mocowane są małe guzki zwane kulkami lutowniczymi. Następnie chip umieszcza się na podłożu stroną z szpilką skierowaną w dół. W obu metodach zmontowana jednostka przechodzi przez kanał powrotu temperatury, który z czasem można regulować w celu stopienia kleju lub kulki lutowniczej. Następnie chłodzi się go, aby przymocować chip (lub guzek) do podłoża.
3. Pick & Place żetonów
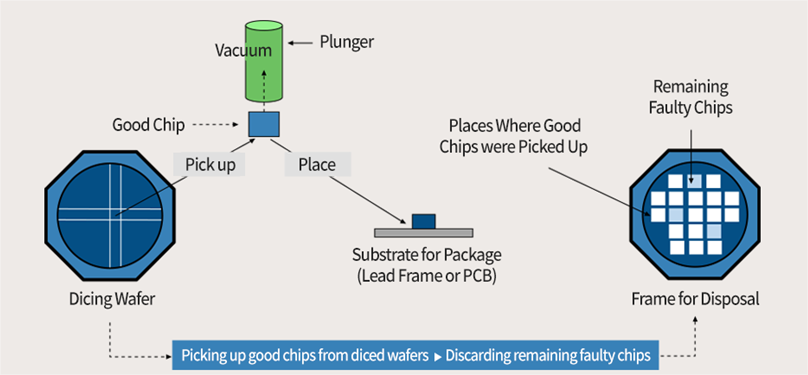
Indywidualne usuwanie chipa przymocowanego do taśmy nazywa się „Pick”. Kiedy dobre wiórki zostaną usunięte z wafla za pomocą tłoczka, umieszczenie ich na powierzchni podłoża opakowania nazywa się „Umieszczeniem”. Te dwa zadania, zwane „Pick & Place”, są wykonywane na Die Bonde.
4. Wyrzut wiórów
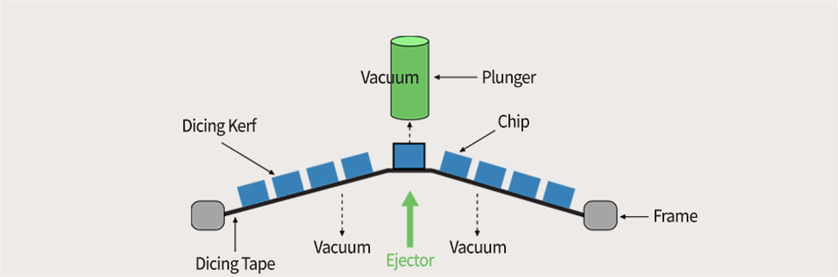
Użyj metody łatwej do wyciągnięcia chipa: „wyrzutu”. Wyrzutnik służy do przykładania sił fizycznych do docelowego chipa, co powoduje, że różni się on nieznacznie wielkością kroku od innych chipów. Po wyrzuceniu wióra od dołu, należy wyciągnąć wiór od góry za pomocą tłoczka z taśmą podciśnieniową. Jednocześnie odciągnij dolną część taśmy za pomocą odkurzacza, aby powierzchnia taśmy była gładka.
5. Wióry są łączone żywicą epoksydową
Podczas klejenia chipa połączenie wykonuje się za pomocą lutowia lub pasty zawierającej metal (Power Tr), ale do łączenia chipów można również zastosować polimer (poliimid). W materiałach polimerowych pasty lub płynne żywice epoksydowe zawierające srebro są stosunkowo łatwe w użyciu i mają dużą częstotliwość stosowania.
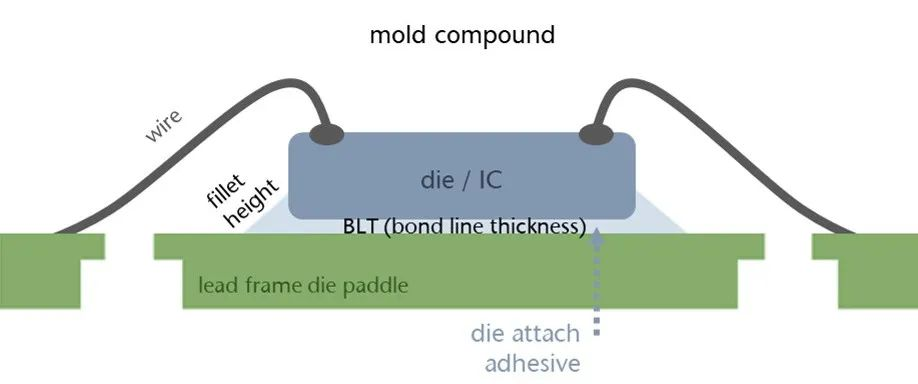
6. Do spajania wiórów zastosowano powlekanie matrycowe (DAF).
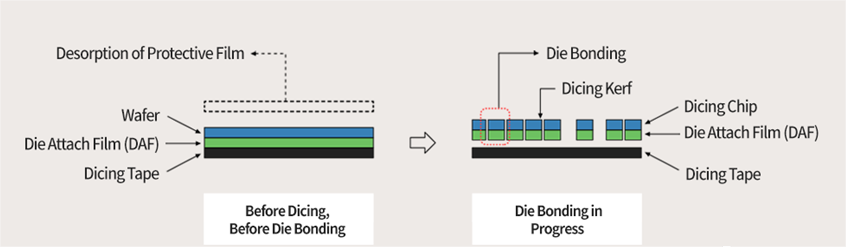
DAF to cienka folia przymocowana do spodu chipa. Grubość DAF można dostosować do bardzo cienkiej i stałej grubości. Jest szeroko stosowany nie tylko w łączeniu chipa z podłożem, ale także w łączeniu chipa z chipem w celu tworzenia pakietów wielochipowych (MCP). Ze struktury chipa wynika, że DAF na dole chipa jest przyklejony do chipa, a taśma do krojenia jest przyklejona do DAF pod nim, a przyczepność jest słaba. W celu wykonania sklejenia wiórów w tej strukturze, po usunięciu wióra i DAF z taśmy, chip umieszcza się bezpośrednio na podłożu bez użycia żywicy epoksydowej
Fountyl Technologies PTE Ltd koncentruje się na przemyśle produkcji półprzewodników, a główne produkty to: uchwyt kołkowy, porowaty uchwyt ceramiczny, ceramiczny efektor końcowy, ceramiczna belka kwadratowa, wrzeciono ceramiczne, zapraszamy do kontaktu i negocjacji!











