Kontrola przepływu w litografii zanurzeniowej
Od ponad dziesięciu lat litografia zanurzeniowa jest główną technologią naświetlania w produkcji półprzewodników. W porównaniu z tradycyjnymi metodami suchej litografii, technika ta znacznie poprawia rozdzielczość naświetlania poprzez wstrzyknięcie cieczy o wysokim współczynniku załamania światła w szczelinę pomiędzy soczewką a powierzchnią płytki. Utrzymanie czystości i jednorodności zanurzonej cieczy oraz uniknięcie tworzenia się kropel resztkowych w procesie szybkiego skanowania to dwa główne wyzwania stojące przed rozwojem technologii litografii zanurzeniowej. Zanieczyszczenia, cząstki, pęcherzyki, ogrzewanie i naprężenia w cieczy mogą zakłócać ciągłość współczynnika załamania światła. Szybki ruch płytki podczas skanowania może zdestabilizować menisk na styku cieczy i otaczającego gazu, powodując pozostawienie kropelek na płytce. Powyższe zjawiska będą miały wpływ na wydajność naświetlania litografii zanurzeniowej, a do rozwiązania problemu potrzebna jest odpowiednia metoda kontroli zachowania przepływu.
1, Wpływ kontroli zachowania przepływu na czystość i jednorodność cieczy
1.1.Wpływ zachowania przepływu na czystość i jednorodność cieczy
1.1.1.Cząsteczki i zanieczyszczenia
Cząsteczki i zanieczyszczenia są głównym źródłem zanieczyszczeń stałych w zanurzonych cieczach. Cząstki zawieszone w zanurzonej cieczy w pobliżu powierzchni płytki lub na wierzchu fotomaski można obrazować w leżącej pod spodem fotomasce lub przenosić do fotomaski podczas wywoływania.
Cząsteczki mogą znajdować się w dostarczanej cieczy lub mogą pochodzić z dowolnej powierzchni, której dotyka ciecz. Po pierwsze, ciecz używana do zanurzenia nieuchronnie zawiera cząstki i zanieczyszczenia, dlatego jako roztwór zanurzeniowy stosuje się wodę dejonizowaną w pomieszczeniu czystym, która jest poddawana dalszej obróbce i filtrowaniu przed wstrzyknięciem do głowicy zanurzeniowej. Innym problemem związanym z cząsteczkami jest złuszczanie się folii wokół skosu płytki, spowodowane niewystarczającą przyczepnością pomiędzy powierzchnią skosu a powłoką powierzchniową. Podczas naświetlania cząstki te mogą być transportowane tam i z powrotem przez menisk cieczy od krawędzi wafla do środka wafla. Metody rozwiązania tego problemu obejmują wybór fotomaski, optymalizację receptury EBR i obróbkę płytek. Potencjalnym źródłem cząstek są także poduszki waflowe. Gdy zanurzona głowica porusza się po płytce, zanurzona głowica zbiera cząstki i ponownie je osadza. Konwencjonalne czyszczenie stołu waflowego zmniejszy liczbę cząstek, a technologia czyszczenia na miejscu okazała się bardzo skuteczną metodą czyszczenia w terenie. Inne defekty spowodowane przez cząstki przezroczystej fotorezystu/powłoki nawierzchniowej osadzone na powierzchni folii fotomaski lub powłoki nawierzchniowej (jako defekty zapobiegające powstawaniu pęcherzyków) można zredukować poprzez optymalizację receptury powłoki.
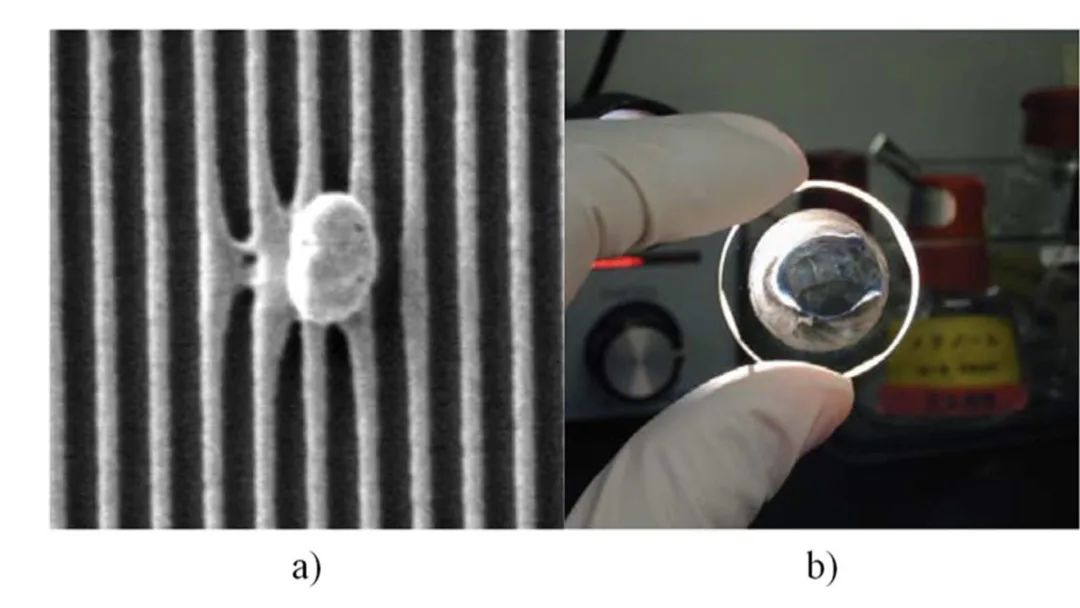
Skutecznym sposobem rozwiązania problemu wymywania jest zastosowanie małej szybkości wymywania warstwy maskującej lub górnej warstwy barierowej. Zbadano także płukanie folii ochronnych wodą dejonizowaną jako alternatywę dla problemu wymywania. Ponadto powierzchnia zanurzonej głowicy jest większa niż powierzchnia pola naświetlania, co oznacza, że płytka jest moczona przed i po naświetlaniu, podobnie jak w procesie płukania [38]. Ponieważ ciecz w dalszym ciągu przepływa przez zanurzoną głowicę podczas ekspozycji i zanurzenia, zanieczyszczenia w zanurzonej cieczy zostaną w znacznym stopniu usunięte, co może zastąpić proces płukania.
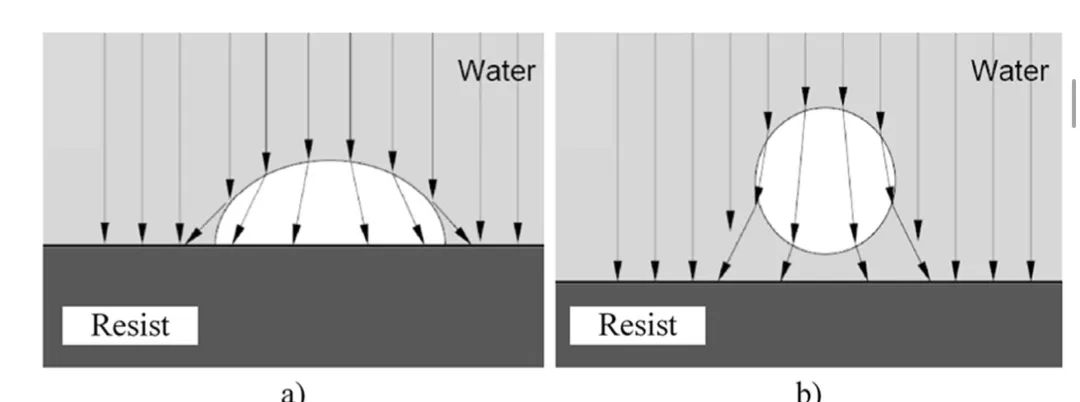
Bąbelki odbijają i załamują wpadające światło. a) na powierzchni fotomaski oraz b) unosząc się w zanurzonym roztworze.
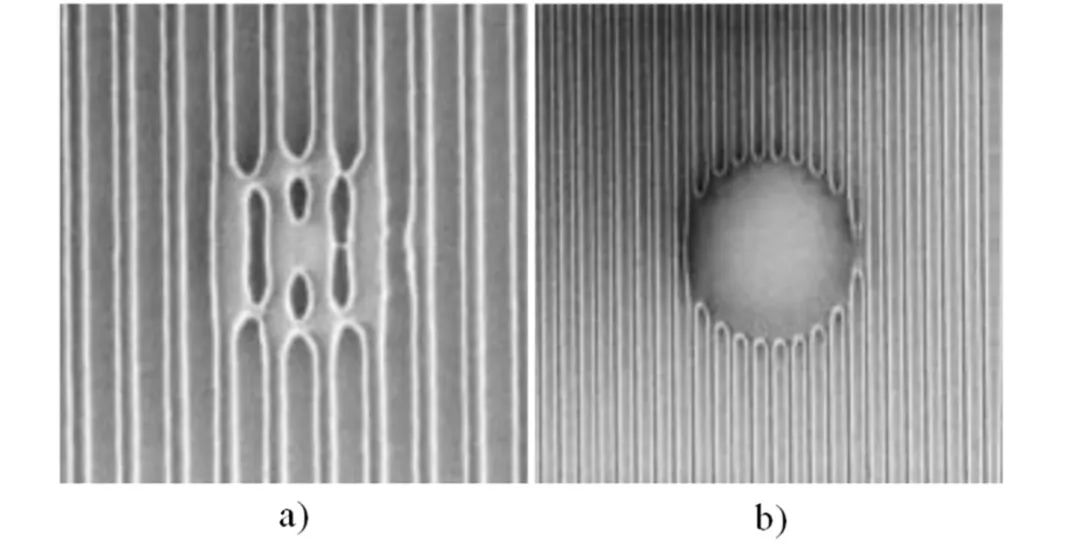
Wady pęcherzyków o różnych rozmiarach. a) 0,85 μm, b) 3 μm.
1.1.2.Buble
Jednym z głównych wyzwań związanych z litografią zanurzeniową z pęcherzykami jest wymóg, aby podczas naświetlania w roztworze zanurzeniowym nie pojawiały się żadne pęcherzyki. Zakrzywiona granica faz gaz-ciecz spowodowana przez pęcherzyki odbija i załamuje padające światło, co powoduje nieciągłości współczynnika załamania światła i zwiększa efekty rozproszenia, co ostatecznie skutkuje defektami wzoru i zmniejszoną wydajnością.
Głównymi czynnikami wpływającymi na działanie bąbelków są czas ekspozycji, rozmiar bąbelków i wysokość bąbelków nad płytką, przy czym krótsze czasy ekspozycji wzmacniają efekt bąbelków, powodując, że elementy pozostają w mocniej zacienionym obszarze przez dłuższy czas ekspozycji . Po drugie, jeśli bąbelek ma ten sam rozmiar co długość fali światła użytego do naświetlenia, światło rozprasza się i zwiększa ilość światła rozproszonego. Jeśli rozmiar pęcherzyka wynosi mikrometry lub więcej, pęcherzyk będzie częściowo blokował i zmieniał kierunek światła. Wreszcie badanie wykazało również, że ogólny wpływ bąbelków na obraz zależy od odległości bąbelków od powierzchni płytki – im większa odległość, tym słabszy efekt, ponieważ bąbelki z fotomaski można szybko wypłukać szybko poruszający się płyn. Jeżeli stosunek odległości pęcherzyka od płytki do średnicy pęcherzyka wynosi 4:10, wpływ pojedynczego pływającego pęcherzyka jest znikomy. W miarę jak pęcherzyk zbliża się do płytki, ze względu na wolniejszy przepływ płynu w pobliżu powierzchni płytki, cień pęcherzyka w płaszczyźnie obrazu staje się silniejszy, a jego żywotność w określonym miejscu płytki wydłuża się. W rezultacie bąbelki przyczepione do powierzchni płytki stanowią znacznie większe zagrożenie dla pozbawionego defektów obrazu. W wyniku systematycznych badań efektu rozpraszania pęcherzyków w litografii zanurzeniowej przewiduje się, że maksymalny rozmiar pęcherzyków, który nie spowoduje defektów, gdy pęcherzyk zostanie przymocowany do powierzchni fotomaski, to 60 nm. Pęcherzyki w litografii zanurzeniowej mogą być spowodowane oddziaływaniem różnych czynników, takich jak ciśnienie, temperatura, reakcja fotochemiczna i dynamika płynów.
1.1.3.Ogrzewanie
Podczas naświetlania zanurzona ciecz nagrzewa się nierównomiernie, a rozkład temperatury może na wiele sposobów wpływać na obraz, wytwarzając jednocześnie niewielkie ilości aberracji sferycznych i wyższego rzędu, a główną wadą obrazowania jest rozmycie ostrości. Jeśli pozwolimy na rozogniskowanie tylko na poziomie 1 nanometra, zmiana współczynnika załamania światła musi być bardzo mała. Ponieważ współczynnik temperaturowy wody (dn/dτ=-10-4K-1) jest bardzo duży w porównaniu z gazem, temperaturę cieczy należy utrzymywać w granicach 10 mK, co nakłada rygorystyczne ograniczenia na systemy obsługi cieczy i kontroli temperatury.
1.1.4.Stres
W przypadku litografii zanurzeniowej wysoka lepkość i duża gęstość zanurzonej cieczy w porównaniu z powietrzem w litografii suchej może powodować znaczne naprężenia zarówno na powierzchni soczewki, jak i płytki. Te naprężenia normalne i ścinające mogą prowadzić do zniekształcenia soczewki i dwójłomności, zakłócając w ten sposób jednolitą ścieżkę światła.
1.2.Metody kontroli
Istnieją trzy sposoby ograniczenia powyższych zachowań wpływających na wydajność ekspozycji. Aby uniknąć zanieczyszczeń i pęcherzyków w procesie naświetlania,
W sekcji
1.2.1 stosuje się fotorezyst o niskim wymywaniu i niskim uwalnianiu gazu. Aby zapobiec odciskaniu się pęcherzyków i cząstek na waflu, należy zastosować pkt
1.2.2 opisuje konkretną metodę okablowania i metodę grubej powłoki. Wreszcie, aby zrównoważyć rozkład temperatury i naprężeń poprzez odprowadzanie zanieczyszczeń, cząstek, pęcherzyków i ciepła z obszaru narażenia,
Sekcja
1.2.3wykorzystuje metody dostarczania i odzyskiwania cieczy.
Nikon był pierwszą firmą na świecie, która opracowała skaner zanurzeniowy ArF do celów produkcyjnych – NSR-S609B [75]. Wcześniej podejmowano wiele prób konstrukcji głowicy zanurzonej w oparciu o metodę lokalnego wypełnienia. Symulowali metodę lokalnego napełniania z systemem dostarczania i odzyskiwania cieczy lub bez niego [54,67] i odkryli, że system dostarczania i odzyskiwania cieczy działał również jako konstrukcja zatrzymująca ciecz. W przypadku braku systemu zasilania i odzyskiwania część cieczy znajduje się poza obszarem soczewki, a pod nią znajduje się pusta przestrzeń. W obecności systemu zasilania i odzyskiwania przepływ odzysku wzmacnia napięcie powierzchniowe na granicy faz gaz-ciecz wokół wgłębienia na ciecz, skutecznie ograniczając ciecz do lokalnego obszaru pod soczewką, co zapewnia lepsze zatrzymanie cieczy.
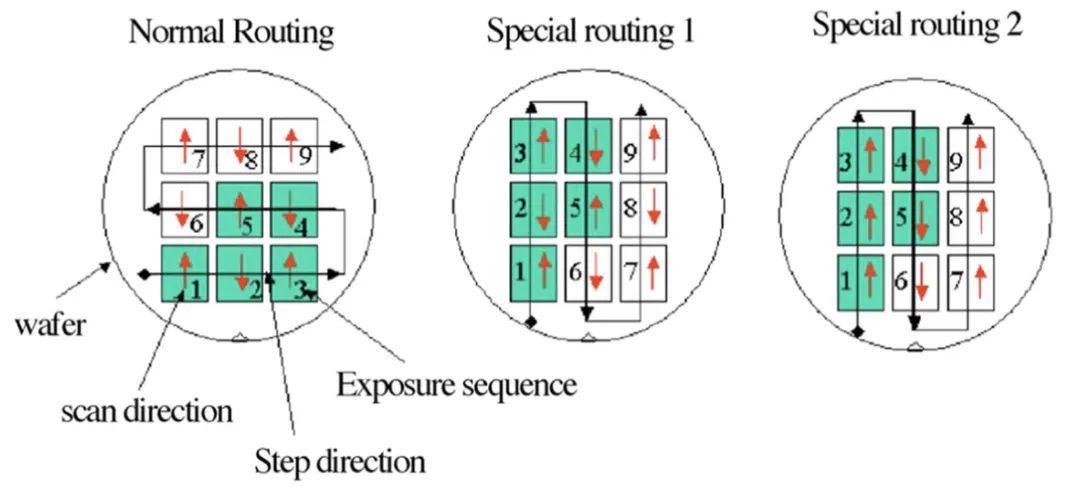
Normalne okablowanie i 2 specjalne okablowanie w celu zmniejszenia defektów
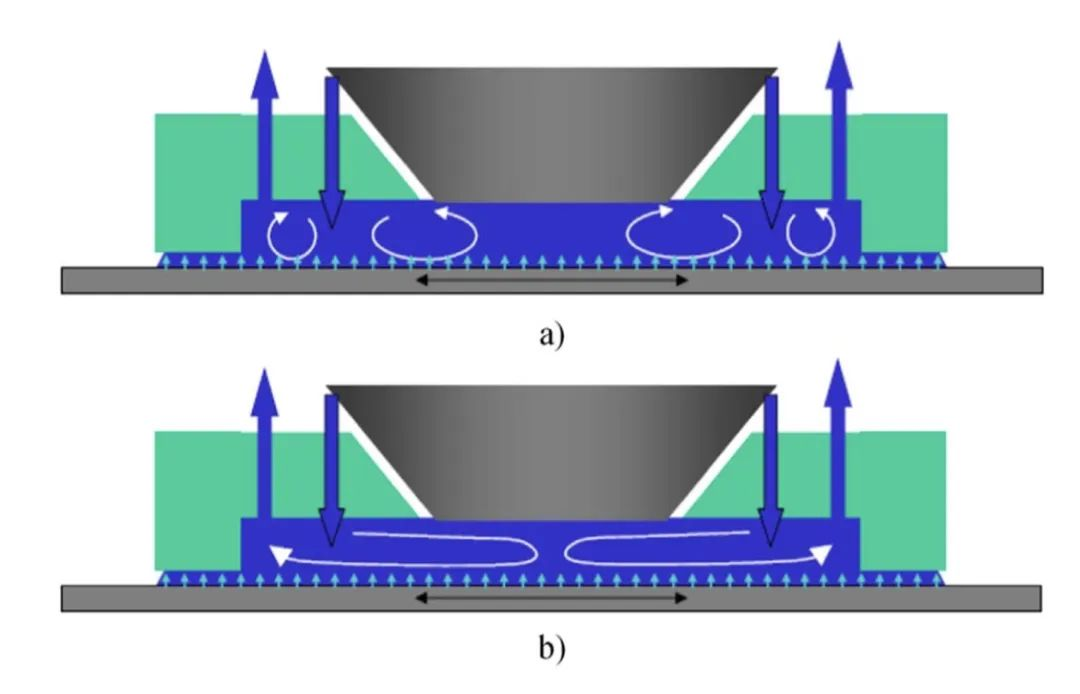
Dwa różne układy dysz. a) Dysza starszej generacji; b) Nowe dysze.
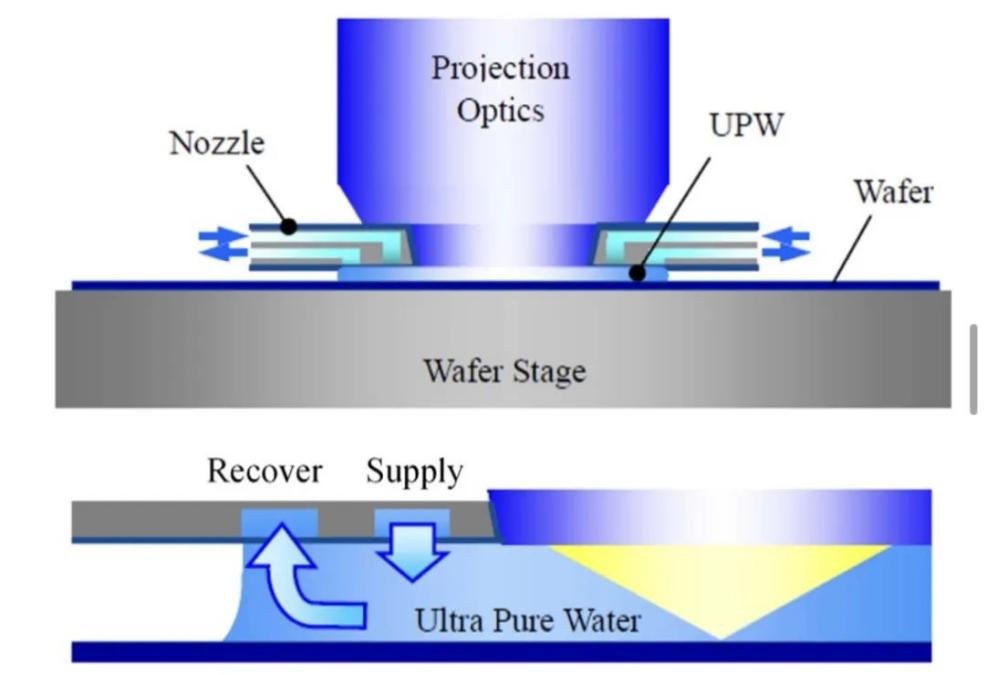
Podstawowa struktura systemu zanurzeniowego LLF.
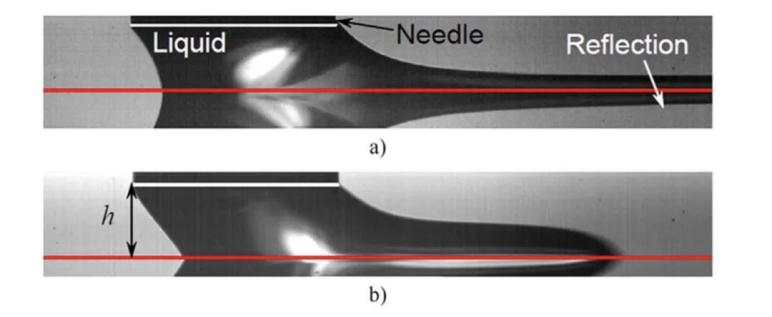
Typowy kształt menisku. A). Rozciąganie folii, b). Przepełnienie inercyjne.
2. Kontrola zachowania przepływu i stabilności menisku
2.1.Niestabilność menisku i kropelki resztkowe w litografii zanurzeniowej
Przez cały proces płyn musi pozostać w szczelinie pomiędzy ostatnią soczewką optyczną a płytką. Gdy płytka porusza się pod cieczą, siły lepkości zaczynają ciągnąć ciecz w kierunku skanowania i wpływają na menisk. Powyżej pewnej prędkości stabilność menisku cofającego zostaje zakłócona, a ciecz zostaje wyciągnięta ze swojej objętości i następnie rozbita na kropelki. Te resztkowe kropelki mogą pozostać na płytce i powodować liczne defekty obrazu. Obecnie w branży półprzewodników prędkość skanowania w produkcji masowej wynosi 800 mm/s, a w przyszłości będzie wyższa. Dlatego należy zadbać o to, aby menisk zanurzonego pola nie utracił stabilności w ramach wymaganej prędkości.
2.2Podstawowe badania stabilności menisku
Prędkość krytyczna odnosi się do maksymalnej prędkości, jaką można osiągnąć bez osadzania się resztek cieczy i jest bardzo ważnym parametrem wydajności w litografii zanurzeniowej. Wyniki eksperymentów „drag drop” na 41 różnych fotomaskach [80,87,88] wykazały, że prędkość krytyczna znacznie wzrasta wraz ze wzrostem statycznego kąta zwilżania recesyjnego, zarówno w stanie rozciągania folii, jak i w stanie bezwładnościowego przelewu .
2.3.Metody kontroli
Istnieją trzy sposoby ograniczenia pozostałości kropel na płytce. Aby poprawić stabilność menisku i uniknąć tworzenia się kropelek resztkowych podczas naświetlania, w litografii zanurzeniowej można zastosować bardziej hydrofobowy fotomaskę. Aby usunąć resztkowe kropelki, które właśnie opuściły menisk, stosuje się kurtynę powietrzną i medium porowate. Aby kontrolować natężenie przepływu cieczy w pobliżu kanału odzysku i ułatwić funkcję odzyskiwania, w zanurzonej głowicy można zastosować modyfikację powierzchni w oparciu o powierzchnie niejednorodne o kontraście zwilżalności.
2.3.1. Hydrofobowość zmodyfikowanej powierzchni kopuły kontroluje prędkość skanowania i naświetlania płytek. Wyższa hydrofobowość oznacza wyższy statyczny cofający się kąt zwilżania, co ułatwia i przyspiesza zanurzoną ciecz w przemieszczaniu się po płytce bez pozostawiania resztek kropelek. Wyższa hydrofobowość jest zatem kluczem do maksymalizacji wydajności, a w połączeniu z mniejszą liczbą defektów może również zwiększyć wydajność.
2.3.2.Druga metoda powstrzymywania cieczy
Innym sposobem kontrolowania stabilności menisku jest specjalna konstrukcja zanurzonej główki. Biorąc pod uwagę różne kąty zwilżania różnych powłok ochronnych i wykończeń oraz zanurzonej cieczy, konstrukcja głowicy zanurzonej musi być w stanie osiągnąć szeroki zakres roboczy przy dużych prędkościach skanowania. ASML podaje, że zastosowanie nowej głowicy zanurzeniowej znacznie zmniejsza całkowitą liczbę defektów (ponad 3x) przy prędkości skanowania wynoszącej 600 mm/s.
Najpopularniejszą optymalizacją głowic zanurzeniowych jest konstrukcja kurtyny powietrznej. Konstrukcja ta tworzy wysokociśnieniową kurtynę powietrzną wokół zanurzonego obszaru, utrzymując płyn w szczelinie poniżej ostatniego elementu optycznego.
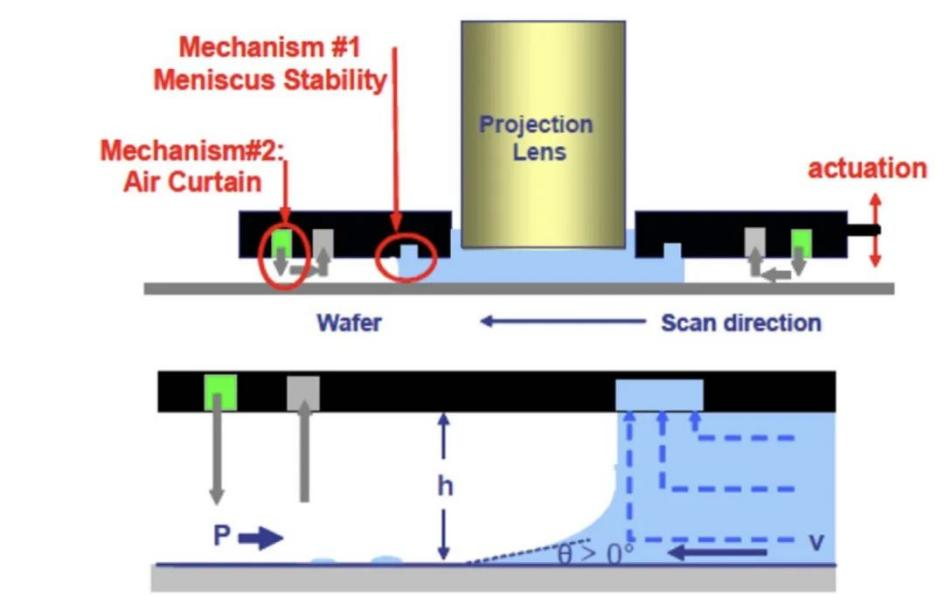
2.3.3.Modyfikacja powierzchni głowicy zanurzonej
Wszystkie powyższe modyfikacje powierzchni w celu kontroli stabilności menisku są stosowane w przypadku płytek i opierają się na jednorodnych powierzchniach, ale można również zastosować heterogeniczne powierzchnie z kontrastem zwilżalności, aby pomieścić ciecz w szczelinie. Biorąc pod uwagę, że rzeczywisty proces litografii może nie pozwalać na heterogeniczną modyfikację powierzchni maski, metodę tę można zastosować w przypadku głowicy zanurzonej.
Fountyl Technologies PTE Ltd koncentruje się na przemyśle produkcji półprzewodników, a główne produkty to: uchwyt kołkowy, porowaty uchwyt ceramiczny, ceramiczny efektor końcowy, ceramiczna belka kwadratowa, wrzeciono ceramiczne, zapraszamy do kontaktu i negocjacji!











