Tipos de corte de wafer de carboneto de silício
O carboneto de silício é um material muito duro e quebradiço (dureza Mohs 9,2), o que pode causar problemas de processamento. Isto é especialmente verdadeiro durante o processo de back-end, onde os wafers devem ser divididos em chips separados antes de serem embalados.
1, corte de lâmina de diamante
O corte mecânico com lâmina de diamante é uma técnica tradicional para separar wafers de SiC.
O wafer é montado em um filme azul e cortado por uma lâmina revestida de diamante que gira em alta velocidade. A largura da pista de corte está geralmente na faixa de 50 a 100 mícrons.
Devido à dureza do SiC, a velocidade de corte da lâmina é menor e a abrasão da lâmina de corte é maior, resultando em custos mais elevados. Além disso, o corte da lâmina pode causar fragmentação e delaminação das bordas dos cavacos. com o tamanho do wafer de carboneto de silício alterado de 4 polegadas para 6 polegadas de diâmetro, o comprimento cumulativo da pista mais que dobrou, além da capacidade de uma lâmina padrão de fazer todo o corte. Como resultado, a lâmina deve ser substituída enquanto o wafer ainda está na posição de trabalho e pode romper durante o processo de corte, danificando o wafer.
Por exemplo, um pedaço de wafer SiC de 100 mm (4 polegadas) precisa levar de 6 a 8 horas e é fácil causar quebra de borda. Portanto, este método tradicional de processamento ineficiente foi gradualmente substituído pela gravação a laser.
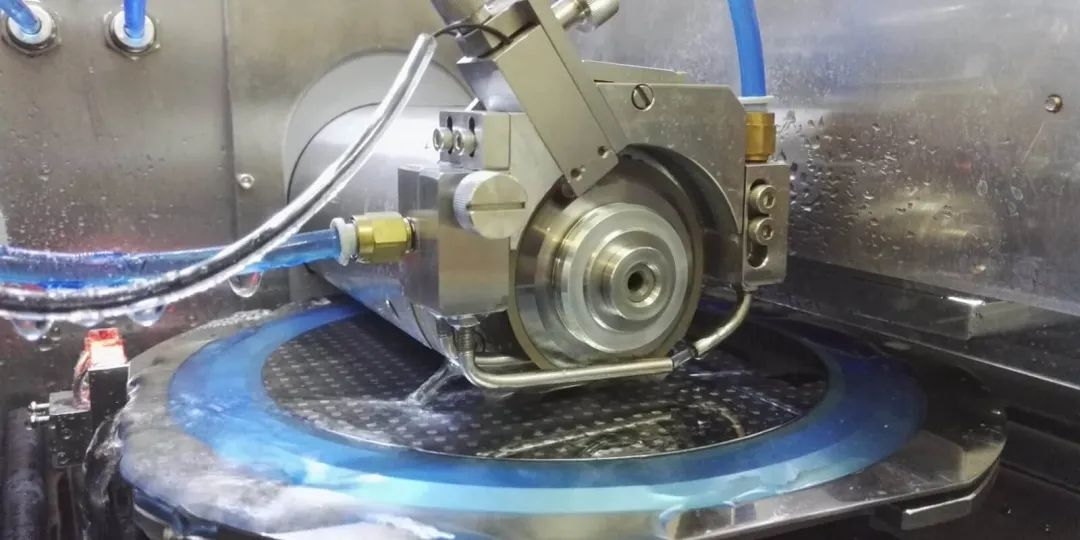
2, corte por ablação a laser
A ablação a laser é uma alternativa ao corte mecânico de wafer. O feixe de laser está focado na pista de corte. O material é aquecido pela energia do laser absorvida. Isso resulta em áreas significativamente afetadas pelo calor e microfissuras. A película azul também pode ser afetada pelo calor, o que pode afetar o processo de embalagem subsequente. Além disso, a taxa de ablação é muito baixa e precisa ser realizada diversas vezes para separar o chip. O número de repetições depende da espessura do wafer e da velocidade de corte. Para evitar resíduos de material no chip, a superfície do wafer deve ser revestida com uma camada protetora. As principais desvantagens desta tecnologia de corte são a baixa qualidade da aresta e a baixa produtividade.
No corte furtivo, um feixe de laser de comprimento de onda curto que passa através de um wafer de SiC é focado dentro do material. Ele cria uma camada de defeitos localizados dentro do material, que se torna o ponto de partida para a separação do wafer. Primeiro, o feixe de laser é focado na parte inferior do wafer e sobe camada por camada. Devido ao processo de divisão, não há remoção de material no trajeto de corte, resultando em incisão zero. Em segundo lugar, a separação final do chip deve ser realizada por um processo de emenda mecânica separado, bem como pela expansão do filme azul. Como o laser aquece o material dentro do wafer, não há danos térmicos na superfície do wafer. Defeitos no padrão do colar de pérolas com áreas sobrepostas só podem surgir no interior do material. Além disso, cada taxa de corte é de cerca de 200 mm/s, e em algumas aplicações pode chegar a 300 mm/s. Porém, dependendo da espessura do material, o laser precisa passar várias vezes antes de conseguir separar o chip. Isto resulta em danos nas paredes laterais do chip devido à camada alterada. Para focar o feixe de laser em pontos muito pequenos dentro do wafer, o feixe espalhado em uma superfície plana na pista de corte precisa ser suave e minimizado. Para evitar o reflexo do laser, é necessária uma pista metálica sem cortes. Outra desvantagem é que a largura necessária para abrir a pista é uma função da espessura do wafer (normalmente 40% da espessura do wafer), o que significa que para um wafer SiC padrão com espessura de 350 μm, a largura mínima necessária da pista de corte é de 140 μm.
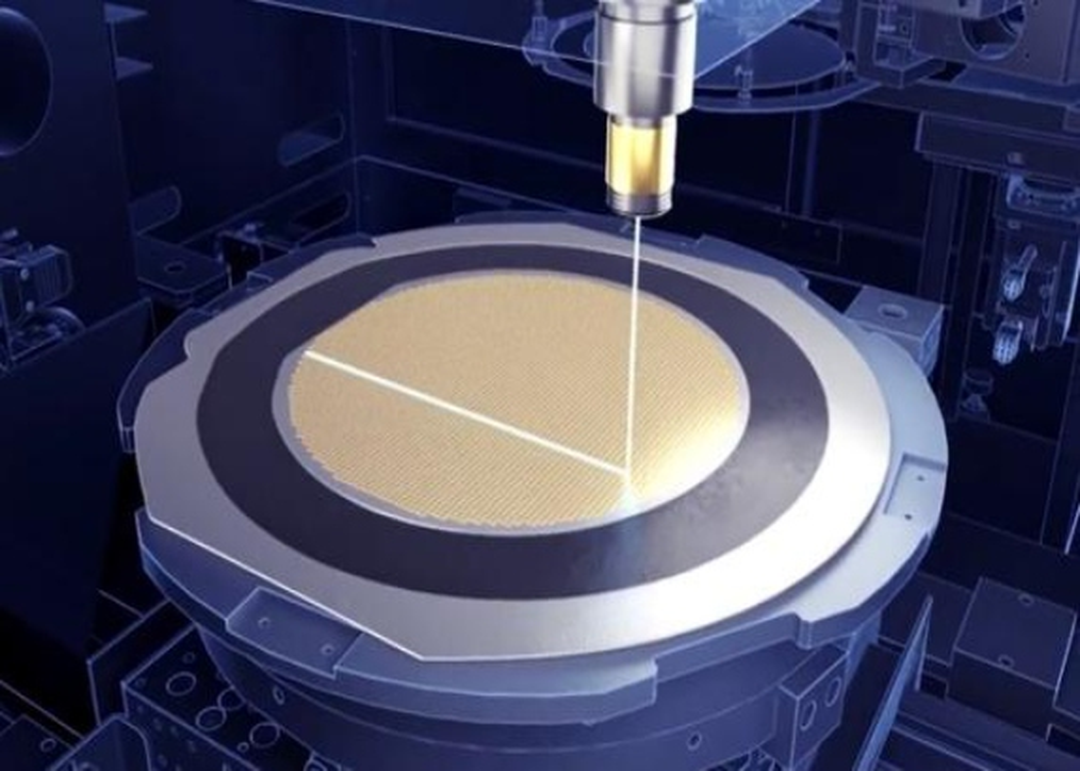
3, Corte TLS
Separação Térmica a Laser é uma alternativa rápida, limpa e econômica para a separação de wafers de carboneto de silício. O laser aquece o material e cria uma região de tensão de compressão cercada por um padrão de tensão de tração tangencial. Em seguida, uma quantidade muito pequena de spray de água deionizada é pulverizada, o que cria uma segunda zona resfriada próxima à primeira zona, causando um padrão de tensão de tração tangencial. A tensão de tração é criada na região onde os dois padrões de tensão se sobrepõem, o que abre e guia a ponta da trinca através de todo o material.
O corte TLS é um processo de etapa única que pode separar wafers de toda a espessura em velocidades de separação de até 300 mm/s. O ponto de partida é um arranhão superficial local ou contínuo na superfície do wafer. Como o corte TLS é um processo dividido, ele tem o potencial de reduzir a largura da pista de corte e aumentar o número de cavacos em cada wafer. A borda do cavaco é lisa, sem tensões residuais ou microfissuras e zonas de fragmentação. A estrutura metálica (PCM) na pista frontal e a poliimida no chip são aceitáveis. Além disso, como a separação é derivada do lóbulo e não da subsequente separação/fratura física, o metal de suporte pode ser separado sem delaminação ou sem ser afetado pelo calor. A análise de rendimento usando o processo de corte TLS em um wafer de dispositivo de potência típico com parte traseira totalmente metalizada mostra que o rendimento médio de poliimida e estruturas metálicas na pista de corte excede 98%.
4,Gravação a laser guiada por água
O laser guia de água serve para focar o laser na microcoluna de água, o diâmetro da coluna de água varia de acordo com a abertura do bico, existem várias especificações de 100 ~ 30 μm. Usando o princípio da reflexão total entre a coluna d'água e a interface do ar, o laser será propagado ao longo da direção do deslocamento da coluna d'água após ser introduzido na coluna d'água. Pode ser processado dentro da faixa estável da coluna de água, e a distância efetiva de trabalho muito longa é especialmente adequada para o corte de materiais espessos. No corte a laser tradicional, o acúmulo e a condução de energia são a principal causa de danos térmicos em ambos os lados do caminho de corte, e o laser guiado por água removerá rapidamente o calor residual de cada pulso devido ao papel da coluna de água , e não se acumulará na peça de trabalho, portanto o caminho de corte estará limpo. Com base nessas vantagens, em teoria o corte a laser guiado por água de carboneto de silício é uma boa escolha, mas a tecnologia é difícil, a maturidade do equipamento relevante não é alta, pois uma parte desgastada do bico com grande dificuldade de produção, se não puder controlar com precisão e estabilidade a pequena coluna de água, respingos de gotas de água ablacionam o chip, afetando o rendimento. Portanto, o processo ainda não foi aplicado à produção de pastilhas de carboneto de silício.
Fountyl Technologies PTE Ltd é especializada em mandril a vácuo de cerâmica, fornece o melhor acessório de cerâmica para processo de corte SIC, vários mandris em 2/3/6/8/12/14 polegadas.












