กล้องจุลทรรศน์แสงคอนโฟคอล
เลเซอร์จะโฟกัสไปที่แผ่นเวเฟอร์ ส่องสว่างจุดแสง และแสงที่สะท้อนจะถูกปรับโฟกัสไปที่ระนาบรับ และจากการวิเคราะห์แสง พื้นผิวของเวเฟอร์ซิลิคอนจะถูกตรวจจับ กล้องจุลทรรศน์เป็นระบบที่แสงเลเซอร์โฟกัสไปที่ชิปซิลิคอน และแสงสะท้อนได้รับการออกแบบให้โฟกัสโดยใช้เครื่องรับ กล่าวอีกนัยหนึ่ง ข้อมูลพร่ามัวจะไม่ผ่านระนาบการรับ ดังนั้นจึงสามารถได้ภาพที่มีความละเอียดสูงและคอนทราสต์สูง
แน่นอนว่าความละเอียดของกล้องจุลทรรศน์แบบใช้แสงนั้นมีจำกัด และยังมีอุปกรณ์สำหรับตรวจสอบโดยใช้ SEM อีกด้วย
อุปกรณ์ทดสอบอนุภาค
อนุภาคบนชิปซิลิคอนจะทำให้ผลผลิตลดลงโดยตรง ตัวอย่างเช่น ใน LSI ขั้นสูง ขนาดสายไฟ LSI คือหลายสิบนาโนเมตร หากมีอนุภาคบนพื้นผิวของฟิล์มโกสต์เมื่อสร้างสายไฟจะทำลายลวดลายได้ง่ายจึงจำเป็นต้องควบคุมอนุภาคบนพื้นผิวอย่างเคร่งครัด
อุปกรณ์ตรวจสอบอัตโนมัติที่มีความสามารถในการโหลดและขนถ่ายเวเฟอร์เป็นอุปกรณ์ที่พบบ่อยที่สุด ตำแหน่งของอนุภาคจะแสดงเป็นรูปภาพทันที
อุปกรณ์ตรวจจับข้อบกพร่องพร้อมแผ่นเวเฟอร์ที่มีลวดลาย
รูปแบบ อนุภาค และข้อบกพร่องบนพื้นผิวของเวเฟอร์ที่มีลวดลายมีข้อกำหนดสูงสำหรับอัตราส่วน S/N และความละเอียด
แม้ว่าวิธีการตรวจสอบพื้นผิวด้วยเวเฟอร์ที่มีลวดลายจะใช้วิธีการกระเจิงแสงเช่นกัน แต่วิธีคอนทราสต์ของรูปแบบก็เป็นเทคโนโลยีกระแสหลัก ในวิธีนี้ แผ่นเวเฟอร์จะส่องสว่างด้วยแสงไฟ รูปภาพจะถูกพิมพ์ลงบนพื้นผิวการตรวจสอบ และสัญญาณภาพที่ได้รับจะถูกป้อนเข้าสู่คอมพิวเตอร์ และข้อบกพร่องจะถูกตรวจสอบโดยการเปรียบเทียบสัญญาณภาพที่มีรูปแบบเดียวกัน ด้วยวิธีนี้ จึงสามารถกำจัดผลกระทบของรูปแบบพื้นฐานและรูปร่างที่ไม่สม่ำเสมอได้
SEM สำหรับการสังเกตเวเฟอร์
SEM ย่อมาจาก Scanning Electron Microscope SEM ส่วนใหญ่จะอยู่ในตำแหน่งที่เป็นอุปกรณ์สังเกตการณ์ การมีอยู่ของ SEM เป็นสิ่งที่ขาดไม่ได้ในการส่งเสริมการปรับแต่งกระบวนการส่วนหน้า SEM สามารถสังเกตผลลัพธ์ของกระบวนการและปรับปรุงเงื่อนไขของกระบวนการได้ SEM ยังขาดไม่ได้ในฐานะผู้ตรวจสอบกระบวนการในฟิลด์ fabs การเชื่อมต่อระหว่างทั้งสองอยู่ใกล้กันมากจนการปรับแต่งเซมิคอนดักเตอร์ช่วยส่งเสริม SEM ที่มีความละเอียดสูง
ซีดีไม่มี
วิธีที่เร็วที่สุดในการตรวจสอบผลลัพธ์การพิมพ์หินคือ CD-SEM รูปแบบความละเอียดสำหรับการตรวจสอบความต้านทานแสงทั้งกลางวันและกลางคืน แน่นอนว่านี่คือการตรวจสอบแบบไม่ทำลาย
การตรวจสอบความละเอียดของการต้านทานถือเป็นการตรวจสอบออนไลน์ที่สำคัญ ในกระบวนการนี้ CD SEM ถือเป็นสิ่งสำคัญ แม้ว่าปัจจุบัน SEM จะเป็นวิธีการกระแสหลัก แต่ในขั้นต้นเนื่องจากขนาดของรูปแบบไม่เล็กนัก จึงใช้วิธีการตรวจติดตามด้วยกล้องจุลทรรศน์แบบใช้แสง เมื่อขนาดการออกแบบใกล้กับ 1μm เป็นไปไม่ได้ที่จะวัดรูปแบบการต้านทานด้วยความละเอียดของกล้องจุลทรรศน์แบบออปติคอล ดังนั้นวิธี SEM จึงเกิดขึ้น นอกจากนี้ SEM ยังมีทางยาวโฟกัสประมาณ 1,000 เท่าของกล้องจุลทรรศน์แบบใช้แสง โดยมีความสามารถในการวัดความยาวที่ด้านบนและด้านล่างของรูปแบบความต้านทาน
อุปกรณ์วัดโอเวอร์เลย์ที่จำเป็นสำหรับการพิมพ์หินด้วยแสง
ความละเอียดเป็นสิ่งสำคัญในการพิมพ์หิน และความถูกต้องของโอเวอร์เลย์ก็มีความสำคัญไม่แพ้กัน เนื่องจากกระบวนการเซมิคอนดักเตอร์ใช้มาสก์หลายสิบตัวเพื่อสร้างลวดลายเป็นชั้น
การทับซ้อนกันได้รับการตรวจสอบโดยการตรวจสอบช่องว่างการทับซ้อนระหว่างเครื่องหมายที่ขึ้นรูปไว้ล่วงหน้าบนวงกลมผลิตภัณฑ์และเครื่องหมายบนมาส์กเลนส์ แท็กเหล่านี้เรียกว่า Ber in Bar และ Box in Box และแท็กเหล่านี้มีขนาดประมาณ 20um เครื่องหมายหรือมาส์กเหล่านี้อยู่ที่มุมทั้งสี่ของกระจกวางแต่ละอัน การวัดกระจกรับแสงหลายชั้นจะดำเนินการบนเวเฟอร์ และข้อมูลจะได้รับการประมวลผลทางสถิติและป้อนกลับไปยังอุปกรณ์รับแสง
อุปกรณ์วัดความหนาของฟิล์ม
วิธีการกำหนดความหนาของฟิล์มสำหรับกระบวนการเซมิคอนดักเตอร์มีประมาณสามประเภท
1 การวัดการสัมผัสทางกายภาพ
2 การวัดด้วยแสง
3 การตรวจเอ็กซ์เรย์
วิธีที่พบบ่อยที่สุดคือการวัดด้วยแสง ซึ่งเป็นวิธีการวัดแบบไม่ทำลายและไม่สัมผัส
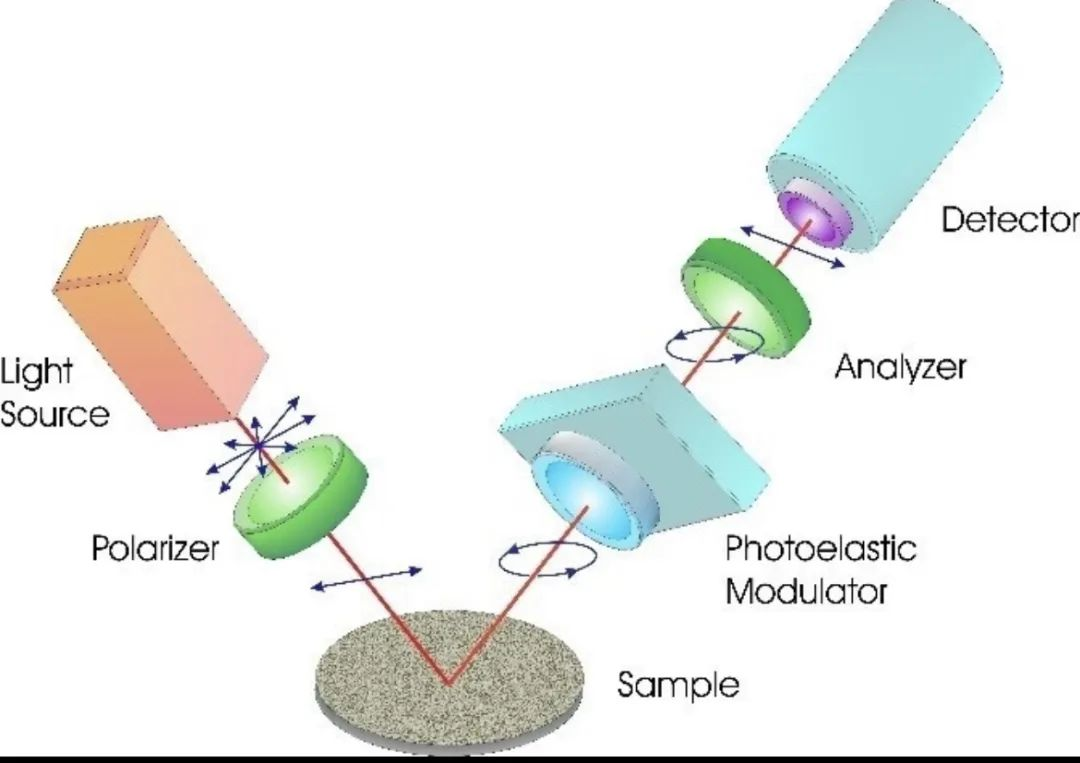
อุปกรณ์วัดอื่นๆ
แนวโน้มของกล้องจุลทรรศน์
เนื่องจาก SEM ไม่เหมาะสำหรับการสังเกตพื้นผิวสี่นูน กล้องจุลทรรศน์แบบโพรบ เช่น กล้องจุลทรรศน์แบบอุโมงค์สแกน (STM) หรือกล้องจุลทรรศน์แรงอะตอม (APM) จึงมีการใช้กันอย่างแพร่หลายเช่นกัน อุปกรณ์เหล่านี้จะสแกนพื้นผิวโดยการติดตามด้วยคานยื่น และตรวจสอบกระแสของอุโมงค์และแรงอะตอมที่ส่วนปลายเพื่อวัดรูปร่างนูนสี่นูนอันละเอียดอ่อนของพื้นผิว อุปกรณ์เหล่านี้มีความละเอียดสูงแต่มีพื้นที่การวัดน้อย
อุปกรณ์วัดอื่นๆ ที่จำเป็นในกระบวนการ ได้แก่ อุปกรณ์วัดความต้านทานและอุปกรณ์วัดความเรียบ แบบแรกจะตรวจสอบค่าความต้านทานหลังการฉีดไอออนและการบำบัดความร้อน เพื่อตรวจสอบและควบคุมผลการใช้สารต้องห้าม ส่วนหลังจะวัดความเรียบหลัง CMP
เขามี
อาจต้องใช้กล้องจุลทรรศน์อิเล็กตรอนแบบส่องผ่าน (TEM) เพื่อสังเกตชิ้นส่วนที่ชำรุดโดยตรง FIB เป็นเครื่องมือที่ทรงพลังมากในการเตรียมตัวอย่างเชิงสังเกตการณ์เหล่านี้ TEM ย่อมาจาก Transparent Eleetron Mieroscope (กล้องจุลทรรศน์อิเล็กตรอนแบบส่งผ่าน)
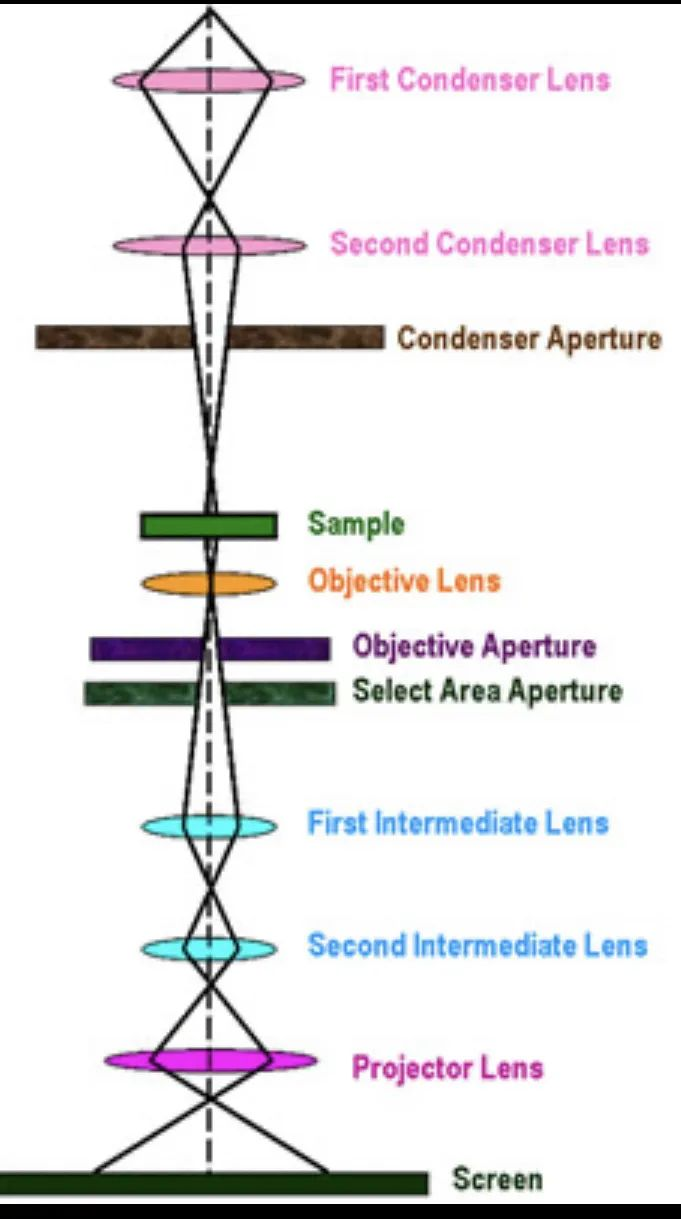
ปรับปรุงผลผลิตด้วยอุปกรณ์ทดสอบ
ผลลัพธ์ของการตรวจติดตาม/การวัดหลังกระบวนการจะถูกป้อนกลับไปยังแต่ละกระบวนการ และกลไกป้อนกลับนี้จะช่วยรักษาคุณภาพของกระบวนการให้คงที่ นอกจากนี้ ผลการตรวจสอบที่เกี่ยวข้องกับอนุภาคจะถูกส่งกลับไปยังห้องปลอดเชื้อ เพื่อช่วยจัดการและบำรุงรักษาอุปกรณ์การผลิตได้ดียิ่งขึ้น
เปรียบเทียบการใช้ FMB
FBM ย่อมาจาก Fail Bit Map หลังจากเสร็จสิ้นกระบวนการเวเฟอร์หรือถอดเวเฟอร์ตรงกลางออก รูปแบบการแสดงผลของพื้นที่ที่ตัดสินว่ามีข้อบกพร่องจะถูกวัดโดยอุปกรณ์ตรวจจับ และสามารถเปรียบเทียบแผนผังข้อบกพร่องของอุปกรณ์ตรวจสอบข้อบกพร่องของเวเฟอร์ที่มีลวดลายเพื่อพิจารณาว่าข้อบกพร่องใดที่ร้ายแรง ข้อบกพร่อง
นอกจากการวิเคราะห์ข้อบกพร่องหลังจากเสร็จสิ้นกระบวนการเวเฟอร์แล้ว วิธีการนี้ยังใช้สำหรับการตรวจสอบกระบวนการแบบเรียลไทม์อีกด้วย ในสถานการณ์การใช้งานนี้ ความสามารถในการวิเคราะห์ข้อบกพร่องที่เพิ่งค้นพบอย่างรวดเร็วเป็นสิ่งสำคัญ เนื่องจากสามารถช่วยให้เราระบุได้ตั้งแต่เนิ่นๆ ว่าข้อบกพร่องจะถึงแก่ชีวิตหรือไม่ และย้อนกลับไปยังกลไกการจัดการกระบวนการ
Fountyl Technologies PTE Ltd มุ่งเน้นไปที่อุตสาหกรรมการผลิตเซมิคอนดักเตอร์ ผลิตภัณฑ์หลัก ได้แก่: Pin chuck, หัวจับเซรามิกที่มีรูพรุน, เอฟเฟกต์ปลายเซรามิก, คานสี่เหลี่ยมเซรามิก, แกนหมุนเซรามิก ยินดีต้อนรับสู่การติดต่อและการเจรจา!











