Các phương pháp ghi chép wafer là gì?
Cắt wafer (cắt) đề cập đến quá trình cắt một wafer thành nhiều chip độc lập ("khuôn"). Quá trình này được thực hiện sau khi tất cả các quy trình sản xuất chất bán dẫn đã được hoàn thành trên tấm bán dẫn để đóng gói và thử nghiệm tiếp theo. Có nhiều cách cắt lát và hôm nay chúng tôi sẽ giới thiệu một cách có hệ thống.
Tại sao lại có quy trình viết nguệch ngoạc?
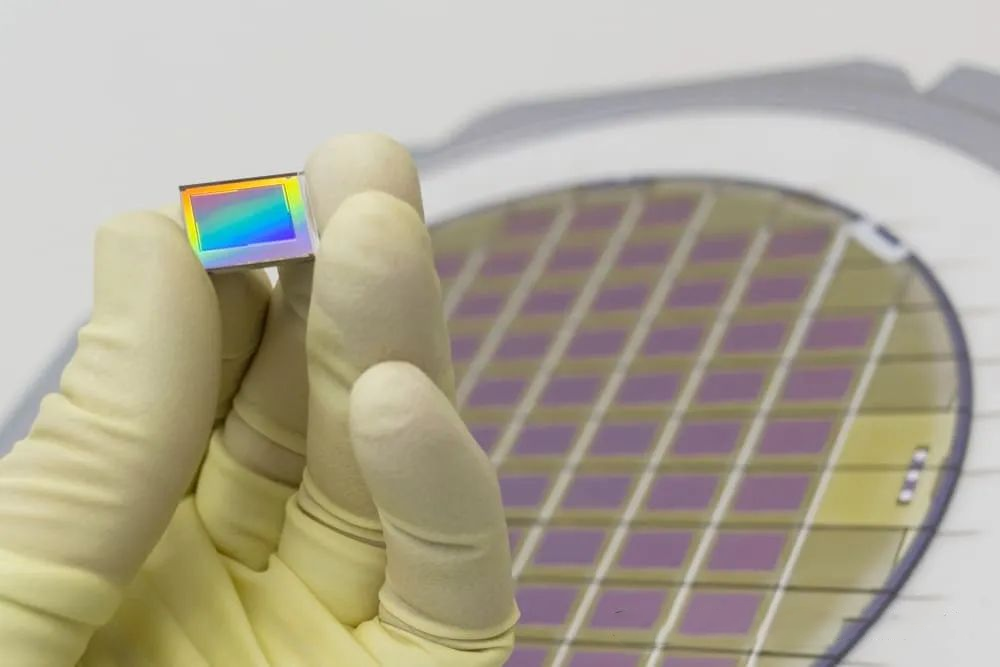
Tấm wafer chứa hàng nghìn con chip, mỗi con chip là một đơn vị độc lập. Khi quá trình sản xuất chip kết thúc, chip ở trạng thái rò rỉ trần và sự ăn mòn hóa học, bụi, hơi ẩm, v.v. trong môi trường đầu cuối sẽ gây ra hư hỏng nghiêm trọng cho chip, vì vậy chip cần phải được lắp vào " quần áo" (vỏ) để bảo vệ chip, tức là bao bì. Quá trình ghi chép cho phép mỗi chip được đóng gói riêng lẻ để sử dụng trong môi trường đầu cuối.
Cách chủ yếu để cắt lát?
Nói chung có viết nguệch ngoạc cơ học, viết nguệch ngoạc bằng laser. Việc khắc laser có thể được chia thành cắt ẩn bằng laser và cắt toàn bộ bằng laser. Sẽ có các đường cắt chéo nhau trên tấm bán dẫn và các đường cắt sẽ được cắt theo ranh giới của các chip riêng lẻ, thường được cắt dọc theo các đường cắt.
Viết nguệch ngoạc cơ khí
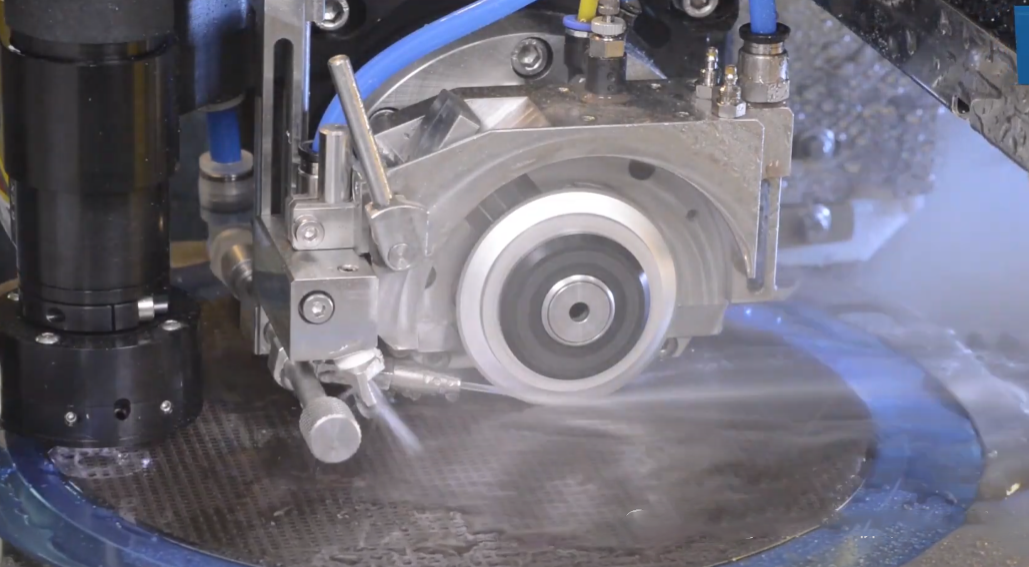
Viết nguệch ngoạc cơ học là việc sử dụng lưỡi kim cương để cắt các tấm wafer một cách vật lý, đây là phương pháp truyền thống nhất và được sử dụng phổ biến nhất trong việc khắc dấu wafer. Lưỡi kim cương được quay với tốc độ cao để cắt tấm wafer, nhiệt và các mảnh vụn sinh ra sẽ bị nước mang đi.
Thuận lợi:
1, thiết bị rẻ
2, thích hợp cho các vật liệu khác nhau của wafer
nhược điểm:
1, độ chính xác của việc viết nguệch ngoạc không cao
2, tỷ lệ viết nguệch ngoạc thấp
3, dễ bị gãy cạnh và các dị thường khác
4, không thích hợp cho các tấm wafer quá mỏng, nói chung tấm wafer có độ dày hơn 100um thích hợp cho việc ghi chép cơ học.
Sự cắt bằng tia la-ze
Một số tấm wafer tương đối giòn và mỏng nên dễ xảy ra hiện tượng viền và nứt bằng lưỡi kim cương nên việc cắt laser cần được xem xét.
Cắt bằng tia Laser Stealth Dicing là một quá trình gồm hai bước:
Bước đầu tiên là sử dụng chùm tia laser để tập trung vào bên trong tấm wafer, kiểm soát chính xác độ sâu tiêu cự của tia laser, tạo thành một vết nứt nhỏ bên trong tấm wafer, trong khi bề mặt vẫn còn nguyên vẹn.
Bước thứ hai là kéo căng đều băng dính gắn vào mặt sau của tấm bán dẫn một cách cơ học. Khi băng giãn ra, các chip riêng lẻ trên tấm bán dẫn sẽ được tách ra dọc theo đường cắt sẵn bằng laser.
Cắt toàn bộ bằng laser
Cắt toàn bộ bằng laser là chùm tia laser được chiếu trực tiếp lên bề mặt tấm bán dẫn, xuyên suốt toàn bộ độ dày của tấm bán dẫn, cắt hoàn toàn tấm bán dẫn và tách trực tiếp một con chip. Cắt toàn bộ bằng laser cho phép kiểm soát chính xác công suất, tiêu cự và tốc độ laser để thích ứng với các yêu cầu về vật liệu và độ dày khác nhau. Không giống như cắt mật mã bằng laser, cắt toàn bộ bằng laser không yêu cầu các bước mở rộng băng tiếp theo để tách chip.
Ưu điểm của cắt laser?
1, tốc độ ghi chép rất nhanh,
2, thiệt hại do căng thẳng là nhỏ
3, độ chính xác viết nguệch ngoạc rất cao
Nhược điểm:
1, giá đắt
2, các mảnh vụn do đốt laser tạo ra rất khó để làm sạch.
Viết nguệch ngoạc là gì?
Để giảm bớt các cạnh của vấn đề vẽ nguệch ngoạc, bạn có thể sử dụng khe đầu tiên bằng tia laser, sau đó sử dụng lưỡi kim cương để vẽ nguệch ngoạc. Nó cũng có thể được xẻ rãnh bằng lưỡi kim cương dày hơn và sau đó cắt bằng lưỡi kim cương.
Quá trình DBG là gì?
Quy trình DBG độc quyền của công ty Disco Nhật Bản (Dicing Before Grinding), đề cập đến mặt trước đầu tiên của tấm bán dẫn đến độ sâu xác định (không cắt qua tấm bán dẫn), sau đó mài mặt sau của tấm bán dẫn đến độ sâu cắt tương ứng, để giảm thiểu vấn đề của vết nứt wafer.
Fountyl Technologies PTE Ltd, đang tập trung vào ngành sản xuất chất bán dẫn, các sản phẩm chính bao gồm: Mâm cặp chốt, mâm cặp gốm xốp, bộ tác động cuối bằng gốm, dầm vuông gốm, trục chính bằng gốm, vui lòng liên hệ và đàm phán!











